Множественный рисунок
Эта статья может быть слишком технической для понимания большинства читателей . ( декабрь 2022 г. ) |
Множественное нанесение рисунка (или множественное нанесение рисунка ) — это класс технологий производства интегральных схем (ИС), разработанных для фотолитографии с целью повышения плотности элементов. Ожидается, что это будет необходимо для узловых полупроводниковых процессов 10 и 7 нм и далее. Предполагается, что одной литографической экспозиции может быть недостаточно для обеспечения достаточного разрешения. Следовательно, потребуются дополнительные обнажения или же потребуются шаблоны позиционирования с использованием вытравленных боковых стенок (с использованием прокладок).

Вверху: разделение объектов на группы (здесь показано 3), каждая из которых имеет свою маску.
В центре: использование прокладки для создания дополнительных отдельных элементов в зазорах.
Внизу: использование функции противоположной полярности для обрезки (небольшого разрыва) уже существующих элементов.
Даже если однократная экспозиция имеет достаточное разрешение, для лучшего качества рисунка были реализованы дополнительные маски, например, Intel для резки линий на своем 45-нм узле. [1] или TSMC на 28-нм узле. [2] Даже для электронно-лучевой литографии однократное воздействие оказывается недостаточным при полушаге ~ 10 нм, поэтому требуется двойное нанесение рисунка. [3] [4]
Литография с двойным узором была впервые продемонстрирована в 1983 году Д. К. Фландерсом и Н. Н. Ефремовым. [5] С тех пор было разработано несколько методов нанесения двойного рисунка, таких как самовыравнивающееся двойное формирование рисунка (SADP) и подход к нанесению двойного рисунка, основанный только на литографии. [6] [7]
Впервые технология двойного шага была предложена Гуртеджем Сингхом Сандху из Micron Technology в 2000-х годах, что привело к разработке 30 нм класса флэш-памяти NAND . С тех пор многошаблонирование широко применяется производителями флэш-памяти NAND и оперативной памяти по всему миру. [8] [9]
Ситуации, требующие нанесения нескольких рисунков
[ редактировать ]Существует ряд ситуаций, которые приводят к необходимости нанесения нескольких рисунков.
Шаг субразрешения
[ редактировать ]
Наиболее очевидным случаем, требующим создания нескольких рисунков, является ситуация, когда шаг элемента ниже предела разрешения оптической проекционной системы. Для системы с числовой апертурой NA и длиной волны λ любой шаг ниже 0,5 λ/NA не будет разрешимым за одно экспонирование пластины. Предел разрешения также может быть обусловлен стохастическим эффектом, как в случае EUV . Следовательно, ширина линии 20 нм по-прежнему требует двойного EUV-структурирования из-за большей дефектности при больших шагах. [10]
Двумерное закругление узора
[ редактировать ]
Хорошо известно, что плотные двумерные узоры, образующиеся в результате интерференции двух или трех лучей в одном направлении, как при квадрупольном или квазарном освещении, подвержены значительному скруглению, особенно на изгибах и углах. [11] [12] [13] Радиус скругления углов больше минимального шага (~0,7 λ/NA). [14] Это также способствует появлению горячих точек для объектов размером ~0,4 λ/NA или меньше. [15] По этой причине выгодно сначала определить образцы линий, а затем соответствующим образом вырезать из них сегменты. [16] Это, конечно, требует дополнительных разоблачений. Сами формы вырезов также могут быть круглыми, что требует высокой точности размещения. [16] [17] [18]
Кончик линии и компромисс между шириной линии
[ редактировать ]Закругление кончиков линий естественным образом приводит к компромиссу между уменьшением ширины линии (т. е. ширины кончика линии) и уменьшением зазора между противоположными кончиками. По мере уменьшения ширины линии радиус кончика уменьшается. Когда кончик линии уже меньше функции разброса точки (k 1 ~0,6–0,7), кончик лески естественным образом отводится назад, [19] увеличение зазора между противоположными кончиками. Функция распространения точки аналогичным образом ограничивает разрешимое расстояние между центрами кончиков линий (смоделированных в виде кругов). Это, в свою очередь, приводит к компромиссу между уменьшением ширины ячейки и уменьшением ее высоты. Этого компромисса можно избежать, добавив маску вырезания/обрезки (см. обсуждение ниже). [20] Следовательно, для 7-нм узла, ориентированного на EUV, с шириной металлической линии 18 нм (k 1 =0,44 для λ = 13,5 нм, NA = 0,33), зазор между кончиками линий менее 25 нм (k 1 =0,61) влечет за собой EUV-одиночный нанесения рисунка недостаточно; необходима вторая разрезанная экспозиция.
Разные части макета требуют разного освещения
[ редактировать ]
Когда шаблоны включают элементы размеров, близких к пределу разрешения, обычно для их печати различное расположение таких элементов требует специального освещения. [21]
Самый простой пример - это горизонтальные плотные линии и вертикальные линии (полушаг <0,35 λ/NA), где для первых требуется дипольное освещение север-юг, а для вторых - дипольное освещение восток-запад. Если используются оба типа (также известные как кросс-квадрупольный C-Quad), неподходящий диполь ухудшает изображение соответствующей ориентации линии. [22] Большие шаги до λ/NA могут иметь как горизонтальные, так и вертикальные линии, обеспечиваемые квадрупольным освещением или освещением QUASAR, но элементы, расположенные по диагонали, и элементы колена ухудшаются. [23] [24]
В DRAM массив и периферия подвергаются воздействию разных условий освещенности . Например, массив можно экспонировать дипольным освещением, а периферию можно использовать кольцевое освещение. [25] Эта ситуация применима к любому набору шаблонов (полушаг < 0,5 λ/NA) с разными шагами или различным расположением элементов, например, прямоугольные массивы или шахматные массивы. [26] [27] [28] [29] Любой из отдельных шаблонов разрешим, но одно освещение не может использоваться одновременно для всех из них. Минимальный шаг может потребовать освещения, которое вредно для удвоенного минимального шага с расфокусировкой. [30] [31]
Включение как изолированных, так и плотных элементов является хорошо известным примером многошагового рисунка. Вспомогательные функции субразрешения (SRAF) были разработаны для обеспечения возможности формирования паттернов изолированных объектов при использовании освещения, адаптированного для плотных объектов. Однако не все диапазоны шага могут быть охвачены. В частности, включить полуплотные функции может оказаться непросто. [32] [33]
Конкретный пример: массивы отверстий
[ редактировать ]
Для конкретного случая массивов отверстий (минимальный полушаг <0,6 λ/NA) три хорошо известных случая требуют трех совершенно разных источников освещения. Обычному массиву обычно требуется квазарное освещение, в то время как тот же массив, повернутый на 45 градусов, приводит к образованию шахматного массива, требующего освещения C-quad. [29] В отличие от обоих случаев, массив с симметрией, близкой к треугольной или шестиугольной, требует гексапольного освещения. [34]
Многошаговые узоры
[ редактировать ]

Иногда шаблон объекта по своей сути содержит более одного шага, и, более того, эти шаги несовместимы до такой степени, что никакое освещение не может одновременно удовлетворительно отображать оба шага. Типичным примером, опять же из DRAM, является кирпичный узор, определяющий активные области массива. [35] [36] Помимо узкого шага активных областей, существует также шаг между разделениями или разрывами активных областей, который отличается от шага с узким шагом в том же направлении. Когда узкий шаг < λ/NA (но все же > 0,5 λ/NA), его невозможно визуализировать одновременно с двойным шагом из-за ограничений фокусировки последнего. Селективное травление, наряду с SADP или SAQP (описано ниже), является лучшим на данный момент подходом для достижения одновременного формирования рисунка обоих шагов. [37]
Небольшие отклонения от двухлучевой интерференции
[ редактировать ]Двухлучевая интерференционная картина (полушаг <0,5 λ/NA) образует набор регулярно расположенных линий. Разрывы таких линий, например кирпичных узоров, являются отклонениями от интерференционной картины. Такие разрывы обычно не доминируют в модели и, таким образом, представляют собой небольшие отклонения. Этих отклонений недостаточно, чтобы полностью компенсировать конструктивное или деструктивное вмешательство лежащего в основе регулярного линейного рисунка; часто возникают боковые лепестки. [38] [39] Зазоры в концах линий легко перекрываются при дипольном освещении. [40] Поэтому необходима еще одна экспозиция маски (обычно называемая маской обрезки), чтобы более четко разорвать рисунок линии.
Линия резки
[ редактировать ]
Самая ранняя реализация множественного рисунка включала вырезание линий. Впервые это произошло с 45-нм узлом Intel с шагом затвора 160 нм. [41] Использование второй маски для вырезания линий, определенных первой маской, не помогает напрямую увеличить плотность объектов. Вместо этого он позволяет определять элементы, например, кирпичные узоры, которые основаны на линиях, расположенных с минимальным шагом, в частности, когда линии находятся вблизи предела разрешения и генерируются упомянутой выше двухлучевой интерференцией. Двухлучевая интерференция по-прежнему доминирует в дифракционной картине. [38] Фактически, при отсутствии отдельного обнажения разреза, зазор между концами линий минимального шага будет непомерно большим. [42] [43] Это происходит из-за округления, возникающего из-за уменьшения пространственных частот. [44]
Сами формы линий разреза подлежат округлению; это округление можно свести к минимуму с помощью оптимизированного освещения, [45] но не может быть полностью устранено.
При применении второй маски к линиям разреза необходимо учитывать наложение относительно первой маски; в противном случае могут возникнуть ошибки размещения кромок (EPE). Если шаг линии уже близок к пределу разрешения, у самого разреза могут возникнуть трудности с визуализацией из-за уменьшенной дозы или окна фокусировки. Стохастическая изменчивость EUV приводит к случайной форме разрезов. [46] В этом случае придется использовать более одной маски разреза, иначе разрез должен занимать более одной линии. Предпочтительным вариантом может быть резка по самовыравнивающейся линии (обсуждается ниже).
Разделение высоты тона
[ редактировать ]


Самая ранняя форма создания множественного рисунка заключалась в простом разделении рисунка на две или три части, каждая из которых может быть обработана традиционным способом, при этом весь рисунок объединялся в конце в последнем слое. Иногда это называют разделением шага , поскольку два объекта, разделенные одним шагом, не могут быть отображены, поэтому одновременно можно отображать только пропущенные объекты. Его также называют более прямо как «ЛЕЛЕ» (лито-травление-лито-травление). Этот подход использовался для узлов 20 и 14 нм. Дополнительные затраты на дополнительные воздействия были допустимы, поскольку они понадобятся только нескольким критическим слоям. Более серьезной проблемой был эффект ошибок позиционирования между объектами (наложение). Следовательно, на смену этому подходу пришел метод самовыравнивающейся визуализации боковой стенки (описанный ниже).
Подход «грубой силы» для нанесения рисунка траншей включает в себя последовательность (по крайней мере) двух отдельных экспозиций и гравировки независимых узоров на одном и том же слое. Для каждой экспозиции требуется разное покрытие фоторезиста. Когда последовательность завершена, узор представляет собой композицию ранее вытравленных подшаблонов. Путем чередования подшаблонов плотность рисунка теоретически можно увеличивать до бесконечности, при этом полушаг обратно пропорционален количеству используемых подшаблонов. Например, шаблон с полушагом 25 нм может быть сгенерирован путем чередования двух шаблонов с полушагом 50 нм, трех шаблонов с полушагом 75 нм или четырех шаблонов с полушагом 100 нм. Уменьшение размера элемента, скорее всего, потребует использования таких методов, как химическая усадка, термическое оплавление или вспомогательные термоусадочные пленки. Этот составной узор затем можно перенести на последний слой.
Лучше всего это описать на примере процесса. Первая экспозиция фоторезиста переносится на нижележащий слой твердой маски. После того, как фоторезист удаляется после переноса рисунка твердой маски, на образец наносится второй слой фоторезиста, и этот слой подвергается второму экспонированию, отображая элементы между элементами, нанесенными на слой твердой маски. Рисунок поверхности состоит из элементов фоторезиста, расположенных по краям между элементами маски, которые можно перенести на последний слой под ним. Это позволяет удвоить плотность объектов.
Иногда необходимо «сшить» два отдельно напечатанных элемента в один. [47] [48] [49]
Разновидностью этого подхода, исключающей первое травление твердой маски, является устойчивость к замораживанию . [50] что позволяет нанести второе покрытие резиста поверх первого проявленного слоя резиста. JSR продемонстрировала линии и пространства длиной 32 нм, используя этот метод. [51] где замораживание достигается за счет поверхностного упрочнения первого слоя резиста.
В последние годы объем термина «разделение шага» постепенно расширился и теперь включает в себя методы, включающие проставки боковин.
Передача изображения боковой стенки
[ редактировать ]
При создании рисунка с прокладками прокладка представляет собой слой пленки, сформированный на боковой стенке элемента с предварительно нанесенным рисунком. Прокладка формируется путем осаждения или реакции пленки на предыдущий рисунок с последующим травлением для удаления всего материала пленки на горизонтальных поверхностях, оставляя только материал на боковых стенках. Если удалить исходный элемент рисунка, останется только проставка. Однако, поскольку на каждую строку приходится две проставки, плотность линий теперь удвоилась. Это обычно называют самовыравнивающимся двойным паттерном (SADP). Техника прокладки применима, например, для определения узких ворот на половине исходного шага литографии.
Поскольку разделение шага стало более трудным из-за возможных различий в положении элементов между различными открытыми частями, перенос изображения боковой стенки (SIT) стал более признанным необходимым подходом. Подход SIT обычно требует формирования промежуточного слоя на боковой стенке вытравленного элемента. Если эта прокладка соответствует проводящему элементу, то в конечном итоге его необходимо разрезать не менее чем в двух местах, чтобы разделить элемент на две или более проводящие линии, как обычно ожидается. С другой стороны, если прокладка соответствует диэлектрическому элементу, резка не потребуется. Предсказание того, сколько сокращений потребуется для сложных логических моделей, было большой технической проблемой. Было опубликовано множество подходов к формированию прокладок (некоторые из них перечислены ниже), все они направлены на улучшение управления (и сокращение) разрезов.
Поскольку разделительные материалы обычно представляют собой твердые маски , качество их рисунка после травления, как правило, выше, чем у профилей фоторезиста после травления, которые обычно страдают от шероховатости краев линии. [52]
Основные проблемы, связанные с использованием спейсера, заключаются в том, могут ли прокладки оставаться на месте после удаления материала, к которому они прикреплены, является ли приемлемым профиль спейсера и подвергается ли основной материал воздействию травления, удаляющего материал, прикрепленный к спейсеру. . Перенос рисунка осложняется ситуацией, когда при удалении материала, примыкающего к проставкам, также удаляется небольшая часть нижележащего материала. Это приводит к более высокой топографии на одной стороне прокладки, чем на другой. [53] Любое несовпадение масок или отклонение критического размера (CD) заранее заданного объекта приведет к чередованию шага между элементами - явление, известное как шаг шага. [54]
Расположение прокладки также зависит от рисунка, к которому она прикреплена. Если рисунок слишком широкий или слишком узкий, это повлияет на положение прокладки. Однако это не будет проблемой для процессов изготовления критически важных элементов памяти, которые являются самовыравнивающимися.
При повторении SADP достигается дополнительное уменьшение высоты звука вдвое. Это часто называют самовыравнивающимся четверным паттерном (SAQP). Поскольку 76 нм — это ожидаемый минимальный шаг для однократного воздействия иммерсионной литографии , [55] Шаг 19 нм теперь доступен в SAQP.
Самовыравнивающийся контакт/через рисунок
[ редактировать ]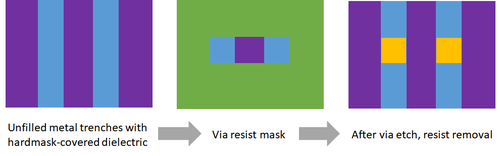
Самовыравнивание контактов и переходных отверстий — это общепринятый метод создания рисунка нескольких контактов или переходных отверстий из одного литографического элемента. Он использует пересечение увеличенной маски резиста и нижележащих траншей, окруженных предварительно нанесенным слоем жесткой маски. Этот метод используется в ячейках DRAM. [56] а также используется для расширенной логики, чтобы избежать многократного воздействия контактов и переходных отверстий, делящих высоту тона. [57] [58] [59]
Начиная с узла 32 нм, Intel применила вышеупомянутый подход с самовыравнивающимися переходными отверстиями, который позволяет использовать два переходных отверстия, разделенных достаточно небольшим шагом (112,5 нм для металла Intel 32 нм). [60] иметь рисунок с одним отверстием резиста вместо двух отдельных. [59] Если бы переходные отверстия были разделены на расстояние, меньшее, чем предел разрешения шага одной экспозиции, минимально необходимое количество масок было бы уменьшено, поскольку две отдельные маски для первоначально разделенной пары переходных отверстий теперь могут быть заменены одной маской для той же пары.
Диэлектрик-спейсер (SID) SADP
[ редактировать ]

При самовыравнивающемся двойном формировании рисунка (SADP) количество масок вырезов/блоков может быть уменьшено или даже устранено в плотных участках, когда прокладка используется для непосредственного формирования рисунка межметаллического диэлектрика вместо металлических элементов. [61] Причина в том, что местоположения вырезов/блоков в элементах стержня/оправки уже заданы в первой маске. Есть второстепенные особенности, которые появляются из зазоров между прокладками после дальнейшего формирования рисунка. Край между второстепенным элементом и прокладкой самовыравнивается с соседним основным элементом.
2D-прокладка SID
[ редактировать ]Использование SID можно применить к двумерным массивам путем итеративного добавления объектов, равноудаленных от ранее существовавших объектов, удваивая плотность с каждой итерацией. [62] [63] На этой прокладочной сетке можно выполнять разрезы, не требующие жесткого позиционирования. [64]
Треугольная прокладка (сотовая структура)
[ редактировать ]
Samsung недавно продемонстрировала структурирование DRAM с использованием сотовой структуры (HCS), подходящей для 20 нм и выше. [65] Каждая итерация распорного рисунка утрояет плотность, эффективно уменьшая шаг 2D в sqrt(3). Это особенно полезно для DRAM, поскольку слой конденсатора можно приспособить к сотовой структуре, что упрощает его формирование.
Самовыравнивающийся четверной рисунок ( САКП )
[ редактировать ]
SADP можно применять дважды подряд для достижения эффективного разделения высоты тона. Это также известно как самовыравнивающийся четверной паттерн (SAQP). В SAQP критический размер основного элемента (CD), а также расстояние между такими элементами определяются либо первой, либо второй прокладкой.
Предпочтительно, чтобы вторая прокладка определяла непроводящие элементы. [66] для более гибких вариантов резки или обрезки.
SAQP имеет преимущества при двумерной маршрутизации с шагом 28 нм (с последующими двумя этапами выборочного травления / обрезки) по сравнению с EUV из-за ограничений освещения последнего. [67]
Направленная самосборка (DSA)
[ редактировать ]
Количество масок, используемых для нанесения рисунка прокладок на боковинах, можно уменьшить с помощью направленной самосборки (DSA) за счет обеспечения разрезов по сетке сразу в пределах печатной области, которые затем можно выбрать при окончательном экспонировании. [68] [64] Альтернативно, сам шаблон выреза может быть сгенерирован как этап DSA. [69] Аналогично, макет разделенного переходного отверстия может быть повторно объединен в пары. [70]
Сообщалось о большом прогрессе в использовании блок-сополимеров ПММА-ПС для определения структур размером менее 20 нм посредством самосборки, руководствуясь топографией поверхности (графоэпитаксии) и/или поверхностным химическим рисунком (хемоэпитаксией). [71] Ключевым преимуществом является относительно простая обработка по сравнению с многократным экспонированием или многократным осаждением и травлением. Основным недостатком этого метода является относительно ограниченный диапазон размеров элементов и рабочих циклов для данной рецептуры процесса. Типичными применениями являются регулярные линии и пространства, а также массивы плотно расположенных отверстий или цилиндров. [72] Однако случайные апериодические шаблоны также могут быть созданы с использованием тщательно определенных направляющих шаблонов. [73]
Шероховатость края линии в рисунках блок-сополимеров сильно зависит от натяжения на границе раздела между двумя фазами, которое, в свою очередь, зависит от параметра Флори «хи» (χ). [74] Более высокое значение χ является предпочтительным для снижения шероховатости; ширина границы раздела между доменами равна 2a(6χ) −1/2 , где a – статистическая длина полимерной цепи. [75] При этом для достаточного разделения фаз необходимо χN > 10,5, где N — степень полимеризации (число повторов мономера в цепи). С другой стороны, полушаг равен 2(3/π 2 ) 1/3 аН 2/3 час 1/6 . Колебания ширины узора на самом деле лишь слабо (квадратный корень) зависят от логарифма полушага, поэтому они становятся более значительными по сравнению с меньшими полушагами.
DSA еще не внедрен в производство из-за проблем с дефектами, когда функция не проявляется так, как ожидалось при управляемой самостоятельной сборке. [76]
Другие методы использования нескольких узоров
[ редактировать ]Высказывались многочисленные опасения, что множественное создание шаблонов уменьшает или даже обращает вспять снижение затрат между узлами, ожидаемое в соответствии с законом Мура . EUV дороже, чем три воздействия 193i (т. е. LELELE), учитывая пропускную способность. [77] Более того, EUV более склонен печатать более мелкие дефекты маски, которые не могут быть устранены с помощью 193i. [78] Некоторые аспекты других рассмотренных методов создания нескольких шаблонов обсуждаются ниже.
Самовыравнивающийся тройной рисунок (SATP)
[ редактировать ]
Самовыравнивающийся тройной рисунок считается многообещающим преемником SADP благодаря введению второй прокладки, обеспечивающей дополнительную гибкость двумерного рисунка и более высокую плотность. [79] [80] Для этого подхода достаточно двух масок (оправки и обрезки). [81] Единственная дополнительная стоимость по сравнению с SADP — это нанесение и травление второй прокладки. Основным недостатком SATP, пришедшего на смену SADP, является то, что его можно будет использовать только для одного узла. По этой причине чаще рассматривается самовыравнивающийся четверной паттерн (SAQP). С другой стороны, обычный поток SID SADP может быть вполне естественным образом расширен до тройного шаблона, при этом вторая маска делит пробел на два элемента. [82]
Имплантация наклонных ионов
[ редактировать ]
Имплантация наклонных ионов была предложена в 2016 году Университетом Беркли как альтернативный метод достижения того же результата, что и создание спейсерного рисунка. [83] Вместо рисунков сердцевины или оправки, поддерживающих нанесенные прокладки, рисунок слоя ионной маскировки защищает нижележащий слой от повреждения в результате ионной имплантации, что приводит к вытравливанию в последующем процессе. Этот процесс требует использования направленных ионных лучей, которые проникают на нужную глубину, чтобы не повредить уже обработанные нижние слои. Кроме того, слой, маскирующий ионы, должен вести себя идеально, т. е. блокировать прохождение всех ионов, а также не отражаться от боковой стенки. Последнее явление было бы вредным и противоречило бы цели подхода ионной маскировки. С помощью этого подхода были достигнуты траншеи размером всего 9 нм с использованием имплантации ионов Ar+ с энергией 15 кэВ под углами 15 градусов в термический маскирующий слой SiO 2 толщиной 10 нм . Фундаментальным аспектом этого подхода является корреляция между шириной повреждения и шагом повреждения; оба расширяются одновременно при фиксированной высоте ионной маски и угле ионного пучка.
Дополнительные полярные воздействия
[ редактировать ]Метод дополнительных воздействий [84] это еще один способ уменьшить экспозицию маски для нескольких рисунков. Вместо многократной экспозиции маски для отдельных переходов, вырезов или блоков используются две экспозиции противоположной или дополняющей полярности, так что одна экспозиция удаляет внутренние части предыдущей схемы экспозиции. Перекрывающиеся области двух многоугольников противоположной полярности не печатаются, а неперекрывающиеся области определяют местоположения, которые печатаются в соответствии с полярностью. Ни одно из этих воздействий не моделирует непосредственно целевые функции. Этот подход также был реализован IMEC в виде двух «хранящих» масок для слоя M0A в их 7-нм ячейке SRAM. [85]
Самовыравнивающаяся блокировка или резка
[ редактировать ]
Самовыравнивающаяся блокировка или резка в настоящее время планируется использовать с SAQP для шагов менее 30 нм. [86] Линии, которые нужно разрезать, делятся на два материала, которые можно травить выборочно. Одна маска вырезания обрезает только все остальные линии, сделанные из одного материала, тогда как другая маска вырезания обрезает оставшиеся линии, сделанные из другого материала. Преимущество этого метода состоит в том, что он позволяет создавать узоры с двойным шагом по сравнению с линиями с минимальным шагом без ошибок в размещении кромок. [37] Удобные для резки макеты обрабатываются с одинаковым минимальным количеством масок (3), независимо от использования длины волны DUV или EUV. [87]

Возможности создания нескольких рисунков EUV
[ редактировать ]
Хотя EUV предполагается, что станет предпочтительной литографией следующего поколения , для нее все равно может потребоваться более одной литографической экспозиции из-за предусмотренной необходимости сначала напечатать серию линий, а затем разрезать их; при использовании одного шаблона воздействия EUV возникают трудности с контролем межстрочного расстояния. [12] Кроме того, на расположение конца линии существенно влияет шум фотонного выстрела.
Существующие приборы EUV с числовой апертурой 0,33 испытывают трудности с разрешением ниже полушага 16 нм. [88] Зазоры между наконечниками являются проблематичными для размеров 16 нм. [89] Следовательно, создание 2D-паттерна EUV ограничено шагом> 32 нм. [88] Недавние исследования по одновременной оптимизации функций EUV-маски и формы освещения показали, что разные узоры в одном и том же металлическом слое могут потребовать разного освещения. [90] [91] [92] [93] [94] С другой стороны, одна экспозиция обеспечивает только одно освещение.
Например, при оптимизации маски источника с перекрестным шагом для узла 7 нм, для шага 40–48 нм и шага 32 нм качество, определенное по наклону нормализованного логарифма изображения, было недостаточным (NILS <2), в то время как только шаг 36 нм было едва удовлетворительным для двунаправленной однократной экспозиции. [13]
Основная ситуация заключается в том, что узоры EUV могут быть разделены в соответствии с разным освещением для разных шагов или разными типами узоров (например, шахматные массивы по сравнению с обычными массивами). [90] Это может относиться к шаблонам вырезания линий, а также к контактным/переходным слоям. Также, вероятно, потребуется более одного сокращения, даже для EUV. [95]
На семинаре EUVL 2016 года компания ASML сообщила, что инструменты 0,33 NA NXE EUV не смогут создавать стандартные шаблоны однократного воздействия для полушага 11–13 нм, ожидаемого в узле 5 нм. [96] Более высокое значение NA, равное 0,55, позволит получить EUV-структуру при однократной экспозиции в полях, размер которых вдвое меньше стандартного размера поля 26 x 33 мм. [96] Однако некоторые продукты, такие как Pascal Tesla P100 от NVIDIA, [97] будет разделен пополам на размер половины поля и, следовательно, потребует сшивания двух отдельных экспозиций. [98] В любом случае два сканирования половинного поля требуют в два раза больше накладных расходов на ускорение/замедление, чем одно сканирование полного поля. [96] [99]
Стохастические дефекты, включая ошибку размещения краев, также влекут за собой двойное (или более высокое) формирование рисунка для контактов/переходных отверстий с межцентровым расстоянием 40 нм или меньше. [100] [101]
Реализации нескольких шаблонов
[ редактировать ]
Шаблоны памяти уже созданы с помощью четверного шаблона для NAND. [102] и скрещенный четверной/двойной рисунок для DRAM. [103] Эти методы нанесения рисунка являются самовыравнивающимися и не требуют специальной резки или обрезки масок. Для 2x-нм DRAM и флэш-памяти должно быть достаточно методов двойного структурирования.
Текущая производительность EUV по-прежнему более чем в 3 раза ниже, чем у иммерсионной литографии с длиной волны 193 нм, что позволяет расширить последнюю за счет многократного нанесения рисунка. Более того, отсутствие EUV-пелликулы также является неприемлемым.
По состоянию на 2016 год Intel использовала SADP для своего 10-нм узла; [104] однако по состоянию на 2017 год минимальный шаг металла 36 нм достигается SAQP. [105] Intel использует тройной шаблон для некоторых критических слоев на своем 14-нм узле. [106] это подход LELELE. [107] Тройное паттернирование уже продемонстрировано на ленте толщиной 10 нм. [108] и уже является неотъемлемой частью 10-нм техпроцесса Samsung. [109] В 2017 году TSMC внедряет 7-нм техпроцесс с множественным структурированием; [110] в частности, разделение высоты тона, [111] шаг до 40 нм. [112] За пределами узла 5 нм создание нескольких паттернов, даже с помощью EUV, будет экономически сложным, поскольку отказ от однократного воздействия EUV приведет к еще большему увеличению стоимости. Однако, по крайней мере, до полушага 12 нм, LELE, за которым следует SADP (SID), кажется многообещающим подходом, использующим только две маски, а также наиболее развитые методы двойного формирования рисунка, LELE и SADP. [113]
Затраты на выкройку
[ редактировать ]
| Метод нанесения рисунка | Нормализованная стоимость пластины |
|---|---|
| 193i ЮВ | 1 |
| 193i ЛЕТАЮЩИЙ | 2.5 |
| 193i ПОЛЕТ | 3.5 |
| 193i САДП | 2 |
| 193i САКП | 3 |
| ЕС, ЮВ | 4 |
| EUV САДП | 6 |
Ссылка: Raley A. et al., Proc. ШПИЕ 9782, 97820F (2016).
По сравнению с 193i SADP, в стоимости EUV SADP преобладает воздействие инструмента EUV, тогда как разница в стоимости 193i SAQP обусловлена дополнительными осаждениями и травлением. Ожидается, что стоимость обработки и потери производительности на литографическом инструменте будут самыми высокими во всем интегрированном технологическом процессе из-за необходимости перемещать пластину в определенные места на высокой скорости. EUV также страдает от предела дробового шума, который заставляет дозу увеличиваться для последующих узлов. [114] С другой стороны, осаждение и травление обрабатывают целые пластины одновременно, без необходимости перемещения пластины в технологической камере. Фактически, под слоем резиста можно добавить несколько слоев для антибликового покрытия или создания твердой маски травления, только для обычной однократной экспозиции.
Опубликованные демонстрации кремния
[ редактировать ]| Подача | Схема узора | # Маски | Продемонстрировано | Ссылка |
|---|---|---|---|---|
| 64 нм | ВЫХОД | 2 | IBM/Тошиба/Ренесас | 2011 ИИЦ |
| 56 нм | ВЫХОД | 2 | STMicroelectronics/IBM/Toshiba | Микрол. англ. 107, 138 (2013) |
| 48 нм | SADP + маска блока | 2 | IBM/Samsung/GlobalFoundries | 2013 ИИЦ |
| 40 нм | SADP + сетка разделения шага резки + шаблон выбора резки | 3 | Холст/Canon/TEL/Секвойя | SPIE 8683, 868305 (2013). |
| 40 нм | САДП + самовыравнивающийся блок (ЛЕЛЕ) | 3 | ТЕЛ. | Учеб. ШПИЕ 10149, 101490О (2017) |
Передовые методы работы с несколькими шаблонами логики/ASIC
[ редактировать ]
| Компания | Логический процесс | Минимальный шаг металла (MMP) | Техника создания узоров MMP | Начало производства |
|---|---|---|---|---|
| Интел | 14 нм | 52 нм [115] | САДП + сокращение [115] | 2014 [115] |
| Интел | 10 нм | 36 нм [116] | SAQP + SAQP + ЛЕЛЕ [116] [117] | 2019 |
| ТСМК | 7FF | 40 нм [112] | САДП + сокращение [118] | начало 2017 года [119] |
| Samsung | 8ЛПП; продолжение 7LPP [120] [121] | 44 нм [122] | ДЛИННЫЙ [122] | конец 2018 года |
Даже с внедрением технологии EUV в некоторых случаях в большинстве производимых слоев по-прежнему сохраняется множественный рисунок. Например, компания Samsung продолжает использовать четырехкратный рисунок для 7-нм техпроцесса. [120] Техпроцесс TSMC 7 нм+ также использует EUV в контексте нескольких шаблонов. [123] В любом случае затрагиваются только несколько слоев; [124] многие остаются традиционными с несколькими узорами.
Стоимость маски
[ редактировать ]Стоимость маски значительно увеличивается за счет использования нескольких рисунков. Маска однократного воздействия EUV имеет меньшие функции, написание которых занимает гораздо больше времени, чем маска погружения. Несмотря на то, что элементы маски в 4 раза больше, чем элементы пластины, количество снимков экспоненциально увеличивается для гораздо меньших элементов. Кроме того, элементы маски размером менее 100 нм гораздо сложнее моделировать, поскольку высота поглотителя составляет ≈70 нм. [125]
Производительность пластин
[ редактировать ]| Инструмент | EUV | EUV | Погружение | Погружение |
|---|---|---|---|---|
| WPH (вафли в час) | 85 | 85 | 275 | 275 |
| # инструменты | 6 | 6 | 24 [126] | 24 |
| время безотказной работы | 70% | 70% | 90% | 90% |
| # проходов | 1 | 2 | 2 | 4 |
| WPM (пластин в месяц) | 257,040 | 128,520 | 2,138,400 | 1,069,200 |
| нормализованное WPM | 1 | 0.5 | 8 | 4 |
Примечание. WPM = WPH * количество инструментов * время безотказной работы / количество проходов * 24 часа в день * 30 дней в месяц. Нормализованное WPM = WPM/(WPM для 1 прохода EUV)
Можно ожидать, что при нанесении нескольких рисунков с помощью иммерсионных сканеров производительность пластин будет выше, чем EUV, даже при четырех проходах на слой из-за более высокой производительности экспонирования пластин (WPH), большего количества доступных инструментов и более высокого времени безотказной работы.
Множественные проблемы с шаблонами
[ редактировать ]
| Проблема | ВЫХОД | ЛЕТАТЬ | Сид САДП | SAQP |
|---|---|---|---|---|
| Наложение | между 1-м и 2-м экспозициями, особенно там, где сшивка | среди всех трёх экспозиций, особенно там, где сшивка | между обнажениями керна и разреза | между обнажениями керна и разреза |
| Ширина открытого объекта | (1) 1-я экспозиция (2) 2-я экспозиция | (1) 1-я экспозиция (2) 2-я экспозиция (3) 3-я экспозиция | основная функция | (1) основная особенность (2) форма разреза |
| Функция уменьшения целевой ширины | шаг экспозиции 1/4 | шаг экспозиции 1/6 | Шаг сердечника 1/4 | шаг сердечника 1/8 |
| Ширина проставки | Н/Д | Н/Д | 1 проставка | (1) 1-я прокладка (2) 2-я проставка |
Множественное формирование рисунка влечет за собой использование множества этапов обработки для формирования слоя с рисунком, при этом обычно достаточно только одного литографического воздействия, одной последовательности осаждения и одной последовательности травления. Следовательно, существует больше источников вариаций и возможных потерь урожайности при множественном формировании рисунка. Если задействовано более одного воздействия, например, LELE или сокращенное воздействие для SAQP, согласование между воздействиями должно быть достаточно жестким. Текущие возможности наложения составляют ≈0,6 нм для экспозиций одинаковой плотности (например, LELE) и ≈2,0 нм для плотных линий по сравнению с разрезами/переходными отверстиями (например, SADP или SAQP) на специальных или подобранных инструментах. [127] Кроме того, каждая экспозиция должна по-прежнему соответствовать заданным целевым значениям ширины. Если используются прокладки, их ширина зависит от первоначального осаждения, а также от продолжительности последующего травления. Если используется более одной прокладки, каждая прокладка может иметь собственное изменение ширины. Ошибка наложения местоположения разреза также может исказить концы линий (что приведет к образованию дуги) или нарушить соседнюю линию. [16] [17] [18]
Смешанные методы нанесения рисунка
[ редактировать ]Множественное формирование паттерна развивается в сторону комбинации многократного воздействия, спейсерного рисунка и/или EUV. Особенно в связи с тем, что масштабирование от кончика к кончику за один раз с использованием современных инструментов EUV затруднено. [12] может потребоваться подход, основанный на сокращении линий. IMEC сообщила, что двойное нанесение рисунка становится требованием EUV. [128]
| Определение сетки | 1-й кадр экспозиции | 2-я экспозиция |
|---|---|---|
| САДП/САКП | 1-я самовыравнивающаяся блочная маска | 2-я самовыравнивающаяся блочная маска |
| САДП/САКП | Вырезать сетку [129] | Вырезать шаблон выделения [129] |
| EUV-воздействие | 1-я самовыравнивающаяся блочная маска | 2-я самовыравнивающаяся блочная маска |
| SAQP | 1-я наложенная дистанционная сетка [130] [131] | 2-я наложенная дистанционная сетка [130] [131] [84] [132] |

Что касается построения линий, SADP/SAQP может иметь преимущество перед воздействием EUV из-за стоимости и зрелости первого подхода, а также проблем стохастического отсутствия или перекрытия функций второго. [133] Для формирования рисунка расположения сетки однократное воздействие DUV после формирования сетки также имеет преимущества по стоимости и зрелости (например, в некоторых случаях иммерсионная литография может даже не потребоваться для формирования промежуточного рисунка) и не вызывает стохастических проблем, связанных с EUV. Выбор местоположения сетки имеет преимущество перед прямой обрезкой точек, поскольку последняя чувствительна к наложению и стохастическим ошибкам размещения ребер, которые могут исказить концы линий. [16] [17]

Самовыравнивающееся литотравление-литотравление (SALELE) — это гибридная технология SADP/LELE, реализация которой началась с 7-нм техпроцесса. [134] и дальнейшее использование в 5-нм техпроцессе. [135]
Повышение производительности за счет использования нескольких шаблонов
[ редактировать ]С 2017 года в нескольких публикациях были указаны способы повышения производительности при использовании нескольких шаблонов. Самовыравнивающаяся блокировка позволяет блокировать или вырезать узоры, пересекающие соседние линии. [136] Перераспределение разрезов позволяет регулировать расстояния между разрезами, чтобы минимизировать количество масок разрезов. [137] [138] Эти методы также можно комбинировать с самовыравнивающимися переходными отверстиями, описанными ранее. [139]
Промышленное внедрение
[ редактировать ]Эволюция множественного рисунка рассматривается параллельно с появлением EUV-литографии. Хотя EUV-литография удовлетворяет разрешению 10-20 нм по основным оптическим соображениям, появление стохастических дефектов [140] а также другие пробелы в инфраструктуре и соображения пропускной способности препятствуют его внедрению в настоящее время. Следовательно, 7-нм техпроцесс в основном осуществляется без EUV. [141] Другими словами, множественные узоры не являются непомерно высокими, а скорее раздражают и приводят к растущим расходам.
FinFET-транзисторы 7 и 5 нм
[ редактировать ]Самовыравнивающееся четырехкратное формирование рисунка (SAQP) уже является общепринятым процессом, который будет использоваться для формирования рисунка ребер для 7 и 5 нм FinFET-транзисторов FinFET . [142] При использовании SAQP каждый этап формирования рисунка дает критическое значение однородности размеров (CDU) в субнанометровом диапазоне (3 сигма). По состоянию на 2017 год среди производителей логики и литейного производства только Intel применяет SAQP к металлическим слоям. [143]
Агрессивный мультипаттерн с DUV может применяться только к 5-нм техпроцессу. [144]
3-нм узел
[ редактировать ]Агрессивный мультипаттерн с DUV может быть применен даже к 3-нм техпроцессу. [145] Из-за увеличения затрат на использование нескольких шаблонов EUV, использование нескольких шаблонов DUV больше не имеет недостатка в стоимости. Агрессивное уменьшение маски может существенно устранить разницу в количестве масок между DUV и EUV для формирования шаблона BEOL. [146]
ДРАМ
[ редактировать ]Как и NAND Flash, DRAM также регулярно использует множественные шаблоны. Несмотря на то, что активные области образуют двумерный массив, одной маски выреза достаточно для 20 нм. [147] Более того, маска выреза может одновременно использоваться для нанесения рисунка на периферию и, таким образом, не будет считаться дополнительной маской. [148] Когда длинный шаг активной области примерно в 3,5 раза превышает короткий шаг, разрывы в активной области образуют шестиугольный массив, который поддается формированию треугольной решетчатой прокладки, упомянутой выше. Samsung уже начала производство 18-нм DRAM. [149] Для трассировки металлической периферии DRAM можно использовать несколько экспозиций, но в этом также нет необходимости, поскольку подход с тройной прокладкой обеспечивает уменьшение шага на 1/5. [150]
NAND флэш-память
[ редактировать ]Планарная флэш-память NAND имела несколько слоев, в которых используется SADP с шагом менее 80 нм и SAQP с шагом менее 40 нм.
Во флэш-памяти 3D NAND для некоторых слоев использовался SADP. Хотя масштабирование в горизонтальном направлении не столь агрессивно, использование укладки строк в 3D NAND будет подразумевать использование множественного рисунка (стиль литотравления) для формирования рисунка вертикальных каналов.
Обычно для NAND SADP формирует набор строк из основной маски с последующим использованием маски обрезки для удаления концов контура и соединением площадок с третьей маской. [151]
EUV-мультипаттерн
[ редактировать ]

Множественное создание EUV-паттернов не исключено, особенно для 5-нм узла. Это связано с рядом причин. Во-первых, это спецификация затяжки между наконечниками (T2T), обозначающая минимальное расстояние между концами металлических лесок. [152] Кроме того, расстояние между разрезами не должно быть слишком маленьким, чтобы обнажать части линий между ними.
Когда минимальный шаг уменьшается до 32 нм или меньше, стохастические дефекты становятся достаточно распространенными. [153] пересмотреть возможность нанесения двойного рисунка при большей ширине конструкции.
При шаге ~30 нм или меньше освещение также ограничивается чрезвычайно низким заполнением зрачка ниже 20%. [154] [155] что приводит к тому, что значительная часть мощности источника EUV остается неиспользованной. Это значительно снижает пропускную способность.
Следовательно, множественное создание шаблонов для EUV в соответствии с более широкими правилами проектирования в настоящее время является практическим соображением как по соображениям урожайности, так и по соображениям пропускной способности.
Ссылки
[ редактировать ]- ^ Intel 45 нм HKMG
- ^ Полигон TSMC, 28 нм
- ^ Чао, Вэйлунь; Ким, Джихун; Андерсон, Эрик Х.; Фишер, Питер; Рекава, Сенаджит; Эттвуд, Дэвид Т. (9 января 2009 г.). Процессы двойного формирования рисунка HSQ на зонных пластинах для обеспечения ограниченной дифракции 10 нм . 53-й Международный симпозиум по электронным, ионным и фотонным пучкам и нанолитографии, Марко-Айленд, Флорида, 26–29 мая 2009 г.
- ^ Дуань, Хуйгао; Уинстон, Дональд; Ян, Джоэл К.В.; Корд, Брайан М.; Манфринато, Витор Р.; Берггрен, Карл К. (ноябрь 2010 г.). «Электронно-лучевая литография с полушагом менее 10 нм с использованием поли(метилметакрилата) в качестве негативного резиста» (PDF) . Журнал вакуумной науки и технологий B, Нанотехнологии и микроэлектроника: материалы, обработка, измерения и явления . 28 (6): C6C58–C6C62. Бибкод : 2010JVSTB..28C..58D . дои : 10.1116/1.3501353 . hdl : 1721.1/73447 . Архивировано из оригинала (PDF) 19 января 2012 г.
- ^ округ Колумбия Фландрия; Н. Н. Ефремов (1983). «Генерация решеток с периодом <50 нм с использованием методов определения границ». Журнал вакуумной науки и технологий B : 1105–1108.
- ^ Крис Бенчер; Юнмей Чен; Хусюн Дай; Уоррен Монтгомери; Лиор Хули (2008). «Нанесение рисунка с полушагом 22 нм с помощью двойного рисунка самовыравнивающейся прокладки CVD (SADP)». Оптическая микролитография XXI . 6924 . Оптическая микролитография XXI; 69244Э: 69244Э. Бибкод : 2008SPIE.6924E..4EB . дои : 10.1117/12.772953 . S2CID 121968664 .
- ^ А. Ванлинхов; Д. Ван Стенвинкель (2007). Флагелло, Донис Дж. (ред.). «Подход к двойному узору, основанный только на литографии». Серия конференций Общества инженеров фотооптического приборостроения (Spie) . Оптическая микролитография XX. 6520 . Оптическая микролитография XX; 65202Ф: 65202Ф. Бибкод : 2007SPIE.6520E..2FV . дои : 10.1117/12.713914 . S2CID 119829809 .
- ^ «Получатели премии IEEE Эндрю С. Гроува» . Премия IEEE Эндрю С. Гроува . Институт инженеров электротехники и электроники . Архивировано из оригинала 9 сентября 2018 года . Проверено 4 июля 2019 г.
- ^ «Микрон шестой год подряд входит в число 100 лучших новаторов мира» . Технология Микрон . 15 февраля 2018 г. Проверено 5 июля 2019 г.
- ^ Д. Де Симоне, А. Сингх, Г. Ванденберге, Proc. ШПИЕ 10957, 109570Q (2019).
- ^ Милан Вала; Иржи Хомола (2014). «Гибкий метод на основе четырехлучевой интерференционной литографии для изготовления больших площадей идеально периодических плазмонных массивов» . Оптика Экспресс . 22 (15): 18778–18789. дои : 10.1364/OE.22.018778 .
- ^ Перейти обратно: а б с ван Сеттен, Eelco; Виттебруд, Фризо; и др. (4 сентября 2015 г.). «Варианты шаблонов для логики N7: перспективы и проблемы EUV». В Берингере, Уве Ф.В.; Файндерс, Джо (ред.). Учеб. SPIE 9661, 31-я Европейская конференция по маскам и литографии . 31-я Европейская конференция по маскам и литографии, 22–23 июня 2015 г., Эйндховен, Нидерланды. Искусство. 96610Г. Бибкод : 2015SPIE.9661E..0GV . дои : 10.1117/12.2196426 . S2CID 106609033 .
- ^ Перейти обратно: а б РХ. Ким и др. , учеб. SPIE том. 9776, 97761Р (2016).
- ^ Р.Л. Джонс и Дж.Д. Байерс, Proc. ШПИЕ 5040, 1035 (2003).
- ^ С. Кобаяши и др., Proc. ШПИЕ 6521, 65210Б (2007 г.).
- ^ Перейти обратно: а б с д Котб Р. и др., Proc. SPIE 10583, 1058321 (2018).
- ^ Перейти обратно: а б с Ю. Бородовский (2012). EUV-литография при вставке и за ее пределами (PDF) . Международный семинар по EUV-литографии.
- ^ Перейти обратно: а б ЛТ-Н. Ван и др., Proc. ШПИЕ 9781, 97810B (2016).
- ^ CA Mack, Proc. ШПИЕ 4226, 83 (2000).
- ^ Маклеллан, Пол (2017). «TSMC @ N7 с Cadence» . Блоги сообщества Cadence .
- ^ CT Бодендорф, Proc. SPIE 5992, 599224 (2005).
- ^ М. Буркхардт и др., Proc. ШПИЕ 6520, 65200К (2007 г.).
- ^ Э. Хендрикс и др., Proc. ШПИЕ 6924, 69240Л (2008 г.).
- ^ В.Н. Партло и др., проф. ШПИОН 1927, 137 (1993).
- ^ Т. Винклер и др., Proc. SPIE 5754, 1169 (2005).
- ^ Ю. Чен и др., Дж. Вак. наук. & Техн. Б 35, 06Г601 (2017).
- ^ К. Цуджита и др., Proc SPIE 6520, 652036 (2007).
- ^ Т. Винклер и др., Proc. SPIE 5754, 1169 (2005).
- ^ Перейти обратно: а б К. Тиан и др., Proc. SPIE 7274, 72740C (2009).
- ^ Несовместимость шага металлического рисунка периферии DRAM
- ^ Запрещенная комбинация шага в узлах расширенной литографии
- ^ FM Шелленберг и др., DAC 2001, Внедрение OPC и влияние на дизайн и компоновку.
- ^ В. Вио и др., Proc. SPIE 5040, 270 (2003).
- ^ Б. Бильски и др., Proc. SPIE 10466, 1046605 (2017).
- ^ 80-нм DRAM Samsung
- ^ Когда литография требует множественного рисунка: избежание аналоговых искажений в слое резиста
- ^ Перейти обратно: а б Выборочное травление в SAQP для создания рисунка размером менее 20 нм
- ^ Перейти обратно: а б Н. Сингх и М. Мукерджи-Рой, Proc. SPIE том. 4691, 1054 (2002).
- ^ Дж. Гарофало и др., Дж. Вак. наук. & Техн. Б 11, 2651 (1993).
- ^ Т. Мацуда и др., Proc. SPIE 7973, 797316 (2011).
- ^ Выпуск журнала Intel Technology Journal, посвященный 45-нм технологии.
- ^ Как разрезы стали обязательно отдельными этапами в литографии
- ^ М. Эрлингс и др., Proc. SPIE 4404, 266 (2001).
- ^ Исчезновение половины коэффициентов Фурье в шахматных массивах
- ^ Оптимизированное освещение для рисунков резки плотного металла.
- ^ Стохастическая изменчивость EUV в разрезах линий
- ^ С-Мин Ким и др., Proc. ШПИЕ 6520, 65200H (2007 г.).
- ^ Ю. Кохира и др., Proc. ШПИЕ 9053, 90530Т (2014 г.).
- ^ Литография для конкретного приложения: усилитель чувствительности и металлический узор в драйвере подсловной строки в DRAM
- ^ «Масштабируемая наноэлектроника – сопротивляется» . Архивировано из оригинала 23 марта 2010 г.
- ^ ЛаПедус, Марк (13 марта 2008 г.). «JSR демонстрирует «замораживающий материал» для 22-нм производства» . Архивировано из оригинала 15 июля 2014 г.
- ^ X. Хуа и др., Дж. Вак. наук. Тех. Б, том. 24, стр. 1850–1858 (2006).
- ^ Ю.К. Чой и др., J. Phys. Ткань. Б, том. 107, с. 3340-3343 (2003).
- ^ Чао, Робин; Кохли, Крити К.; Чжан, Юньлинь; Мадан, Анита; Мутинти, Гангадхара Раджа; Хонг, Огюстин Дж.; Конклин, Дэвид; Холт, Джадсон; Бейли, Тодд К. (1 января 2014 г.). «Мультитехнические метрологические методы для оценки шага шага в FinFET-транзисторах с длиной волны 14 нм и выше». Журнал микро/нанолитографии, MEMS и MOEMS . 13 (4): 041411. Бибкод : 2014JMM&M..13d1411C . дои : 10.1117/1.JMM.13.4.041411 . ISSN 1932-5150 . S2CID 122374784 .
- ^ И. Бушомс и др. , учеб. ШПИЕ 7274, 72741К (2009).
- ^ Патент США 6165880, переданный TSMC.
- ^ Ю. Лаке и др. , Микроэлектр. англ. 107, 138 (2013).
- ^ Патент США 8813012, переданный Synopsys.
- ^ Перейти обратно: а б Р. Брейн и др. , ИИТС 2009.
- ^ П. Пакан и др. , ИЭДМ 2009.
- ^ Ссылка: Патент США 8312394, переданный Synopsys.
- ^ К. Ояма и др., Proc. ШПИЕ 9051, 90510В (2014 г.).
- ^ Б. Мебарки и др. , патент США 8 084 310, присвоенный прикладным материалам.
- ^ Перейти обратно: а б MC Смайлинг и др. , учеб. SPIE 8683, 868305 (2013).
- ^ Дж. М. Парк и др. , ИЭДМ 2015, 676 (2015).
- ^ Назначение функций прокладок в SAQP.
- ^ Литография для конкретного применения - двумерная трассировка с шагом 28 нм
- ^ Презентация синопсиса на Semicon West 2013. Архивировано 24 сентября 2015 г. в Wayback Machine.
- ^ З. Сяо и др. , учеб. ШПИЕ 8880, 888017-3 (2013).
- ^ Дж. Бекарт и др., Proc. ШПИЕ 9658, 965804 (2015).
- ^ SH Парк и др. , Мягкая материя, 6, 120-125 (2010).
- ^ К.Г. Харди и К. Тан, J. Polymer Sci. Пт. Б: Физика полимеров, вып. 51, стр. 2–15 (2013).
- ^ ЛВ. Чанг и др. Технический дайджест IEDM 2010, 752–755 (2010).
- ^ Отчет NIST 2011 по LER в PS-b-PMMA DSA
- ^ A. N. Semenov, Macromolecules 26, 6617 (1993).
- ^ А. Гарби и др., Proc. ШПИЕ 9777, 97770Т (2016).
- ^ Д. Сивай и др. , Дж. Микро/Нанолит. МЭМС МОЭМС 14, 023501 (2015).
- ^ К. Секи и др. , Учеб. SPIE 9658, 96580G (2015).
- ^ Патент США 7842601, переданный Samsung.
- ^ Ю. Чен и др. , Proc. SPIE 7973, 79731P (2011).
- ^ М. Мирсаиди и др. , IEEE Транс. СБИС-система. 22, 1170 (2014).
- ^ Патент США 7846849, присвоенный прикладным материалам.
- ^ SW Ким и др., JVST B 34, 040608 (2016).
- ^ Перейти обратно: а б Ф.Т. Чен и др. , учеб. ШПИЕ 8326, 83262Л (2012 г.).
- ^ S. Sakhare et al., Proc. SPIE 9427, 94270O (2015).
- ^ Н. Моханти и др., Proc. ШПИЕ 10147, 1014704 (2017).
- ^ Требование удвоения шага травления для удобной для резки компоновки металлических дорожек: устранение зависимости от длины волны литографии
- ^ Перейти обратно: а б ТБ. Чиу и др. , учеб. ШПИЕ 9781, 978107 (2016).
- ^ TH-Bao et al. , учеб. ШПИЕ 9781, 978102 (2016).
- ^ Перейти обратно: а б Y. Chen и др., J. Vac. наук. Тех. Б35, 06Г601 (2017).
- ^ М. Крауз и др. , учеб. ШПИЕ 10148, 101480H (2017).
- ^ В. Гиллийнс и др. , Proc. SPIE 10143, 1014314 (2017).
- ^ Т. Ласт и др. , учеб. ШПИЕ 10143, 1014311 (2017).
- ^ С. Сюй и др. , учеб. ШПИЕ 9422, 94221И (2015 г.).
- ^ Мерритт, Рик (7 октября 2015 г.). «5-нм тестовые лампы Litho Path Hybrid 193i, EUV считаются лучшим подходом» . ЭТаймс .
- ^ Перейти обратно: а б с ASML High-NA EUV
- ^ Представлена NVIDIA Pascal Tesla P100 — 15,3 миллиарда транзисторов на кристалле площадью 610 мм2, изготовленном по технологии 16 нм
- ^ Микролитография: наука и технологии , 2-е изд., Б.В. Смит и К. Сузуки (ред.), CRC Press, 2007, стр. 94.
- ^ Справочник по технологии производства полупроводников , Ю. Ниши и Р. Деринг (ред.), CRC Press, 2000, стр. 475.
- ^ Литография для конкретного применения: через разделение на 5 нм и более
- ^ В. Гао и др., Proc.SPIE 11323, 113231L (2020).
- ^ Hynix M1X NAND
- ^ Патент США 9318369, переданный Samsung.
- ^ Intel обсуждает 10-нм
- ^ Intel представляет 10-нм техпроцесс
- ^ Intel переходит на 7 нм без EUV
- ^ «Ухабистый путь к 10-нм FinFET» . 21 мая 2015 г.
- ^ Тройной рисунок становится обычным явлением при 10 нм.
- ^ Samsung анонсирует 10-нм техпроцесс FinFET для SoC
- ^ «Semimd — журнал о здоровье и фитнесе 2020» . 10 ноября 2023 г.
- ^ С.Ю. Ву и др., IEDM 2016, документ 2.7.
- ^ Перейти обратно: а б IEDM 2016 Этап настройки для 7/5 нм
- ^ FT Чен и др. , учеб. SPIE 8683, 868311 (2013).
- ^ FT Чен и др. , учеб. SPIE том. 8326, 82362Л (2012).
- ^ Перейти обратно: а б с «Процесс литографии 14 нм — WikiChip» .
- ^ Перейти обратно: а б [1] А. Йео и др., IITC 2018.
- ^ Заявка на патент США 20150179513.
- ^ Свати Чаван; Джайеш Праджапати; Акаш Верма. «Эвристический подход к устранению нарушений правил проектирования (DRC) в конструкциях ASIC @ 7-нм технологии FinFET» . Проектирование и повторное использование .
- ^ TSMC в 2017 г.
- ^ Перейти обратно: а б Дж. Ким и др., Proc. ШПИЕ 10962, 1096204 (2019).
- ^ Поддержка Калибра для 8LPP и 7LPP.
- ^ Перейти обратно: а б [2] Х. Ри и др., 2018 Symp. Техн. СБИС, 217.
- ^ Mentor расширяет поддержку 7-нм FinFET Plus
- ^ Сообщение о прибылях и убытках TSMC за второй квартал 2019 г.
- ^ RR Haque et al. , учеб. ШПИЕ 9776, 97760F (2016).
- ^ Samsung получает 24 погружных инструмента от ASML в 2010 г.
- ^ Расширение иммерсионной литографии до узлов размером 1xnm.
- ^ Ошибки EUV под атакой
- ^ Перейти обратно: а б MC Смайлинг и др., Proc. SPIE 8683, 868305 (2013).
- ^ Перейти обратно: а б Патент США 9240329.
- ^ Перейти обратно: а б Заявка на патент США 20170221902.
- ^ Патент США 8697538.
- ^ П. Бишоп и Э. Хендрикс, Proc. ШПИЕ 10583, 105831К (2018).
- ^ К. Лин, Proc. ШПИОН 11327, 113270X (2020).
- ^ SALELE двойной шаблон для узлов 7 и 5 нм.
- ^ Ф. Лаццарино и др., Proc. SPIE 10149, 1014908 (2017).
- ^ Z. Сяо и др., Proc. SPIE 8880, 888017 (2013).
- ^ Самовыравнивающееся перераспределение и расширение блоков для повышения производительности работы с несколькими шаблонами
- ^ Дж.Х. Франке и др., Proc. ШПИЕ 10145, 1014529 (2017).
- ^ П. Де Бишоп и Э. Хендрикс, Proc. ШПИЕ 10583, 105831К (2018).
- ^ Ленты TSMC в 2018 году.
- ^ SAQP для FinFET
- ^ Лидерство Intel 14 нм
- ^ Q. Ву и др., CSTIC 2023.
- ^ Расширение многопаттернности DUV в сторону 3 нм
- ^ Уменьшение маски BEOL с использованием промежуточных отверстий и разрезов
- ^ ЮС. Канг и др., J. Micro/Nanolith. МЭМС МОЭМС том. 15(2), 021403 (2016).
- ^ Патент США 7253118.
- ^ DRAM Samsung 18 нм
- ^ Рисунок с тройной прокладкой для металлической периферии DRAM
- ^ Х. Дай и др., Proc. ШПИОН 7275, 72751E (2009 г.).
- ^ Дж. Ван Шут и др., Proc. ШПИЕ 11147, 1114710 (2019).
- ^ С. Канг и др., Proc. SPIE 11611, 1161129 (2021).
- ^ Д. Рио и др., Proc. SPIE 11609, 116090T (2021).
- ^ Дж.Х. Франке и др., Proc. ШПИЕ 11517, 1151716 (2020).