Вспышка ловушки заряда
Флэш-память с ловушкой заряда ( CTF ) — это технология полупроводниковой памяти, используемая при создании энергонезависимой NOR и NAND флэш-памяти . Это разновидность MOSFET с плавающим затвором технологии памяти , но она отличается от традиционной технологии с плавающим затвором тем, что для хранения электронов в ней используется пленка нитрида кремния, а не легированный поликристаллический кремний, типичный для структуры с плавающим затвором. Такой подход позволяет производителям памяти сократить производственные затраты пятью способами:
- Для формирования узла хранения заряда требуется меньше технологических этапов.
- Можно использовать меньшую геометрию процесса (следовательно, уменьшая размер и стоимость чипа)
- В одной ячейке флэш-памяти можно хранить несколько битов.
- Повышенная надежность
- Более высокий выход, поскольку ловушка заряда менее восприимчива к точечным дефектам в туннельном оксидном слое.
Хотя концепция улавливания заряда существовала и раньше, только в 2002 году AMD и Fujitsu выпустили флэш-память с улавливанием заряда большого объема. Они начали коммерческое производство флэш-памяти с улавливанием заряда, представив семейство флэш-памяти GL NOR. Это же предприятие, сейчас работающее под названием Spansion , с тех пор производит устройства улавливания заряда в больших объемах. Вспышки с улавливанием заряда в 2008 году заняли 30% рынка флэш-памяти NOR стоимостью 2,5 миллиарда долларов. Saifun Semiconductors , которая лицензировала большой портфель технологий улавливания заряда нескольким компаниям, была приобретена Spansion в марте 2008 года. С конца 2000-х годов CTF стал основным компонентом флэш-памяти 3D V-NAND, разработанной Toshiba и Samsung Electronics .
Происхождение
[ редактировать ]Оригинальный MOSFET (полевой транзистор металл-оксид-полупроводник или МОП-транзистор) был изобретен египетским инженером Мохамедом М. Аталлой и корейским инженером Давоном Кангом в Bell Labs в 1959 году и продемонстрирован в 1960 году. [1] Кан продолжил изобретать МОП-транзистор с плавающим затвором вместе с Саймоном Мин Сзе из Bell Labs, и они предложили его использовать в качестве с плавающим затвором (FG) ячейки памяти в 1967 году. [2] Это была первая форма энергонезависимой памяти, основанная на вводе и хранении зарядов в МОП-транзисторах с плавающим затвором. [3] которая позже стала основой для технологий EPROM (стираемого PROM ), EEPROM (электрически стираемого PROM) и флэш-памяти . [4]
Концепция захвата заряда была впервые представлена Джоном Седоном и Тингом Л. Чу в 1967 году. [ нужна ссылка ]
В конце 1967 года исследовательская группа Сперри под руководством Ричарда Вегенера изобрела транзистор металл-нитрид-оксид-полупроводник (MNOS-транзистор). [5] тип МОП-транзистора, в котором оксидный слой заменен двойным слоем нитрида и оксида. [6] Нитрид использовался в качестве улавливающего слоя вместо плавающего затвора, но его использование было ограничено, поскольку считалось, что он уступает плавающему затвору. [7] Транзисторное устройство MNOS можно запрограммировать путем применения 50-вольтового прямого или обратного смещения между затвором и каналом для улавливания зарядов, которые могут повлиять на пороговое напряжение транзистора.
Память с ловушкой заряда (CT) была представлена в устройствах MNOS в конце 1960-х годов. Его структура устройства и принципы работы аналогичны памяти с плавающим затвором (FG), но основное отличие состоит в том, что заряды хранятся в проводящем материале (обычно в слое легированного поликремния ) в памяти FG, тогда как память CT хранит заряды в локализованных ловушки внутри диэлектрического слоя (обычно из нитрида кремния ). [3]
Уловитель заряда EEPROM
[ редактировать ]К 1974 году технология улавливания заряда использовалась в качестве механизма хранения в электрически стираемой программируемой постоянной памяти (EEPROM) и была альтернативой стандартной технологии MOSFET с плавающим затвором . [8] В 1977 году PCY Chen из Fairchild Camera and Instrument опубликовал статью. [9] подробное описание изобретения SONOS , технологии MOSFET с гораздо менее требовательными условиями программирования и стирания, а также более длительным хранением заряда. Это улучшение привело к созданию в 1980-х годах производственных устройств EEPROM на базе SONOS с улавливанием заряда.
Эксперименты со вспышкой зарядовой ловушки
[ редактировать ]В 1991 году японские исследователи NEC, в том числе Н. Кодама, К. Ояма и Хироки Шираи, разработали тип флэш-памяти , включающий метод улавливания заряда. [10] В 1998 году израильский инженер Боаз Эйтан из компании Saifun Semiconductors (позже приобретенной Spansion ) запатентовал [11] технология флэш-памяти под названием NROM , в которой используется слой улавливания заряда для замены плавающего затвора, используемого в традиционных конструкциях флэш-памяти. В этом патенте фигурируют две важные инновации: локализация инжектированных отрицательных и положительных зарядов вблизи выводов стока/истока ячейки и использование концепции обратного считывания для обнаружения сохраненных данных ячейки на обоих концах ловушки заряда. Эти две новые идеи позволили обеспечить высокую цикличность, что позволило производить надежные вспышки с улавливанием заряда впервые с тех пор, как 30 лет назад была изобретена концепция улавливания заряда. Более того, используя эти концепции, можно создать два отдельных физических бита на ячейку, удвоив емкость хранимых данных на ячейку.
В 2000 году исследовательская группа Advanced Micro Devices (AMD) под руководством Ричарда М. Фастоу, египетского инженера Халеда З. Ахмеда и иорданского инженера Самира Хаддада (который позже присоединился к Spansion) продемонстрировала механизм улавливания заряда для флэш-памяти NOR ячеек . [12] Эти инновации были дополнительно усовершенствованы в AMD и Fujitsu в 2002 году (а позже и в Spansion) и впервые запущены в серийное производство этими компаниями в так называемой «MirrorBit Flash Memory».
Флеш-память Spansion MirrorBit
[ редактировать ]Вспышка с улавливанием заряда (CTF) была коммерциализирована компаниями AMD и Fujitsu в 2002 году. [13] В том же году компания AMD (подразделение, позднее выделенное в Spansion) анонсировала новую технологию флэш-памяти под названием «MirrorBit». [14] Компания Spansion использовала этот продукт для снижения производственных затрат и расширения диапазона плотности флэш-памяти NOR по сравнению с обычными флэш-памятью NOR, а также для обеспечения соответствия стоимости флэш-памяти NOR с многоуровневыми ячейками, производимой Intel .
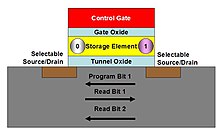
Ячейка MirrorBit использует слой улавливания заряда не только в качестве замены обычного плавающего затвора, но также использует преимущества непроводящей природы нитрида, накапливающего заряд, что позволяет двум битам совместно использовать одну и ту же ячейку памяти. Как показано на рисунке 1, биты расположены на противоположных концах ячейки и могут быть прочитаны, пропуская ток через канал в разных направлениях.
Были успешно созданы продукты, сочетающие этот подход с технологией многоуровневых ячеек, позволяющие содержать четыре бита в ячейке. [15]
Операция захвата заряда
[ редактировать ]Как и ячейка памяти с плавающим затвором, ячейка улавливания заряда использует переменный заряд между управляющим затвором и каналом для изменения порогового напряжения транзистора. Механизмы изменения этого заряда у плавающего затвора и ловушки заряда относительно схожи, и механизмы считывания также очень похожи.
Улавливание заряда и механизмы с плавающими затворами
[ редактировать ]При флэш-памяти с захватом заряда электроны сохраняются в слое улавливания точно так же, как они хранятся в плавающем затворе стандартной флэш-памяти, EEPROM или EPROM . Ключевое отличие состоит в том, что слой улавливания заряда является изолятором, а плавающий затвор — проводником.
Высокие нагрузки на запись во флэш-память вызывают нагрузку на туннельный оксидный слой, создавая небольшие нарушения в кристаллической решетке, называемые «оксидными дефектами». Если создается большое количество таких сбоев, между плавающим затвором и каналом транзистора возникает короткое замыкание, и плавающий затвор больше не может удерживать заряд. Это основная причина износа флэш-памяти (см. Флэш-память#Износ памяти ), которая определяется как «выносливость» чипа. Чтобы уменьшить возникновение таких коротких замыканий, вспышка с плавающим затвором изготавливается с использованием толстого туннельного оксида (~ 100 Å), но это замедляет стирание при использовании туннелирования Фаулера-Нордхайма и вынуждает конструкцию использовать более высокое туннельное напряжение, что ставит новые нагрузки на другие части чипа.
Ячейка улавливания заряда относительно невосприимчива к таким трудностям, поскольку слой улавливания заряда является изолятором. [16] Короткое замыкание, создаваемое оксидным дефектом между слоем улавливания заряда и каналом, отводит только электроны, находящиеся в непосредственном контакте с замыкателем, оставляя остальные электроны на месте, чтобы продолжать контролировать пороговое напряжение транзистора. Поскольку короткие замыкания вызывают меньшую озабоченность, можно использовать более тонкий туннельный оксидный слой (50–70 Å), увеличивая связь улавливающего слоя с каналом и приводя к более высокой скорости программы (с локализованными захваченными зарядами) и стиранию при более низких туннельных напряжениях. Более низкие туннельные напряжения, в свою очередь, создают меньшую нагрузку на туннельный оксидный слой, что приводит к меньшему количеству нарушений решетки.
Еще одним важным преимуществом использования ячейки улавливания заряда является то, что тонкий слой улавливания заряда уменьшает емкостную связь между соседними ячейками, что повышает производительность и масштабируемость. [16]
Перенос заряда на слой улавливания заряда
[ редактировать ]Электроны перемещаются на слой улавливания заряда аналогично тому, как программируется вспышка NOR с плавающим затвором, через механизм инжекции горячих электронов в канале (CHE), также известный как инжекция горячих носителей . Короче говоря, между управляющим затвором подается высокое напряжение, в то время как к истоку и стоку прикладывается средне-высокое напряжение, в то время как ток индуцируется от истока к стоку. Те электроны, которые набрали достаточную энергию при прохождении через область сильного поля возле стока, испаряются из канала и инжектируются в слой улавливания заряда, где они останавливаются.
Удаление заряда из слоя улавливания заряда
[ редактировать ]Флэш-память улавливания заряда стирается посредством инъекции горячих дырок (см. Инжекция горячих носителей ) в отличие от подхода туннелирования Фаулера-Нордхайма, используемого как во флэш-памяти NAND, так и во флэш-памяти NOR для стирания. В этом процессе используется поле, а не ток, используемый в FN, для перемещения дырок к слою улавливания заряда и удаления заряда.
Производственная вспышка для улавливания заряда
[ редактировать ]Вспышка с улавливанием заряда по изготовлению аналогична вспышке с плавающим затвором, за некоторыми исключениями, которые служат для упрощения производства.
Отличия материалов от плавающих ворот
[ редактировать ]И вспышка с плавающим затвором, и вспышка с улавливанием заряда используют многоуровневую структуру затвора, в которой плавающий затвор или слой улавливания заряда находится непосредственно над каналом и под управляющим затвором. Плавающий затвор или слой улавливания заряда изолирован от канала туннельным оксидным слоем, а от управляющего затвора - оксидным слоем затвора. Материалы для всех этих слоев одинаковы, за исключением накопительного слоя, который представляет собой проводящий поликремний для структуры с плавающим затвором и обычно представляет собой нитрид кремния для ловушки заряда.
Связь захвата заряда с кремниевыми нанокристаллами
[ редактировать ]Freescale Semiconductor производит похожую технологию, которую компания называет «Thin Film Storage» в своей линейке микроконтроллеров или MCU. Подход Freescale использует нанокристаллы кремния в качестве проводящих островков в непроводящем слое оксида кремния.
Как и в более традиционной ловушке заряда из нитрида кремния , электроны не перетекают с одной стороны плавающего затвора на другую, увеличивая износ элемента.
Этот нанокристаллический подход массово производится компанией Freescale, а системы хранения с улавливанием заряда в целом разрабатываются в ST Microelectronics, Philips, Renesas, Samsung, Toshiba, Atmel и Spansion. [17]
Отличия процесса от плавающих ворот
[ редактировать ]Поскольку нитридный слой, улавливающий заряд, не проводит ток, на нем нет необходимости создавать рисунок – все ловушки заряда уже изолированы друг от друга. Это можно использовать для упрощения производства.
Структуры с плавающим затвором требовали более сложных диэлектриков затвора для последних нескольких поколений процессов, и сегодня обычно используется структура ONO (оксид-нитрид-оксид), которая более сложна в изготовлении и не является необходимой для вспышки с улавливанием заряда.
Одним из преимуществ нитридного слоя является то, что он менее чувствителен к высокотемпературной обработке, чем поликремний, используемый в плавающем затворе. Это упрощает обработку слоев над ловушкой заряда.
Флэш-память MirrorBit
[ редактировать ]MirrorBit Flash от Spansion и NROM от Saifun — это две флэш-памяти, в которых используется механизм захвата заряда в нитриде для хранения двух битов в одной ячейке, что эффективно удваивает емкость памяти чипа. Это делается путем размещения зарядов по обе стороны слоя ловушки заряда. Ячейка считывается с использованием прямых и обратных токов через канал для считывания любой стороны ловушки заряда.
Операция MirrorBit – получение 2 битов в ячейку
[ редактировать ]
Во время программирования CHE (рис. 2) горячие электроны инжектируются из канала в слой улавливания заряда в сторону смещенного стокового конца канала, но не из плавающего истокового конца канала. Позволяя истоку и стоку транзистора переключаться с одного конца канала на другой, заряды можно инжектировать и сохранять в слое улавливания заряда на любом конце канала.
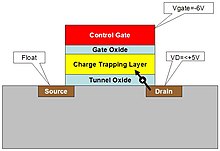
Аналогичным образом можно стереть один конец ячейки улавливания заряда, поместив стирающее поле на одном или другом конце канала, оставив другой конец плавающим, как показано на рисунке 3. Стирание горячей дырки между полосами создает дырки, которые захватываются локально, некоторые из которых рекомбинируют с электронами, удаляя заряд с этого конца зарядовой ловушки.
Чтение 2 битов из ячейки
[ редактировать ]Чтение MirrorBit выполняется очень просто, меняя местами контакты истока и стока. Область обеднения перехода, простирающаяся со стороны стока, экранирует канал от заряда на стороне ячейки улавливания заряда, которая перекрывает сток. Конечным результатом этого является то, что заряд на стороне стока мало влияет на ток, протекающий через канал, в то время как заряд на стороне истока определяет порог срабатывания транзистора.
Когда исток и сток меняются местами, заряд противоположной стороны определяет порог транзистора.
Таким образом, два разных уровня заряда на обоих концах ячейки улавливания заряда вызовут протекание двух разных токов через ячейку, в зависимости от направления тока.
Более поздние события
[ редактировать ]Улавливание заряда NAND — Samsung и другие
[ редактировать ]Samsung Electronics в 2006 году раскрыла информацию [18] ее исследования по использованию флэш-памяти с улавливанием заряда, позволяющие продолжать масштабирование технологии NAND с использованием клеточных структур, аналогичных планарным структурам, которые использовались в то время. Технология зависит от структуры конденсатора SONOS (кремний-оксид-нитрид-оксид-кремний) или MONOS (металл-ONOS), хранящей информацию в ловушках заряда в нитридном слое.
Samsung раскрыла две структуры ячеек: TANOS (титан, оксид алюминия, нитрид, оксид, кремний) для 40 нм, где исследователи считали, что существующая трехмерная структура крышки (подробно описанная далее в этой статье) не может быть изготовлена, и THNOS, в которой оксид алюминия будет заменен неизвестным диэлектрическим материалом с высоким k . Ожидалось, что материал с высоким k обеспечит более длительное время удерживания, чем структура из оксида алюминия.
В конструкции крышки управляющий затвор расширен, образуя барьер между соседними плавающими затворами в обычной ячейке с плавающими затворами.
В течение следующих пяти лет многие разработчики устройств нашли способы приблизить структуру крышки к более жесткой технологической геометрии, успешно производя NAND на узле 30 нм с помощью этого подхода.
Улавливание заряда по-прежнему рассматривается как будущая технология для флэш-памяти NAND, но она рассматривается больше для вертикальных структур, чем для плоских ячеек.
Почему NAND нужна технология улавливания заряда
[ редактировать ]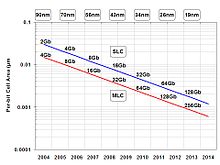
Флэш-память NAND масштабируется очень агрессивно (рис. 4). По мере миграции процессов ширина границы раздела управляющего вентиля и плавающего вентиля уменьшается пропорционально площади сжатия, а расстояние между плавающими вентилями сокращается пропорционально сжатию процесса, но толщина плавающего вентиля остаётся прежней ( чем тоньше плавающий затвор, тем менее устойчивой становится клетка к потере электронов). Это означает, что связь между соседними плавающими вентилями становится больше, чем связь между управляющим вентилем и плавающим вентилем, что приводит к повреждению данных между соседними битами.
Поскольку процессы продолжают сокращаться, это становится все более проблематичным. По этой причине управляющий вентиль в современной флэш-памяти NAND был переконфигурирован, чтобы закрыть плавающий вентиль. В конструкции с крышкой управляющий затвор расширен и образует барьер между соседними плавающими затворами в обычной ячейке с плавающими затворами (см. рисунок 5). Это служит для уменьшения связи с соседним плавающим затвором и одновременного увеличения связи между плавающим затвором и управляющим затвором. Одним из недостатков является то, что управляющий вентиль соединяется с каналом, поэтому необходимо принять меры для минимизации этой связи.
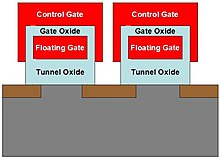
В 2006 году считалось, что существующая структура крышки с плавающим затвором не может быть изготовлена с использованием процессов, меньших, чем узел 50 нм, из-за трудностей в производстве сложного трехслойного оксида затвора ONO, который требуется для этих устройств.
Самсунг даже анонсировал [19] В конце 2006 года компания заявила, что к 2008 году такое устройство будет запущено в производство по технологическому процессу 40 нм, но в течение пяти лет после этого объявления многие разработчики устройств нашли способы подтолкнуть структуру крышки к все более жесткой геометрии процесса, успешно производя NAND до Узел 20 нм при таком подходе.
Подход улавливания заряда по-прежнему рассматривается как будущее флэш-памяти NAND для процессов размером менее 20 нм и рассматривается как для плоских, так и для вертикальных трехмерных структур.
Когда это изменение может произойти
[ редактировать ]Сегодня [ когда? ] SanDisk утверждает, что компания рассчитывает и дальше использовать традиционные структуры NAND во втором узле в диапазоне 10–19 нм. [20] Это означает, что стандартные структуры устройств могут оставаться неизменными до тех пор, пока отрасль не достигнет 10 нм, однако проблемы создания надежных плавающих затворов становятся все более серьезными с каждым сокращением процесса.
С другой стороны, Международной технологической дорожной карты для полупроводников (ITRS) на 2010 год. таблицы «Интеграция процессов, устройств и структур» (PIDS) [21] показывают внедрение улавливания заряда, начиная с 22 нм в 2012 году и становясь массовым в 2014 году благодаря 20-нм техпроцессу.
Возможно, в будущих процессах будет использоваться планарная ячейка улавливания заряда. Ни один производитель еще не раскрыл свои технологии для геометрий менее 19 нм.
Слои улавливания заряда для вертикальных структур
[ редактировать ]Вертикальные структуры рассматриваются как следующий логический шаг для флэш-памяти NAND, когда дальнейшее горизонтальное масштабирование становится невозможным. Поскольку вертикальные элементы невозможно выгравировать сбоку, слой улавливания заряда становится очень интересным способом создания вертикальной флэш-строки NAND.
Toshiba и Samsung Electronics представили прототипы структур NAND с улавливанием вертикального заряда.
BiCS от Toshiba и 3D NAND от Samsung
[ редактировать ]Тошиба в 2007 году [22] и Samsung в 2009 году [23] объявила о разработке 3D V-NAND , средства построения стандартной строки битов флэш-памяти NAND вертикально, а не горизонтально, чтобы увеличить количество бит в заданной области кремния.

Примерное представление о его поперечном сечении показано на рисунке 6. На этом рисунке красные части представляют собой проводящий поликремний, синие — изолирующие слои диоксида кремния, а желтые — слой улавливания заряда нитрида.
Вертикальные структуры (показана только одна) представляют собой цилиндры, которые реализуют канал, обернутый чередующимися слоями диэлектрика и улавливания заряда (синий и желтый). Для изготовления такого устройства слои проводящего поликремния и диэлектрика из диоксида кремния сначала наносятся поверх кремниевой подложки, содержащей стандартные логические элементы КМОП. Затем вытравливается траншея, и на ее стенки наносятся сначала диоксид кремния (синий), затем слой нитрида кремния (желтый), затем еще один слой диоксида кремния (синий), образуя диэлектрик затвора, ловушку заряда и туннельный диэлектрик в указанном порядке. . Наконец, отверстие заполняется проводящим поликремнием (красный), который образует канал. Чередующиеся слои проводящего поликремния действуют как управляющие ворота в этой структуре.
Эта структура использует тот факт, что слой ловушки заряда не нужно изолировать между каждым управляющим затвором, поэтому его не нужно травить в вертикальном направлении.
Улавливание заряда во встроенной памяти
[ редактировать ]Одним из преимуществ вспышки улавливания заряда перед другими технологиями является то, что ее можно относительно легко встроить в стандартный логический процесс. Стандартный логический процесс может быть преобразован в процесс «логика плюс флэш-память» путем добавления еще трех масок высокого напряжения и еще трех основных масок CTF, и ни одна из этих шести масок не является критическим уровнем (т.е. необходимо использовать наиболее продвинутую часть). процесса). Все остальные логические процессы могут использоваться напрямую. [24]
Устройства памяти с улавливанием заряда с использованием запрещенной зоны
[ редактировать ]В ITRS PIDS 2013 было четко упомянуто, что для решения дилеммы удержания и стирания заряда необходимы устройства улавливания заряда с использованием запрещенной зоны. Однако SONOS, использующий простой туннельный оксид, не подходит для применения NAND — как только электроны захватываются глубокими уровнями ловушки SiN, их трудно освободить даже в сильном электрическом поле. Чтобы быстро стереть устройство, в SiN вводятся отверстия в подложке для нейтрализации электронного заряда. Поскольку дырочный барьер для SiO2 высок (~ 4,1 эВ), эффективность инжекции дырок низкая, и достаточный дырочный ток достижим только при использовании очень тонкого туннельного оксида (~ 2 нм). Однако такой тонкий туннельный оксид приводит к плохому сохранению данных, поскольку прямое туннелирование дырок из подложки под действием слабого встроенного поля, вызванного накопительными электронами, невозможно остановить (скорость прямого туннелирования сильно зависит от толщины барьера, но лишь слабо). зависит от электрического поля, поэтому слабого встроенного поля, вызванного накоплением заряда, достаточно, чтобы вызвать прямое туннелирование дырок из подложки, что нарушает сохранение данных). Было предложено несколько вариантов SONOS. Концепции туннельной диэлектрики используются для изменения свойств туннельного барьера для создания туннельного диэлектрика «переменной толщины». Например, тройные ультратонкие (1–2 нм) слои ONO вводятся для замены одиночного оксида (BE-SONOS) [HT Lue, et al, IEDM 2005]. В сильном электрическом поле два верхних слоя оксида и нитрида смещаются над валентной зоной Si, и дырки в подложке легко туннелируют через нижний тонкий оксид и инжектируются в толстый улавливающий слой SiN выше. В режиме хранения данных слабое электрическое поле не компенсирует тройной слой, и как электроны в SiN, так и дырки в подложке блокируются всей толщиной тройного слоя. Позже в BE-SONOS добавляются высококалийный (Al2O3) и металлический затвор для улучшения характеристик стирания, так называемый BE-MANOS [SC Lai и др., NVSMW 2007]. Предлагается добавлять буферный оксид между высококалиевым Al2O3 и SiN для улучшения удерживания. В настоящее время массовое производство 3D NAND использует структуру, аналогичную BE-MANOS, с некоторыми вариациями детальной настройки рецепта каждой отдельной компанией. Концепция запрещенной зоны, разработанная для туннельного барьера, признана необходимой основой для устройств улавливания заряда.
Хотя улавливание заряда NAND может помочь решить проблемы перекрестных помех GCR и FG и, таким образом, обещает масштабирование ниже 20 нм, это не помогает устранить фундаментальные ограничения, такие как пробой словной линии и слишком малое количество электронов. Таким образом, в Согласно тенденции дорожной карты, он занимает переходную роль между планарной FG и 3D NAND. Когда устройства улавливания заряда используются для создания 3D NAND, больший размер устройства естественным образом решает проблемы числа электронов и пробой словесной строки.
Дальнейшее чтение
[ редактировать ]- «Samsung представляет 40-нм флэш-накопитель с ловушкой заряда» (пресс-релиз). Твердотельная технология. 11 сентября 2006 г. Архивировано из оригинала 3 июля 2013 г.
- Кинам Ким (2005). «Технология производства DRAM и флэш-памяти NAND размером менее 50 нм». Международная конференция IEEE по электронным устройствам, 2005 г. Технический дайджест IEDM . стр. 323–326. дои : 10.1109/IEDM.2005.1609340 . ISBN 0-7803-9268-Х . S2CID 16423250 .
{{cite book}}:|journal=игнорируется ( помогите ) - Санхун Чжон; и др. (декабрь 2005 г.). «Металлический затвор с высокой рабочей функцией и диэлектрики с высоким κ для устройств флэш-памяти с ловушками заряда». Транзакции IEEE на электронных устройствах . 52 (12): 2654–2659. Бибкод : 2005ITED...52.2654J . дои : 10.1109/TED.2005.859691 .
- Саид Тегерани; и др. (17 июня 2013 г.). «Будущее флэш-памяти с улавливанием заряда» . ЭЭ Таймс .
Ссылки
[ редактировать ]- ^ «1960 — Демонстрация металлооксидно-полупроводникового (МОП) транзистора» . Кремниевый двигатель . Музей истории компьютеров .
- ^ Кан, Давон ; Сзе, Саймон Мин (июль – август 1967 г.). «Плавающие ворота и их применение в устройствах памяти». Технический журнал Bell System . 46 (6): 1288–1295. Бибкод : 1967ITED...14Q.629K . дои : 10.1002/j.1538-7305.1967.tb01738.x .
- ^ Jump up to: а б Иоанну-Суфлеридис, В.; Димитракис, Панайотис; Норманд, Паскаль (2015). «Глава 3: Воспоминания с ловушками заряда с модифицированными ионным пучком ONO-треками» . Энергонезависимая память с улавливанием заряда: Том 1 – Базовые и расширенные устройства . Спрингер. стр. 65–102 (65). ISBN 9783319152905 .
- ^ «Не просто вспышка на сковороде» . Экономист . 11 марта 2006 года . Проверено 10 сентября 2019 г.
- ^ Вегенер, HAR; Линкольн, Эй Джей; Пао, ХК; О'Коннелл, MR; Олексиак, Р.Э.; Лоуренс, Х. (октябрь 1967 г.). Транзистор с переменным порогом — новое электрически изменяемое неразрушающее запоминающее устройство, доступное только для чтения . 1967 г. Международная встреча по электронным устройствам. Том. 13. с. 70. дои : 10.1109/IEDM.1967.187833 .
- ^ Броди, Айвор; Мюрей, Джулиус Дж. (2013). Физика микропроизводства . Springer Science & Business Media . п. 74. ИСБН 9781489921604 .
- ^ Пралл, Кирк; Рамасвами, Нирмал; Года, Акира (2015). «Глава 2: Краткий обзор современного состояния памяти NAND» . Энергонезависимая память с улавливанием заряда: Том 1 – Базовые и расширенные устройства . Спрингер. стр. 37–64 (39). ISBN 9783319152905 .
- ^ Таруи, Иисус; Нагай, Киёко; Хаяши, Юта (19 июля 1974 г.). «Энергонезависимая полупроводниковая память» (PDF) . Это Бутури 43 (10): 990–1002. дои : 10.11470/aubutsu1932.43.990 . ISSN 2188-2290 . Архивировано (PDF) из оригинала 1 марта 2018 г.
- ^ Чен, PCY (1977). «МОП-устройства Si-gate с изменяемым порогом». Транзакции IEEE на электронных устройствах . 24 (5): 584–586. Бибкод : 1977ITED...24..584C . дои : 10.1109/T-ED.1977.18783 . ISSN 0018-9383 . S2CID 25586393 .
- ^ Кодама, Н.; Ояма, К.; Шираи, Х.; Сайто, К.; Окадзава, Т.; Хокари, Ю. (декабрь 1991 г.). «Ячейка с симметричной боковой стенкой (SSW)-DSA для флэш-памяти емкостью 64 Мбит». Международная встреча по электронным устройствам, 1991 г. [Технический дайджест] . стр. 303–306. дои : 10.1109/IEDM.1991.235443 . ISBN 0-7803-0243-5 . S2CID 111203629 .
{{cite book}}:|journal=игнорируется ( помогите ) - ^ Эйтан, Боаз. «Патент США 5768192: Энергонезависимая полупроводниковая ячейка памяти, использующая асимметричный захват заряда» . Ведомство США по патентам и товарным знакам . Проверено 22 мая 2012 г.
- ^ Фастоу, Ричард М.; Ахмед, Халед З.; Хаддад, Самир; и др. (апрель 2000 г.). «Увеличение заряда, индуцированное запеканием, в флэш-ячейках NOR» . Письма об электронных устройствах IEEE . 21 (4): 184–186. Бибкод : 2000IEDL...21..184F . дои : 10.1109/55.830976 . S2CID 24724751 .
- ^ «Samsung производит первую память 3D NAND, стремясь повысить плотность и снизить стоимость за ГБ» . ЭкстримТех . 6 августа 2013 года . Проверено 4 июля 2019 г.
- ^ Ламмерс, Дэвид (13 мая 2016 г.). «AMD противопоставляет MirrorBit Intel StrataFlash» . ЭЭ Таймс .
- ^ «Пресс-релиз «Spansion представляет первое семейство решений MirrorBit® Quad для доставки контента» » . Компания «Спансион», Инкорпорейтед. Архивировано из оригинала 12 июля 2012 года . Проверено 22 мая 2012 г.
- ^ Jump up to: а б Принц, Бетти (2006). «Эволюция флэш-памяти: нитридное хранилище и кремниевый нанокристалл». Материалы конференции CMOSET : слайд 12.
- ^ Принц, Бетти (2006). «Эволюция флэш-памяти: нитридное хранилище и кремниевый нанокристалл». Материалы конференции CMOSET : слайд 13.
- ^ Ким, Кинам; Чой, Юнгдал (2006). «Перспективы на будущее технологии NAND Flash для 40-нм узлов и выше». Материалы семинара IEEE по энергонезависимой полупроводниковой памяти : 9–11.
- ^ «Пресс-релиз: Samsung анонсирует первое 40-нанометровое устройство — флэш-память NAND емкостью 32 ГБ с революционной технологией улавливания заряда» . Samsung . Проверено 3 ноября 2013 г.
- ^ Харари, Эли (2010). «Презентация встречи финансовых аналитиков SanDisk»: слайд 16.
{{cite journal}}: Для цитирования журнала требуется|journal=( помощь ) - ^ «Обновление интеграции процессов, устройств и структур (PIDS) ITRS, 2010 г.» . ITRS – Международная технологическая дорожная карта для полупроводников. Архивировано из оригинала 17 августа 2011 года . Проверено 22 мая 2012 г.
- ^ «Пресс-релиз: Toshiba разрабатывает новую технологию флэш-памяти NAND» . Корпорация Тошиба . Проверено 22 мая 2012 г.
- ^ Кимура, Масахидэ (17 сентября 2009 г.). «3D-ячейки делают возможной терабитную флэш-память NAND» . Никкей Тех-Он . Архивировано из оригинала 6 августа 2012 года.
- ^ Чунг, Сон Ён (2010). «Технология и конструкция устройства улавливания заряда для применения флэш-памяти NOR». Краткий курс Международного семинара по памяти .