7-нм процесс
Эта статья может быть слишком технической для понимания большинства читателей . ( январь 2020 г. ) |
| Полупроводник устройство изготовление |
|---|
 |
|
Масштабирование МОП-транзисторов ( узлы процесса ) |
|
|
Будущее
|
В производстве полупроводников процесс «7 нм» — это термин, обозначающий MOSFET технологический узел , следующий за узлом «10 нм» , определенным Международной дорожной картой для устройств и систем (IRDS), которой предшествовала Международная технологическая дорожная карта для полупроводников ( International Roadmap for Devices and Systems (IRDS)). ИТРС). Он основан на технологии FinFET (ребристый полевой транзистор), типе технологии многозатворных MOSFET . По состоянию на 2021 год стандарт литографии IRDS дает таблицу размеров «7 нм». [1] некоторые из них приведены ниже:
| Расчетное значение | нм |
|---|---|
| минимальный полушаг (DRAM, MPU, металл) | 18 |
| минимальный полушаг (Flash, плавник MPU, LGAA) | 15 |
| минимально необходимый OL (DRAM, Flash, MPU) | 3.6 |
| Шаг ворот | 54 |
| Длина ворот | 20 |
Стандарт IRDS Lithography 2021 года является документом, обращенным в прошлое, поскольку это первое массовое производство фирменного процесса «7 нм», поскольку Тайваньская компания по производству полупроводников ( TSMC ) начала производство микросхем памяти SRAM емкостью 256 Мбит с использованием процесса «7 нм », называемого N7 в июне 2016 г., [2] до того, как Samsung начала массовое производство своих устройств по техпроцессу «7 нм» (7LPP) в 2018 году. [3] Эти технологические узлы имели такую же приблизительную плотность транзисторов , что и узел Intel «10 нм Enhanced Superfin», позже переименованный в «Intel 7». [4]
По крайней мере, с 1997 года шкала длины технологического узла не относилась к каким-либо конкретным размерам интегральных схем, таким как длина затвора, шаг металла или шаг затвора, поскольку новые процессы литографии больше не сжимали равномерно все элементы на кристалле. К концу 2010-х годов шкала длины стала коммерческим названием. [5] это означало новое поколение технологических процессов, не имеющих никакого отношения к физическим свойствам. [6] [7] [8] Предыдущие стандарты ITRS и IRDS не содержали достаточных указаний по соглашениям об именах технологических узлов для учета самых разных размеров чипа, что приводило к расхождениям между тем, как литейные заводы маркировали свою литографию, и фактическими размерами, которых достигали их технологические узлы.
Первый массовый мобильный процессор «7 нм», предназначенный для использования на массовом рынке, Apple A12 Bionic , был представлен на мероприятии Apple в сентябре 2018 года. [9] Хотя 31 августа 2018 года Huawei до Apple A12 Bionic анонсировала свой собственный процессор «7 нм» Kirin 980 , Apple A12 Bionic был выпущен для публичного массового использования потребителями до Kirin 980. Оба чипа были произведены TSMC. . [10]
В 2019 году [11] AMD выпустила процессоры Rome (EPYC 2) для серверов и центров обработки данных, основанные на узле TSMC N7. [12] и имеет до 64 ядер и 128 потоков. Они также выпустили потребительские настольные процессоры Matisse с числом ядер до 16 и 32 потоков. Однако кристалл ввода-вывода в многочиповом модуле Rome (MCM) изготовлен по 14-нм техпроцессу GlobalFoundries (14HP), а кристалл ввода-вывода Matisse использует 12-нм техпроцесс GlobalFoundries (12LP+). Серия Radeon RX 5000 также основана на техпроцессе TSMC N7.
История
[ редактировать ]Демонстрации технологий
[ редактировать ]размером 7 нм МОП-транзисторы были впервые продемонстрированы исследователями в начале 2000-х годов. В 2002 году исследовательская группа IBM , в которую входили Брюс Дорис, Омер Докумачи, Мейкей Ионг и Анда Мокута, изготовила 6-нм MOSFET-транзистор кремний-на-изоляторе (SOI). [13] [14] В 2003 году NEC исследовательская группа под руководством Хитоши Вакабаяши и Сигэхару Ямагами изготовила 5-нм МОП-транзистор. [15] [16]
В июле 2015 года IBM объявила, что создала первые функциональные транзисторы по технологии «7 нм» с использованием кремний-германиевого процесса. [17] [18] [19] [20]
В июне 2016 года TSMC произвела ячейки памяти SRAM емкостью 256 Мбит по своему техпроцессу «7 нм». [2] с площадью ячейки 0,027 квадратных микрометров (550 F 2 ) [ написание? ] с разумной рискованной доходностью производства. [21]
Ожидаемая коммерциализация и технологии
[ редактировать ]В 2015 году Intel ожидала, что на 7-нанометровом узле в транзисторах придется использовать полупроводники III-V, что сигнализирует об отказе от кремния. [22]
В апреле 2016 года TSMC объявила, что пробное производство «7 нм» начнется в первой половине 2017 года. [23] В апреле 2017 года TSMC начала рискованное производство микросхем памяти SRAM емкостью 256 Мбит с использованием техпроцесса «7 нм» (N7FF+). [2] с литографией в крайнем ультрафиолете (EUV). [24] Производственные планы TSMC на базе «7 нм» по состоянию на начало 2017 г. [ нужно обновить ] Первоначально на этом технологическом узле (N7FF) должны были использовать иммерсионную литографию глубокого ультрафиолета (DUV), а переход от рискованного производства к коммерческому производству со второго квартала 2017 года по второй квартал 2018 года. Кроме того, было запланировано их производство более позднего поколения «7 нм» (N7FF+). [ нужно обновить ] использовать множественное моделирование EUV и оценить переход от риска к массовому производству в период с 2018 по 2019 год. [25]
В сентябре 2016 года GlobalFoundries объявила о пробном производстве во второй половине 2017 года и о рискованном производстве в начале 2018 года, при этом тестовые чипы уже запущены. [26]
В феврале 2017 года Intel анонсировала Fab 42 в Чандлере, штат Аризона , что, согласно пресс-релизам на тот момент, ожидалось. [ нужно обновить ] для производства микропроцессоров с использованием «7 нм» (Intel 4 [27] ) производственный процесс. [28] На тот момент компания не опубликовала никаких ожидаемых значений длин элементов на этом узле процесса. [ нужно обновить ]
В апреле 2018 года TSMC объявила о серийном производстве чипов «7 нм» (CLN7FF, N7). В июне 2018 года компания объявила о наращивании массового производства. [3]
В мае 2018 года Samsung объявила о производстве в этом году чипов «7 нм» (7LPP). ASML Holding NV является их основным поставщиком машин для литографии EUV. [29]
В августе 2018 года GlobalFoundries объявила о прекращении разработки чипов «7 нм», сославшись на стоимость. [30]
28 октября 2018 года компания Samsung объявила, что их процесс второго поколения «7 нм» (7LPP) вступил в рискованное производство и на тот момент ожидалось, что его массовое производство будет запущено к 2019 году. [ нужно обновить ]
17 января 2019 года в ходе отчета о финансовых результатах за четвертый квартал 2018 года TSMC упомянула, что разные клиенты будут иметь «разные варианты» второго поколения «7 нм». [31] [ нужно обновить ]
16 апреля 2019 года TSMC анонсировала свой «6-нм» процесс под названием (CLN6FF, N6), который, согласно пресс-релизу, выпущенному 16 апреля 2019 года, на тот момент ожидался, что он будет использоваться в массовых продуктах с 2021 года. [32] [ нужно обновить ] В то время ожидалось, что N6 будет использовать EUVL до 5 слоев по сравнению с 4 уровнями в их процессе N7+. [33]
28 июля 2019 года TSMC анонсировала свой «7-нм» процесс второго поколения под названием N7P, который, по прогнозам, будет основан на DUV, как и их процесс N7. [34] Поскольку N7P был полностью IP-совместим с исходным «7 нм», а N7+ (который использует EUV) — нет, N7+ (объявленный ранее как «7 нм+») должен был быть отдельным процессом от «7 нм». N6 («6 нм»), еще один процесс на основе EUV, в то время планировалось выпустить позже, чем даже процесс «5 нм» (N5) TSMC, с IP-совместимостью с N7. На своем отчете о прибылях и убытках за первый квартал 2019 года TSMC подтвердила свое заявление за четвертый квартал 2018 года. [31] На тот момент ожидалось, что N7+ принесет менее 1 миллиарда долларов дохода в 2019 году. [35] [ нужно обновить ]
5 октября 2019 года AMD объявила о своей дорожной карте EPYC , включающей чипы Milan, созданные с использованием процесса TSMC N7+. [36] [ нужно обновить ]
7 октября 2019 года TSMC объявила, что начала поставлять на рынок продукты N7+ в больших объемах. [37] [ нужно обновить ]
26 июля 2021 года Intel объявила о своей новой производственной программе, переименовав все свои будущие технологические узлы. [27] Улучшенный SuperFin (10ESF) Intel «10 нм», который был примерно эквивалентен процессу N7 от TSMC, отныне будет называться «Intel 7», в то время как их более ранний процесс «7 нм» раньше назывался «Intel 4». [27] [38] В результате первые процессоры Intel на базе Intel 7 на тот момент планировалось начать поставки ко второй половине 2022 года. [ нужно обновить ] тогда как ранее Intel объявила, что планирует выпустить процессоры «7 нм» в 2023 году. [39] [ нужно обновить ]
Коммерциализация технологий
[ редактировать ]В июне 2018 года AMD объявила о выпуске 7-нм графических процессоров Radeon Instinct во второй половине 2018 года. [40] В августе 2018 года компания подтвердила выпуск графических процессоров. [41]
21 августа 2018 года компания Huawei анонсировала свою SoC HiSilicon Kirin 980 , которая будет использоваться в их Huawei Mate 20 и Mate 20 Pro, построенных с использованием 7-нм техпроцесса (N7) TSMC. [ нужно обновить ]
12 сентября 2018 года Apple анонсировала свой A12 Bionic чип , используемый в iPhone XS и iPhone XR, построенный по 7-нм техпроцессу TSMC (N7). Процессор A12 стал первым 7-нм чипом для массового использования, поскольку он был выпущен до Huawei Mate 20. [42] [43] 30 октября 2018 года Apple анонсировала свой A12X Bionic чип , используемый в iPad Pro, созданный с использованием 7-нм техпроцесса TSMC (N7). [44]
4 декабря 2018 года Qualcomm анонсировала свои процессоры Snapdragon 855 и 8cx, построенные по 7-нм техпроцессу (N7) TSMC. [45] Первым массовым продуктом на базе Snapdragon 855 стал Lenovo Z5 Pro GT, анонсированный 18 декабря 2018 года. [46]
29 мая 2019 года MediaTek анонсировала свою SoC 5G, созданную с использованием 7-нм техпроцесса TSMC. [47]
7 июля 2019 года компания AMD официально представила Ryzen серию центральных процессоров 3000, основанных на 7-нм техпроцессе TSMC и микроархитектуре Zen 2 .
6 августа 2019 года Samsung анонсировала SoC Exynos 9825, первый чип, созданный с использованием процесса 7LPP. Exynos 9825 — первый чип для массового рынка, созданный с использованием EUVL . [48]
6 сентября 2019 года компания Huawei анонсировала свои SoC HiSilicon Kirin 990 4G и 990 5G , созданные с использованием процессов TSMC N7 и N7+. [49]
10 сентября 2019 года Apple анонсировала свой A13 Bionic чип , используемый в iPhone 11 и iPhone 11 Pro, созданный с использованием процесса TSMC N7P второго поколения. [50]
Производство 7 нм (узлы N7) обеспечило 36% выручки TSMC во втором квартале 2020 года. [51]
17 августа 2020 года IBM анонсировала процессор Power10 . [50]
26 июля 2021 года Intel объявила, что ее процессоры Alder Lake будут производиться с использованием недавно переименованного процесса Intel 7, ранее известного как «10 нм Enhanced SuperFin». [27] Судя по пресс-релизам, на тот момент ожидалось, что эти процессоры будут выпущены во второй половине 2021 года. [ нужно обновить ] Ранее компания подтвердила 7-нм техпроцесс, который теперь называется «Intel 4». [27] Семейство микропроцессоров под названием Meteor Lake будет выпущено в 2023 году. [52] [53] [ нужно обновить ]
Трудности с узором
[ редактировать ]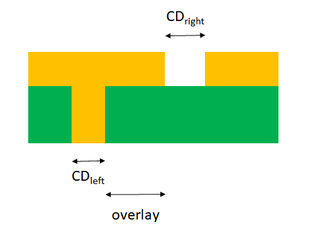




Ожидается, что литейный узел «7 нм» будет использовать любую из следующих технологий формирования рисунка или их комбинацию: разделение шага , самовыравнивающееся формирование рисунка и литографию EUV . Каждая из этих технологий сопряжена с серьезными проблемами в управлении критическими размерами (CD), а также размещением шаблонов, причем все они связаны с соседними элементами.
Разделение высоты тона
[ редактировать ]Разделение высоты тона включает в себя разделение элементов, которые расположены слишком близко друг к другу, на разные маски, которые последовательно экспонируются с последующей обработкой литотравлением. Из-за использования разных экспозиций всегда существует риск ошибки наложения между двумя экспозициями, а также возникновения разных компакт-дисков в результате разных экспозиций.
Распорка
[ редактировать ]Формирование промежуточного рисунка включает в себя нанесение слоя на предварительно структурированные элементы, а затем обратное травление для формирования прокладок на боковых стенках этих элементов, называемых центральными элементами. После удаления основных элементов прокладки используются в качестве маски травления для определения траншей в нижележащем слое. В то время как контроль промежуточного CD в целом превосходен, траншейный CD может попасть в одну из двух популяций из-за двух возможностей: находиться там, где находился основной элемент, или в оставшемся промежутке. Это известно как «ходьба по шагу». [54] Обычно шаг = основной CD + зазор CD + 2 * прокладка CD, но это не гарантирует, что основной CD = зазор CD. Для таких функций FEOL , как изоляция ворот или активной области (например, ребер), траншейный CD не так важен, как CD, определяемый проставками, и в этом случае создание рисунка с прокладками фактически является предпочтительным подходом к созданию рисунка.
При использовании самовыравнивающегося четверного рисунка (SAQP) используется вторая прокладка, заменяющая первую. В этом случае основной CD заменяется на основной CD - 2*2-й спейсерный CD, а разрывный CD заменяется на разрывный CD - 2*2-й спейсерный CD. Таким образом, размеры некоторых элементов строго определяются второй прокладкой CD, тогда как размеры остальных элементов определяются основной CD, шагом сердечника, а также первой и второй прокладочными CD. Центральный компакт-диск и шаг сердцевины определяются с помощью обычной литографии, тогда как разделительные компакт-диски не зависят от литографии. На самом деле ожидается, что это будет иметь меньше вариаций, чем разделение высоты звука, когда дополнительная экспозиция определяет свой собственный компакт-диск, как напрямую, так и через наложение.
Линии, определенные разделителями, также требуют обрезки. Пятна разреза могут смещаться при экспонировании, что приводит к искажению концов линий или проникновению в соседние линии.
Самовыравнивающееся литотравление-литотравление (SALELE) было реализовано для формирования рисунка BEOL «7 нм». [55]
EUV-литография
[ редактировать ]Литография в экстремальном ультрафиолете (также известная как EUV или EUVL ) способна разрешать детали размером менее 20 нм в обычном стиле литографии. Однако трехмерная отражающая природа маски EUV приводит к новым аномалиям изображения. Особой неприятностью является эффект двух полос, когда пара одинаковых элементов в форме полосок не фокусируется одинаково. Одна особенность по существу находится в «тени» другой. Следовательно, эти две функции обычно имеют разные компакт-диски, которые меняются в зависимости от фокуса, и эти функции также меняют положение в зависимости от фокуса. [56] [57] [58] Этот эффект может быть аналогичен тому, который может возникнуть при разделении высоты тона. Связанный с этим вопрос — это разница в наилучшем фокусе между функциями разных питчей. [59]
У EUV также есть проблемы с надежной печатью всех функций в большой популяции; некоторые контакты могут полностью отсутствовать или линии перемыкаться. Они известны как стохастические сбои печати. [60] [61] Уровень дефектности порядка 1 тыс./мм. 2 . [62]
Зазор между наконечниками трудно контролировать в EUV, в основном из-за ограничений освещенности. [63] Предпочтительна отдельная экспозиция(и) для линий разреза.
маски ослабленного фазового сдвига использовались При производстве узла 90 нм для обеспечения адекватных окон фокусировки для контактов с произвольным шагом с длиной волны ArF-лазера (193 нм). [64] [65] тогда как это улучшение разрешения недоступно для EUV. [66] [67]
На конференции EUV Lithography SPIE в 2021 году клиент TSMC сообщил, что выход EUV-контакта сопоставим с выходом при иммерсионном мультипаттерне. [68]
Сравнение с предыдущими узлами
[ редактировать ]Из-за этих проблем технология «7 нм» создает беспрецедентные трудности с созданием паттернов на задней стороне линии (BEOL). Предыдущий крупносерийный и долговечный литейный узел (Samsung «10 нм», TSMC «16 нм») использовал разделение тона для металлических слоев с более плотным пеком. [69] [70] [71]
Время цикла: погружение против EUV
[ редактировать ]| Процесс | Погружение (≥ 275 слов в час) [72] | EUV (1500 пластин/день) [73] |
|---|---|---|
| с одним рисунком: Слой 1 день завершения погружением |
6000 вафель/день | 1500 вафель/день |
| Слой с двойным рисунком: 2 дня завершения погружением |
6000 пластин/2 дня | 3000 вафель/2 дня |
| Слой с тройным рисунком: 3-дневное завершение погружением |
6000 пластин/3 дня | 4500 вафель/3 дня |
| Четырехслойный слой: 4 дня завершения погружением |
6000 пластин/4 дня | 6000 пластин/4 дня |
Поскольку в настоящее время инструменты погружения работают быстрее, на большинстве слоев по-прежнему используется мультипаттерн. На слоях, требующих иммерсионного четырехслойного рисунка, производительность завершения слоев с помощью EUV сопоставима. На других слоях погружение было бы более продуктивным при завершении слоя даже при наличии мультипаттернов.
Управление правилами проектирования в серийном производстве
[ редактировать ]Создание металлического рисунка «7 нм», который в настоящее время практикуется TSMC, включает в себя линии самовыравнивающегося двойного рисунка (SADP) с разрезами, вставленными внутри ячейки на отдельной маске по мере необходимости для уменьшения высоты ячейки. [74] Однако для формирования плавника используется самовыравнивающийся четырехугольный рисунок (SAQP), что является наиболее важным фактором производительности. [75] Проверки правил проектирования также позволяют избежать использования нескольких шаблонов и обеспечивают достаточные зазоры для разрезов, поэтому требуется только одна маска разреза. [75]
Узлы процессов и предложения процессов
[ редактировать ] этого раздела Фактическая точность оспаривается . ( сентябрь 2023 г. ) |
Именование технологических узлов четырьмя разными производителями (TSMC, Samsung, SMIC , Intel) частично обусловлено маркетингом и не связано напрямую с каким-либо измеримым расстоянием на кристалле — например, узел «7 нм» TSMC ранее был схожим по некоторым ключевым параметрам. к запланированной Intel первой итерации узла «10 нм», прежде чем Intel выпустила дальнейшие итерации, кульминацией которых стал «10-нм Enhanced SuperFin», который позже был переименован в «Intel 7» по маркетинговым причинам. [76] [77]
Поскольку реализация EUV на скорости «7 нм» все еще ограничена, многошаблонирование по-прежнему играет важную роль в стоимости и доходности; EUV добавляет дополнительные соображения. Разрешение большинства критических слоев по-прежнему определяется множественным структурированием. Например, для «7 нм» Samsung, даже со слоями с шагом 36 нм с одним рисунком EUV, слои с шагом 44 нм все равно будут иметь четырехкратный рисунок. [78]
| Samsung | ТСМК | Интел | СМИК | |||||||
|---|---|---|---|---|---|---|---|---|---|---|
| Имя процесса | 7ЛПП [79] [80] | 6ЛПП [81] | N7 [82] | Н7П [34] | N7+ [83] | N6 | Интел 7 [27] [ оспаривается – обсуждаем ] (10 нм) [84] | N+1 (>7 нм) | Н+2 (7 морских миль) | 7 нм EUV |
| Плотность транзисторов (МТР/мм 2 ) | 95.08–100.59 [85] [86] | 112.79 | 91.2–96.5 [87] [88] | 113.9 [87] | 114.2 [32] | 100.76–106.1 [89] [90] 60.41 [91] | 89 [92] | 113.6 [93] | Unknown | |
| Размер битовой ячейки SRAM | 0,0262 мкм 2 [94] | Unknown | 0,027 мкм 2 [94] | Unknown | Unknown | 0,0312 мкм 2 | Unknown | Unknown | Unknown | |
| Шаг затвора транзистора | 54 нм | Unknown | 57 нм | 54 нм | 66 нм | 63 нм | Unknown | |||
| Шаг ребер транзистора | 27 нм | Unknown | Н/Д | Unknown | Unknown | 34 нм | Unknown | Unknown | Unknown | |
| Высота ребра транзистора | Unknown | Unknown | Н/Д | Unknown | Unknown | 53 нм | Unknown | Unknown | Unknown | |
| Минимальный (металлический) шаг | 46 нм | Unknown | 40 нм | 40 нм [95] | 44 нм | 42 нм | Unknown | |||
| Внедрение EUV | шаг металла 36 нм; [78] 20% от общего набора слоев |
Unknown | Нет, вместо этого использовался самовыравнивающийся четырехугольный узор ( SAQP ). | 4 слоя | 5 слоев | Никто. полагался на SAQP Сильно | Никто | Никто | Да (после N+2) | |
| Выход пластин с ограничением EUV | 1500 вафель/день [73] | Unknown | Н/Д | ~ 1000 вафель/день [96] | Unknown | Н/Д | Unknown | Unknown | Unknown | |
| Мультипаттерн (≥ 2 масок на слое) |
до Ворота Виас (двойной узор) [97] Металл 1 (тройной узор) [97] Металлический шаг 44 нм (четырехслойный) [78] |
Unknown | до Ворота Контакты/переходные отверстия (четверенные) [98] Нижние 10 металлических слоев |
То же, что N7, с сокращением на 4 слоя EUV. | То же, что N7, с сокращением на 5 слоев EUV. | мультипаттерн с DUV | мультипаттерн с DUV | Unknown | ||
| Статус выпуска | 2018 рисковое производство производство 2019 года |
производство 2020 года | 2017 рисковое производство производство 2018 года [2] |
производство 2019 года | 2018 рисковое производство [2] производство 2019 года |
2020 рисковое производство производство 2020 года |
производство 2021 г. [27] | Производство с риском, апрель 2021 г., массовое производство неизвестно. | Рискованное производство в конце 2021 года, спокойно производится с июля 2021 года. [99] | Отменено из-за эмбарго США |
Процесс 7LP (ведущая производительность) компании GlobalFoundries «7 нм» предлагал бы на 40 % более высокую производительность или на 60 %+ меньшую мощность при двукратном увеличении плотности и на 30–45 % более низкой стоимости кристалла по сравнению с процессом «14 нм» . Шаг контактного полиэфира (CPP) должен был составлять 56 нм, а минимальный шаг металла (MMP) - 40 нм, что было получено с использованием самовыравнивающегося двойного рисунка (SADP). Размер ячейки SRAM 6T имел бы размер 0,269 квадратных микрона. GlobalFoundries планировала в конечном итоге использовать EUV-литографию в улучшенном процессе под названием 7LP+. [100] Позже GlobalFoundries прекратила разработку всех процессов «7 нм» и выше. [101]
Новый процесс Intel «Intel 7», ранее известный как «10 нм Enhanced SuperFin» (10ESF), основан на предыдущем 10-нм узле. Узел будет иметь прирост производительности на 10-15% на ватт . Между тем, их старый техпроцесс «7 нм», который теперь называется «Intel 4», на тот момент ожидался, будет выпущен в 2023 году. [102] [ нужно обновить ] В то время было обнародовано мало подробностей об узле «Intel 4», хотя плотность его транзисторов на тот момент оценивалась как минимум в 202 миллиона транзисторов на квадратный миллиметр. [27] [103] [ нужно обновить ] По состоянию на 2020 год у Intel возникли проблемы с процессом «Intel 4», вплоть до передачи производства графических процессоров Ponte Vecchio на аутсорсинг. [104] [105] [ нужно обновить ]
Ссылки
[ редактировать ]- ^ «Обновление международной дорожной карты для устройств и систем на 2021 год: литография» (PDF) . Международная дорожная карта для устройств и систем . 7 апреля 2024 г.
- ^ Jump up to: а б с д и «Технология 7 нм» . ТСМС . Проверено 30 июня 2019 г.
- ^ Jump up to: а б Чен, Моника; Шен, Джесси (22 июня 2018 г.). «TSMC наращивает производство 7-нм чипов» . ДиджиТаймс . Проверено 17 сентября 2022 г.
- ^ Субраманиам, Вайдьянатан (27 июля 2021 г.). «Intel подробно описывает новые технологические инновации и названия узлов: Alder Lake 10 нм Enhanced SuperFin теперь называется Intel 7; Intel 20A — это 2-нм техпроцесс для 2024 года» . Проверка ноутбука .
- ^ Моррис, Кевин (23 июля 2020 г.). «Больше никаких нанометров: пришло время именования новых узлов» . Электронный инженерный журнал . Проверено 17 сентября 2022 г.
- ^ Шукла, Приянк. «Краткая история эволюции узла процесса» . Дизайн-Повторное использование . Проверено 9 июля 2019 г.
- ^ Грушка, Джоэл (23 июня 2014 г.). «14 нм, 7 нм, 5 нм: насколько низко может опускаться КМОП? Это зависит от того, спросите ли вы инженеров или экономистов…» . ЭкстримТех . Проверено 17 сентября 2022 г.
- ^ Пирзада, Усман (16 сентября 2016 г.). «Эксклюзив: действительно ли Intel начинает терять свое технологическое лидерство? Выпуск 7-нм узла запланирован на 2022 год» . Wccftech . Проверено 17 сентября 2022 г.
- ^ Шенкленд, Стивен (12 сентября 2018 г.). «Процессор Apple A12 Bionic для нового iPhone XS опережает отрасль, перейдя на 7-нм технологию производства чипов» . CNET . Проверено 16 сентября 2018 г.
- ^ Саммерс, Н. (12 сентября 2018 г.). «Apple A12 Bionic — это первый 7-нанометровый чип для смартфонов» . Engadget . Проверено 20 сентября 2018 г.
- ^ «AMD запускает Epyc Rome, первый 7-нм процессор» . 8 августа 2019 г.
- ^ Смит, Райан (26 июля 2018 г.). «Процессоры AMD «Rome» EPYC будут производиться TSMC» . АнандТех . Проверено 18 июня 2019 г.
- ^ «IBM претендует на самый маленький кремниевый транзистор в мире — TheINQUIRER» . Theinquirer.net . 9 декабря 2002 года. Архивировано из оригинала 31 мая 2011 года . Проверено 7 декабря 2017 г.
- ^ Дорис, Брюс Б.; Докумачи, Омер Х.; Ёнг, Мейкей К.; Мокута, Анда; Чжан, Ин; Канарский, Томас С.; Рой, РА (декабрь 2002 г.). «Экстремальное масштабирование с помощью ультратонких Si-канальных МОП-транзисторов». Дайджест. Международная встреча по электронным устройствам . стр. 267–270. дои : 10.1109/IEDM.2002.1175829 . ISBN 0-7803-7462-2 . S2CID 10151651 .
- ^ «NEC тестирует самый маленький транзистор в мире» . Бесплатная библиотека . Проверено 7 декабря 2017 г.
- ^ Мицуру; Очиаи, К.; Ямамото, Т.; г., Вакабаяши, Хитоши; Икезава, Нобуюки; Нарихиро , Международная встреча по электронным устройствам, 2003 стр. 20.7.1–20.7.3. doi : 10.1109/ . IEDM.2003.1269446 0-7803-7872-5 . S2CID 2100267 .
- ^ Диньян, Ларри. «IBM Research создает функциональный 7-нм процессор» . ЗДНет .
- ^ Маркофф, Джон (9 июля 2015 г.). «IBM раскрывает рабочую версию чипа гораздо большей емкости» . Нью-Йорк Таймс .
- ^ «За пределами кремния: IBM представляет первый в мире 7-нм чип — Ars Technica» . arstechnica.com . 9 июля 2015 г.
- ^ «Семь достижений в области чипов, изготовленных по техпроцессу более 7 нм» . Блог исследований IBM . 27 февраля 2017 г.
- ^ Чанг, Дж.; Чен, Ю.; Чан, В.; Сингх, СП; Ченг, Х.; Фудзивара, Х.; Лин, Дж.; Связь.; Хунг, Дж.; Ли, Р.; Ляо, Х. (февраль 2017 г.). «12.1 7-нм SRAM 256 МБ в технологии FinFET с металлическим затвором high-k и схемой помощи при записи для с низким напряжением MIN приложений » . Международная конференция IEEE по твердотельным схемам (ISSCC) , 2017 г. стр. 206–207. дои : 10.1109/ISSCC.2017.7870333 . ISBN 978-1-5090-3758-2 . S2CID 19930825 .
- ^ «Intel продвигается вперед к 10-нм технологии и отойдет от кремния на 7-нм технологии» . 23 февраля 2015 г.
- ^ Пэриш, Кевин (20 апреля 2016 г.). «Остерегайтесь Intel и Samsung: TSMC готовится к переходу на 7-нм техпроцесс и пробному производству» . Цифровые тенденции . Проверено 17 сентября 2022 г.
- ^ «Советы TSMC по узлам 7+, 12, 22 нм | EE Times» . ЭТаймс . Проверено 17 марта 2017 г.
- ^ Шилов, Антон (5 мая 2017 г.). «Дорожные карты Samsung и TSMC: добавлены 8 и 6 нм с учетом 22ULP и 12FFC» . АнандТех . Проверено 17 сентября 2022 г.
- ^ «GLOBALFOUNDRIES представит лучшее в отрасли предложение по технологии FinFET 7 нм» . GlobalFoundries (Пресс-релиз). 15 сентября 2016 г. Проверено 8 апреля 2017 г.
- ^ Jump up to: а б с д и ж г час Катресс, Ян. «Дорожная карта Intel до 2025 года: с 4 нм, 3 нм, 20 А и 18 А?!» . www.anandtech.com . Проверено 27 июля 2021 г.
- ^ «Intel поддерживает американские инновации, инвестируя 7 миллиардов долларов в завод полупроводников нового поколения в Аризоне» . Отдел новостей Intel . 8 февраля 2017 г. Проверено 17 сентября 2022 г.
- ^ Кинг, Ян (22 мая 2018 г.). «Samsung заявляет, что в этом году начнется производство новых 7-нанометровых чипов» . Блумберг . Проверено 17 сентября 2022 г.
- ^ Дент, Стив (28 августа 2018 г.). «Крупный поставщик чипов AMD больше не будет производить чипы следующего поколения» . Engadget . Проверено 17 сентября 2022 г.
- ^ Jump up to: а б Стенограмма телеконференции TSMC о прибылях и убытках за четвертый квартал 2018 года, 17 января 2019 г.
- ^ Jump up to: а б Шор, Дэвид (16 апреля 2019 г.). «TSMC объявляет о выпуске 6-нанометрового процесса» . WikiChip Предохранитель . Проверено 31 мая 2019 г.
- ^ Шилов, Антон (1 мая 2019 г.). «TSMC: большинство 7-нм клиентов перейдут на 6-нм» . АнандТех . Проверено 31 мая 2019 г.
- ^ Jump up to: а б Шор, Дэвид (28 июля 2019 г.). «TSMC рассказывает о 7-нм, 5-нм техпроцессе, производительности, следующем поколении 5G и корпусах для высокопроизводительных вычислений» . WikiChip Предохранитель . Проверено 13 сентября 2019 г.
- ^ CC Wei, стенограмма телеконференции TSMC о прибылях и убытках за первый квартал 2019 года (18 апреля).
- ^ Алкорн, Пол (5 октября 2019 г.). «Блюда AMD в архитектуре Zen 3 и Zen 4, дорожная карта Милана и Генуи» . Аппаратное обеспечение Тома . Проверено 8 октября 2019 г.
- ^ «Технология N7+ от TSMC — это первый процесс EUV, позволяющий доставлять продукцию клиентов на рынок в больших объемах | Planet 3DNow!» (на немецком языке). 7 октября 2019 г. Проверено 8 октября 2019 г.
- ^ «Ускорение инноваций в процессах» (PDF) . Интел . 26 июля 2021 г.
- ^ Джонс, Райан (27 марта 2021 г.). «Ctrl+Alt+Delete: почему вас должен радовать 7-нм процессор Intel» . Доверенные отзывы . Проверено 30 марта 2021 г.
- ^ «Раздвигая границы для процессоров и графических процессоров, AMD демонстрирует лидерство в продуктах нового поколения Ryzen, Radeon и EPYC на выставке Computex 2018» (пресс-релиз). 5 июня 2018 г.
- ^ Мартин, Дилан (23 августа 2018 г.). «Технический директор AMD: «Мы пошли ва-банк» на 7-нм процессоры» . КРН . Проверено 17 сентября 2022 г.
- ^ «Apple анонсирует iPhone Xs и iPhone Xs Max с золотистым цветом, более быстрым Face ID и многим другим» . 12 сентября 2018 г.
- ^ Фридман, Эндрю Э. (12 сентября 2018 г.). «Apple представляет 7-нм процессор A12 Bionic для iPhone XS» . Аппаратное обеспечение Тома . Проверено 12 сентября 2018 г.
- ^ Аксон, Сэмюэл (7 ноября 2018 г.). «Apple внедряет Ars в процессорную систему A12X iPad Pro» . Арс Техника . Проверено 18 ноября 2018 г.
- ^ Катресс, Ян (4 декабря 2018 г.). «Технический саммит Qualcomm, день 1: Объявление о партнерстве в области 5G и Snapdragon 855» . АнандТех . Проверено 31 мая 2019 г.
- ^ Фрумусану, Андрей (18 декабря 2018 г.). «Lenovo первой выпустила телефон на Snapdragon 855 с анонсом Z5 Pro GT» . АнандТех . Проверено 31 мая 2019 г.
- ^ «МедиаТек 5G» . МедиаТек . Проверено 31 мая 2019 г.
- ^ Сиддики, Аамир (7 августа 2019 г.). «Samsung анонсирует Exynos 9825 перед запуском Galaxy Note 10» . XDA-Разработчики . Проверено 13 сентября 2019 г.
- ^ Катресс, Ян. «Huawei анонсирует Kirin 990 и Kirin 990 5G: подход с использованием двух SoC, встроенный модем 5G» . АнандТех . Проверено 13 сентября 2019 г.
- ^ Jump up to: а б «IBM представляет процессор IBM POWER10 нового поколения» . Отдел новостей IBM . 17 августа 2020 г. . Проверено 17 августа 2020 г.
- ^ «TSMC прокладывает агрессивный курс на 3-нм литографию и не только - ExtremeTech» .
- ^ «Генеральный директор Intel объявляет о стратегии IDM 2.0 в области производства и инноваций» . Отдел новостей Intel . 23 марта 2021 г. . Проверено 17 сентября 2022 г.
- ^ «Intel Unleashed: проектирование будущего (повтор)» . Отдел новостей Intel . 23 марта 2021 г. . Проверено 17 сентября 2022 г.
- ^ MJ Маслоу и др., Proc. SPIE 10587, 1058704 (2018).
- ^ ПРОДАЖА Двойной шаблон для узлов 7 и 5 нм
- ^ «Семинар IMEC EUVL 2018» (PDF) .
- ^ Ю. Накадзима и др., Симпозиум EUVL 2007, Саппоро.
- ^ Л. де Винтер и др., Proc. ШПИЕ 9661, 96610А (2015 г.).
- ^ М. Буркхардт и А. Рагунатан, Proc. ШПИЕ 9422, 94220X (2015 г.).
- ^ П. Де Бишоп и Э. Хендрикс, Proc. ШПИЕ 10583, 105831К (2018).
- ^ «Стохастическая долина смерти EUV» . linkedin.com .
- ^ С. Ларивьер и др., Proc. ШПИЕ 10583, 105830У (2018 г.).
- ^ Э. ван Сеттен и др., Proc. ШПИЕ 9661. 96610G (2015).
- ^ Ч. Чанг и др., Proc. SPIE 5377, 902 (2004).
- ^ Т. Девуавр и др., MTDT 2002.
- ^ S-S. Yu et al., Proc. SPIE 8679, 86791L (2013).
- ^ А. Эрдманн и др., Proc. SPIE 10583, 1058312 (2018).
- ^ Ци Ли и др., Proc. SPIE 11609, 116090V (2021).
- ^ Чон, туалет; Ан, Дж. Х.; Банг, Ю.С.; Юн, Ю.С.; Чой, JY; Ким, ЮК; Пэк, Юго-Запад; Ан, Юго-Запад; Ким, бакалавр наук; Сонг, Ти Джей; Юнг, Дж. Х.; Делай, Дж. Х.; Лим, С.М.; Чо, Х.-; Ли, Дж. Х.; Ким, Д.В.; Канг, С.Б.; Ку, Дж.-; Квон, SD; Юнг, С.-; Юн, Дж. С. (23 июня 2017 г.). «10-нм технология BEOL 2-го поколения с оптимизированным освещением и LELELELE». Симпозиум 2017 по технологии СБИС . стр. Т144–Т145. дои : 10.23919/VLSIT.2017.7998156 . ISBN 978-4-86348-605-8 . S2CID 43207918 – через IEEE Xplore.
- ^ «Симпозиум TSMC: «10-нм готовы к проектированию, начинающемуся в этот момент» - Аналитика отрасли - Блоги Cadence - Сообщество Cadence» . Community.cadence.com .
- ^ Ву, С.; Лин, CY; Чанг, MC; Лиав, Джей-Джей; Ченг, JY; Ян, С.Х.; Лян, М.; Мияшита, Т.; Цай, CH; Сюй, Британская Колумбия; Чен, HY; Ямамото, Т.; Чанг, Ю.Ю.; Чанг, В.С.; Чанг, Швейцария; Чен, Дж. Х.; Чен, ХФ; Тинг, КЦ; Ву, Ю.К.; Пан, К.Х.; Цуй, РФ; Яо, Швейцария; Чанг, PR; Лиен, HM; Ли, ТЛ; Ли, HM; Чанг, В.; Чанг, Т.; Чен, Р.; Ага, М.; Чен, CC; Чиу, Ю.Х.; Чен, Ю.Х.; Хуанг, ХК; Лу, ЮК; Чанг, CW; Цай, МХ; Лю, CC; Чен, Канзас; Куо, CC; Лин, ХТ; Джанг, С.М.; Ку, Ю. (23 декабря 2013 г.). «16-нм технология FinFET CMOS для мобильных SoC и вычислительных приложений». Международная конференция IEEE по электронным устройствам , 2013 г. стр. 9.1.1–9.1.4. дои : 10.1109/IEDM.2013.6724591 . ISBN 978-1-4799-2306-9 – через IEEE Xplore.
- ^ «Товары и услуги - Снабжение полупроводниковой промышленности» . asml.com .
- ^ Jump up to: а б «Samsung Ramps 7-нм чипы EUV» . ЭТаймс . 17 октября 2018 г.
- ^ «Процесс литографии 7 нм — WikiChip» .
- ^ Jump up to: а б «Эвристический подход к устранению нарушений правил проектирования (DRC) в конструкциях ASIC @ 7-нм технологии FinFET» . Проектирование и повторное использование .
- ^ Меррит, Рик (16 января 2017 г.). «15 взглядов с кремниевого саммита» . ЭТаймс . Проверено 16 сентября 2022 г.
- ^ Хилл, Брэндон (28 марта 2017 г.). «Intel подробно описывает усовершенствованный 10-нм узел FinFET компании Cannonlake, претендующий на полное превосходство над конкурентами» . Горячее оборудование . Архивировано из оригинала 12 июня 2018 года . Проверено 30 августа 2018 г.
- ^ Jump up to: а б с Дж. Ким и др., Proc. ШПИЕ 10962, 1096204 (2019).
- ^ «СБИС 2018: Samsung 7-нм 2-го поколения, EUV переходит на HVM» . ВикиЧип . 4 августа 2018 г. Проверено 16 сентября 2022 г.
- ^ «Samsung Electronics начинает производство 7-нм техпроцесса LPP на основе EUV» . Отдел новостей Samsung . 18 октября 2018 года . Проверено 16 сентября 2022 г.
- ^ «Samsung начинает массовое производство V1: специализированное предприятие EUV для узлов 7, 6, 5, 4 и 3 нм» .
- ^ ИЭДМ 2016
- ^ «TSMC переводит фотон в облако» . ЭТаймс . 4 октября 2018 г.
- ^ Боншор, Гэвин (20 октября 2022 г.). «Обзор Intel Core i9-13900K и i5-13600K: Raptor Lake приносит больше удовольствия» . АнандТех . Проверено 28 сентября 2023 г.
- ^ «Сможет ли TSMC сохранить лидерство в области технологических процессов» . 18 июля 2023 г.
- ^ «Samsung 3-нм GAAFET приступает к рисковому производству; обсуждает улучшения следующего поколения» . 5 июля 2022 г.
- ^ Jump up to: а б Джонс, Скоттен (3 мая 2019 г.). «Сравнение 5-нм TSMC и Samsung» . Семивики . Проверено 30 июля 2019 г.
- ^ «N3E заменяет N3; поставляется во многих вариантах» . 4 сентября 2022 г.
- ^ Джонс, Скоттен (18 июля 2023 г.), Сможет ли TSMC сохранить лидерство в области технологических процессов
- ^ «Дорожная карта Intel до 2025 года: с 4 нм, 3 нм, 20 А и 18 А?!» .
- ^ Шор, Дэвид (19 июня 2022 г.). «Взгляд на технологию процессов Intel 4» . WikiChip Предохранитель .
- ^ SMIC массово производит 14-нм узлы, переходит на 5-нм, 7-нм , 16 сентября 2022 г.
- ^ «Проверка безопасности Baidu» . wappass.baidu.com Проверено 6 сентября 2023 г. .
- ^ Jump up to: а б «СБИС 2018: Samsung 7-нм 2-го поколения, EUV переходит на HVM» . WikiChip Предохранитель . 4 августа 2018 г. Проверено 31 мая 2019 г.
- ^ Смит, Райан (13 июня 2022 г.). «Подробное описание узла процесса Intel 4: двукратное масштабирование плотности, повышение производительности на 20 %» . АнандТех . Проверено 17 сентября 2022 г.
- ^ «Стенограмма телеконференции о прибылях и убытках TSMC за 1 квартал 2018 года, стр. 12» (PDF) . Архивировано из оригинала (PDF) 14 октября 2018 года . Проверено 14 октября 2018 г.
- ^ Jump up to: а б WC Jeong и др., Технология СБИС, 2017 г.
- ^ Диллинджер, Том (23 марта 2017 г.). «10 главных новостей технологического симпозиума TSMC, часть II» . Поливики . Проверено 16 сентября 2022 г.
- ^ Пол Алкорн (21 июля 2022 г.). «Китайская компания SMIC поставляет 7-нм чипы, как сообщается, скопировала технологию TSMC» . Аппаратное обеспечение Тома .
- ^ Джонс, Скоттен (8 июля 2017 г.). «Эксклюзивно: GLOBALFOUNDRIES раскрывает подробности 7-нм техпроцесса» . Поливики . Проверено 16 сентября 2022 г.
- ^ Шилов, Антон; Катресс, Ян (27 августа 2018 г.). «GlobalFoundries прекращает разработку 7-нм технологий: предпочитает сосредоточиться на специализированных процессах» . АнандТех . Проверено 27 июля 2021 г.
- ^ «Intel: Извините, но выпуск наших 7-нм чипов будет отложен до 2022, 2023 года» . ПКМАГ . Проверено 27 июля 2021 г.
- ^ «Процесс литографии 7 нм — WikiChip» .
- ^ «7-нм техпроцесс Intel отстает от графика на шесть месяцев — Новости» .
- ^ «Поскольку график 7-нм процесса продолжает отставать, Intel рассматривает возможность создания сторонних производителей» . 24 июля 2020 г.
Внешние ссылки
[ редактировать ]| Предшественник 10 нм |
MOSFET изготовления полупроводниковых устройств Процесс | Преемник 5 нм |