Фоторезист
Фоторезист и (также известный как резист ) — это светочувствительный материал , используемый в нескольких процессах, таких как фотолитография фотогравировка , для формирования узорчатого покрытия на поверхности. Этот процесс имеет решающее значение в электронной промышленности . [1]
Процесс начинается с покрытия подложки светочувствительным органическим материалом. Затем на поверхность наносится узорчатая маска, блокирующая свет, так что свету будут подвергаться только незамаскированные области материала. Затем на поверхность наносится растворитель, называемый проявителем.В случае позитивного фоторезиста фоточувствительный материал разрушается под действием света, и проявитель растворяет участки, подвергшиеся воздействию света, оставляя после себя покрытие там, где была помещена маска.В случае негативного фоторезиста светочувствительный материал укрепляется (полимеризуется или сшивается) под действием света, и проявитель растворяет только те области, которые не подвергались воздействию света, оставляя после себя покрытие в тех местах, где была маска. не размещен.

Перед нанесением фоторезиста можно нанести покрытие BARC (нижнее антибликовое покрытие), чтобы избежать возникновения отражений под фоторезистом и улучшить характеристики фоторезиста на полупроводниковых узлах меньшего размера. [2] [3] [4]
Обычные фоторезисты обычно состоят из трех компонентов: смолы (связующего, обеспечивающего такие физические свойства, как адгезия, химическая стойкость и т. д.), сенсибилизатора (содержащего фотоактивное соединение) и растворителя (который сохраняет резист в жидком состоянии).
Определения [ править ]
Простая резиста полярность
Положительный: свет ослабит сопротивление и создаст дыру.
Минус: свет сделает резист более жестким и создаст маску, устойчивую к травлению.
Чтобы объяснить это в графической форме, у вас может быть график зависимости энергии воздействия журнала от доли оставшейся толщины резиста. Положительный резист будет полностью удален при конечной энергии воздействия, а отрицательный резист будет полностью затвердевшим и нерастворимым к концу энергии воздействия. Наклон этого графика представляет собой коэффициент контрастности. Интенсивность (I) связана с энергией соотношением E = I*t.
Позитивный фоторезист [ править ]


— Позитивный фоторезист это тип фоторезиста, часть которого подвергается воздействию света и становится растворимой в проявителе фоторезиста. Неэкспонированная часть фоторезиста остается нерастворимой в проявителе фоторезиста.
Некоторые примеры позитивных фоторезистов:
ПММА (полиметилметакрилат) однокомпонентный
- Устойчивость к глубокому УФ, электронному лучу, рентгеновскому излучению
- Сама смола чувствительна к DUV (медленно).
- Механизм разрыва цепи
Двухкомпонентные DQN резисты:
- Обычные резисты для ртутных ламп
- Сложный эфир диазохинона (DQ) 20-50% по весу
- светочувствительный
- гидрофобный, не растворимый в воде
- Фенольная новолачная смола (N)
- Часто используется для воздействия, близкого к УФ-излучению.
- Водорастворимый
- Воздействие ультрафиолета разрушает ингибирующий эффект DQ.
- Проблемы: Адгезия, устойчивость к травлению.
Негативный фоторезист [ править ]


— Негативный фоторезист это тип фоторезиста, в котором часть фоторезиста, подвергающаяся воздействию света, становится нерастворимой в проявителе фоторезиста. Неэкспонированная часть фоторезиста растворяется проявителем фоторезиста.
- На основе циклизованного полиизопрена (каучука).
- разнообразие сенсибилизаторов (всего несколько % по весу)
- Фотосшивка полимеров, инициируемая свободными радикалами
- Проблемы:
- потенциальное ингибирование кислорода
- отек во время развития
- длинные узкие линии могут стать волнистыми
- вздутие является проблемой для создания рисунков с высоким разрешением.
- Пример: СУ-8 (полимер на эпоксидной основе), хорошая адгезия), Фоторезист Кодак (КПР).
Функция передачи модуляции
MTF (передаточная функция модуляции — это соотношение модуляции интенсивности изображения и модуляции интенсивности объекта и является параметром, указывающим возможности оптической системы.
Различия между положительным резистом и отрицательным
Следующая таблица [6] основан на обобщениях, общепринятых в индустрии изготовления микроэлектромеханических систем (МЭМС).
| Характеристика | Позитивный | Отрицательный |
| Адгезия к кремнию | Справедливый | Отличный |
| Относительная стоимость | Дороже | Менее дорогой |
| База разработчиков | Водный | Органический |
| Растворимость в проявителе | Открытая область растворима | Открытая область нерастворима |
| Минимальная функция | 0,5 мкм | 7 нм |
| Покрытие шагов | Лучше | Ниже |
| Влажная химическая стойкость | Справедливый | Отличный |
Классификация [ править ]


По химической структуре фоторезисты можно разделить на три типа: фотополимерные, фоторазлагающиеся и фотосшивающие фоторезисты.
- Фотополимерный фоторезист — это тип фоторезиста, обычно аллиловый мономер, который может генерировать свободные радикалы под воздействием света, а затем инициировать фотополимеризацию мономера с образованием полимера. метилметакрилата и полифталевого альдегида /ПАГ. Фотополимерные фоторезисты обычно используются для негативного фоторезиста, например, смеси
- Фоторезист с фотосшивкой — это тип фоторезиста, который может сшивать цепочку за цепочкой под воздействием света, образуя нерастворимую сетку. Фоторезист с фотосшивкой обычно используется для негативного фоторезиста.

* Фоторазлагаемый фоторезист — это тип фоторезиста, который под действием света образует гидрофильные продукты. Фоторазлагающиеся фоторезисты обычно используются для позитивного фоторезиста. Типичным примером является азидхинон, например диазонафтахинон (DQ).
- Для самоорганизующегося однослойного фоторезиста SAM сначала SAM формируется на подложке путем самосборки . Затем эта поверхность, покрытая SAM, облучается через маску, аналогичную другому фоторезисту, которая создает образец с фотоузором в облученных областях. И, наконец, для удаления проектируемой части используется проявитель (может использоваться как в качестве позитивного, так и в качестве негативного фоторезиста). [7]
Источники света [ править ]
Поглощение в УФ и более волн коротких длинах
В литографии уменьшение длины волны источника света является наиболее эффективным способом достижения более высокого разрешения. [8] Фоторезисты чаще всего используются при длинах волн ультрафиолетового спектра или короче (<400 нм). Например, диазонафтохинон (ДНХ) сильно поглощает в диапазоне примерно от 300 до 450 нм. Полосы поглощения можно отнести к переходам n-π* (S0–S1) и π-π* (S1–S2) в молекуле ДНХ. [ нужна ссылка ] В спектре глубокого ультрафиолета (DUV) электронный переход π-π* в бензоле [9] или хромофоры с двойной связью углерода появляются при длине волны около 200 нм. [ нужна ссылка ] Из-за появления большего количества возможных переходов поглощения, связанных с большей разницей в энергии, поглощение имеет тенденцию увеличиваться с увеличением длины волны или большей энергии фотонов . Фотоны с энергией, превышающей потенциал ионизации фоторезиста (в конденсированных растворах могут достигать 5 эВ). [10] также может высвобождать электроны, которые способны дополнительно экспонировать фоторезист. В диапазоне от примерно 5 до примерно 20 эВ фотоионизация электронов внешней « валентной зоны » является основным механизмом поглощения. [11] Выше 20 эВ внутренняя электронная ионизация и оже-переходы становятся более важными. Поглощение фотонов начинает уменьшаться по мере приближения к рентгеновской области, поскольку для более высокой энергии фотонов допускается меньшее количество оже-переходов между глубокими атомными уровнями. Поглощенная энергия может вызвать дальнейшие реакции и в конечном итоге рассеивается в виде тепла. Это связано с газовыделением и загрязнением фоторезиста.
Электронно-лучевое воздействие [ править ]
Фоторезисты также можно экспонировать электронными лучами, получая те же результаты, что и экспонирование светом. Основное отличие состоит в том, что в то время как фотоны поглощаются, отдавая всю свою энергию сразу, электроны отдают свою энергию постепенно и во время этого процесса рассеиваются внутри фоторезиста. Как и в случае с длинами волн высоких энергий, многие переходы возбуждаются электронными лучами, поэтому нагрев и выделение газа по-прежнему вызывают беспокойство. Энергия диссоциации связи CC составляет 3,6 эВ. Вторичные электроны, генерируемые первичным ионизирующим излучением, имеют энергию, достаточную для диссоциации этой связи, вызывая разрыв. Кроме того, электроны с низкой энергией имеют более длительное время взаимодействия с фоторезистом из-за их более низкой скорости; по сути, электрон должен находиться в состоянии покоя относительно молекулы, чтобы наиболее сильно реагировать посредством диссоциативного присоединения электрона, когда электрон останавливается на молекуле, отдавая всю свою кинетическую энергию. [12] В результате разрыва исходный полимер разбивается на сегменты с более низкой молекулярной массой, которые легче растворяются в растворителе, или же высвобождаются другие химические соединения (кислоты), которые катализируют дальнейшие реакции разрыва (см. обсуждение химически амплифицированных резистов ниже). Для электронно-лучевого воздействия фоторезисты выбирают нечасто. Электронно-лучевая литография обычно использует резисты, специально предназначенные для воздействия электронным лучом.
Параметры [ править ]
Физические, химические и оптические свойства фоторезистов влияют на их выбор для различных процессов. [13] Основными свойствами фоторезиста являются разрешающая способность, технологическая доза и фокусная широта , необходимые для отверждения, а также устойчивость к реактивному ионному травлению. [14] : 966 [15] Другими ключевыми свойствами являются чувствительность, совместимость с гидроксидом тетраметиламмония (ТМАГ), адгезия, устойчивость к окружающей среде и срок годности. [14] : 966 [15]
- Разрешение
- Разрешение — это способность различать соседние элементы на подложке. Критический размер (CD) является основным показателем разрешения. Чем меньше компакт-диск, тем выше будет разрешение.
- Контраст
- Контраст — это разница между экспонированной частью и неэкспонированной частью. Чем выше контраст, тем более очевидной будет разница между экспонированными и неэкспонированными участками.
- Чувствительность
- Чувствительность — это минимальная энергия, необходимая для создания четко выраженного элемента фоторезиста на подложке, измеряемая в мДж/см. 2 . Чувствительность фоторезиста важна при использовании глубокого ультрафиолета (DUV) или крайнего ультрафиолета (EUV).
- Вязкость
- Вязкость — это мера внутреннего трения жидкости, влияющая на то, насколько легко она будет течь. Когда необходимо получить более толстый слой, предпочтительным будет фоторезист с более высокой вязкостью.
- Приверженность
- Адгезия – это прочность сцепления между фоторезистом и подложкой. Если резист оторвется от подложки, некоторые элементы будут отсутствовать или повреждены.
- Устойчивость к травлению
- Антитравление — это способность фоторезиста противостоять воздействию высокой температуры, среды с различным pH или ионной бомбардировке в процессе постмодификации.
- Поверхностное натяжение
- Поверхностное натяжение — это натяжение, вызываемое жидкостью, стремящейся минимизировать площадь своей поверхности, что вызвано притяжением частиц в поверхностном слое. Для лучшего смачивания поверхности подложки фоторезисты должны обладать относительно низким поверхностным натяжением.
Химическая амплификация [ править ]
Фоторезисты, используемые в производстве для ДУФ и более коротких волн, требуют применения химического усиления для повышения чувствительности к энергии воздействия. Это делается для того, чтобы бороться с большим поглощением на более коротких длинах волн. Химическую амплификацию также часто используют при электронно-лучевом воздействии для повышения чувствительности к экспозиционной дозе. При этом кислоты , выделяемые в результате воздействия радиации, диффундируют на этапе постэкспозиционного обжига. Эти кислоты делают окружающий полимер растворимым в проявителе. Одна молекула кислоты может катализировать множество таких « снятия защиты реакций »; следовательно, требуется меньше фотонов или электронов. [16] Диффузия кислоты важна не только для повышения чувствительности и производительности фоторезиста, но также для ограничения шероховатости края линии из-за статистики дробового шума. [17] Однако длина диффузии кислоты сама по себе является потенциальным ограничителем разрешения. [18] Кроме того, слишком большая диффузия снижает химический контраст, что снова приводит к большей шероховатости. [17]
Следующие реакции являются примером коммерческих химически амплифицированных фоторезистов, используемых сегодня:
- фотокислотный генератор + hν (193 нм) → кислотный катион + сульфонат- анион [19]
- сульфонат-анион + hν (193 нм) → e − + сульфонат [20]
- и − + генератор фотокислоты → е − + кислотный катион + сульфонат-анион [19]
е − представляет собой сольватированный электрон или освобожденный электрон, который может реагировать с другими компонентами раствора. Обычно он проходит расстояние порядка многих нанометров, прежде чем его удерживают; [21] [22] такое большое расстояние перемещения соответствует высвобождению электронов через толстый оксид в УФ-СППЗУ в ответ на ультрафиолетовый свет. Это паразитное воздействие ухудшит разрешение фоторезиста; для 193 нм оптическое разрешение в любом случае является ограничивающим фактором, но для электронно-лучевой литографии или EUVL разрешение определяет диапазон электронов, а не оптика.
Типы [ править ]
DNQ новолачный фоторезист -
Один очень распространенный позитивный фоторезист, используемый с I, G и H-линиями ртутной лампы, основан на смеси диазонафтохинона (ДНХ) и новолачной смолы (фенолформальдегидной смолы). ДНХ ингибирует растворение новолачной смолы, но под воздействием света скорость растворения увеличивается даже по сравнению со скоростью растворения чистого новолака. Механизм, с помощью которого неэкспонированный ДНХ ингибирует растворение новолака, не совсем понятен, но считается, что он связан с водородными связями (или, точнее, с диазосочетанием в неэкспонированной области). ДНХ-новолачные резисты получают путем растворения в основном растворе (обычно 0,26 н. гидроксида тетраметиламмония (ТМАГ) в воде).
Резисты на эпоксидной основе [ править ]
Один очень распространенный негативный фоторезист основан на олигомере на основе эпоксидной смолы. Общее название продукта — фоторезист SU-8 . Первоначально он был изобретен IBM , но сейчас продается Microchem и Gersteltec . Уникальным свойством СУ-8 является то, что его очень сложно разобрать. Таким образом, он часто используется в приложениях, где для устройства необходим постоянный рисунок резиста (который невозможно удалить и который можно использовать даже в условиях суровых температур и давлений). [23] Механизм действия полимера на основе эпоксидной смолы показан в 1.2.3 СУ-8. SU-8 склонен к разбуханию при меньших размерах элементов, что привело к разработке низкомолекулярных альтернатив, способных достигать более высокого разрешения, чем SU-8. [24]
полимер тиол-енов ( Нестехиометрический OSTE )
В 2016 году было показано, что полимеры OSTE обладают уникальным механизмом фотолитографии, основанным на диффузионно-индуцированном истощении мономера, что обеспечивает высокую точность фотоструктурирования. Полимерный материал OSTE был первоначально изобретен в Королевском технологическом институте KTH , но сейчас продается компанией Mercene Labs . Хотя материал имеет свойства, аналогичные свойствам SU8, у OSTE есть особое преимущество, заключающееся в том, что он содержит реактивные поверхностные молекулы, что делает этот материал привлекательным для микрофлюидных или биомедицинских применений. [13]
Водородный силсесквиоксан (HSQ) [ править ]
HSQ — распространенный негативный резист для электронного луча , но он также полезен для фотолитографии. Первоначально изобретенный компанией Dow Corning (1970 г.), [25] и в настоящее время производится ( 2017 г. ) компанией Applied Quantum Materials Inc. ( AQM ). В отличие от других негативных резистов, HSQ неорганический и не содержит металлов. Таким образом, подвергнутый воздействию HSQ обеспечивает оксид с низкой диэлектрической проницаемостью (low-k), богатый кремнием. Сравнительное исследование с другими фоторезистами было опубликовано в 2015 году (Dow Corning HSQ). [26]
Приложения [ править ]


Микроконтактная печать [ править ]
Микроконтактная печать была описана Whitesides Group в 1993 году. Обычно в этой технике эластомерный штамп используется для создания двумерных рисунков путем печати молекул «чернил» на поверхности твердого субстрата. [27]
Шаг 1 для микроконтактной печати. Схема создания мастер-штампа из полидиметилсилоксана (ПДМС). Шаг 2 микроконтактной печати. Схема нанесения краски и контактный процесс микропечатной литографии.
Печатные платы [ править ]
Производство печатных плат — одно из важнейших применений фоторезиста. Фотолитография позволяет быстро, экономично и точно воспроизвести сложную схему электронной системы, как если бы она была выпущена из печатного станка. Общий процесс заключается в нанесении фоторезиста, подвергании изображения воздействию ультрафиолетовых лучей, а затем травлении для удаления медной подложки. [28]

Нанесение рисунка и травление подложек [ править ]
Сюда входят специальные фотонные материалы, микроэлектромеханические системы ( МЭМС ), стеклянные печатные платы и другие по созданию микропаттернов задачи . Фоторезист не подвергается травлению растворами с pH выше 3. [29]

Микроэлектроника [ править ]
Это приложение, в основном применяемое к кремниевым пластинам и кремниевым интегральным схемам, является наиболее развитой из технологий и наиболее специализированным в этой области. [30]
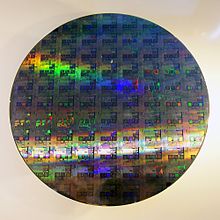
См. также [ править ]
Ссылки [ править ]
- ^ Эрик, Анслин; Догерти, Деннис. Современная физическая органическая химия . Университетские научные книги.
- ^ «Верхние антибликовые покрытия против нижних антибликовых покрытий» .
- ^ Микрохимия. «Основы микроструктурирования: антибликовые покрытия» (PDF) . Микрохимикс ГмбХ . Проверено 31 января 2020 г.
- ^ «Антибликовое покрытие днища AR™ 10L (BARC) | DuPont» . dupont.com .
- ^ Ито, Х.; Уилсон, CG; Фреше, JHJ (1 сентября 1982 г.). «Новые УФ-стойки с отрицательным или положительным тоном» . Симпозиум 1982 года по технологии СБИС. Сборник технических статей : 86–87.
- ^ Маду, Марк (13 марта 2002 г.). Основы микропроизводства . ЦРК Пресс. ISBN 978-0-8493-0826-0 .
- ^ Хуан, Цзинъюй; Дальгрен, Дэвид А.; Хеммингер, Джон К. (1 марта 1994 г.). «Фотопаттерн самоорганизующихся монослоев алкантиолата на золоте: простой однослойный фоторезист с использованием водной химии». Ленгмюр . 10 (3): 626–628. дои : 10.1021/la00015a005 . ISSN 0743-7463 .
- ^ Браттон, Дэниел; Ян, Да; Дай, Джуньян; Обер, Кристофер К. (1 февраля 2006 г.). «Последние достижения в литографии высокого разрешения». Полимеры для передовых технологий . 17 (2): 94–103. дои : 10.1002/пат.662 . ISSN 1099-1581 . S2CID 55877239 .
- ^ Исии, Хироюки; Усуи, Синдзи; Дуки, Кацудзи; Кадзита, Тору; Чаванья, Хитоши; Симокава, Цутому (1 января 2000 г.). Хулихан, Фрэнсис М. (ред.). «Дизайн и литографические исполнения генераторов фотокислоты 193-специфического». Достижения в области технологии и обработки резистов XVII . 3999 : 1120–1127. Бибкод : 2000SPIE.3999.1120I . дои : 10.1117/12.388276 . S2CID 98281255 .
- ^ Бельбруно, Джозеф (1990). «Многофотонная химия фенола в гексане при длине волны 266 нм» . Письма по химической физике . 166 (2): 167–172. Бибкод : 1990CPL...166..167B . дои : 10.1016/0009-2614(90)87271-р .
- ^ Вайнгартнер, Джозеф С; Дрен, Б.Т.; Барр, Дэвид К. (2006). «Фотоэлектрическая эмиссия пылевых зерен, подвергшихся воздействию крайнего ультрафиолетового и рентгеновского излучения». Астрофизический журнал . 645 (2): 1188–1197. arXiv : astro-ph/0601296 . Бибкод : 2006ApJ...645.1188W . дои : 10.1086/504420 . S2CID 13859981 .
- ^ Браун, М; Грубер, Ф; Руф, М.-Ж; Кумар, С.В.К; Илленбергер, Э; Хотоп, Х (2006). «Усиленное ИК-фотоном диссоциативное присоединение электронов к SF6: зависимость от энергии фотонов, колебаний и электронов». Химическая физика . 329 (1–3): 148. Бибкод : 2006CP....329..148B . doi : 10.1016/j.chemphys.2006.07.005 .
- ↑ Перейти обратно: Перейти обратно: а б Гринер, Джесси; Ли, Вэй; Рен, Джуди; Войку, Дэн; Пахаренко Виктория; Тан, Тянь; Кумачева, Евгения (2 февраля 2010 г.). «Быстрое и экономичное изготовление микрофлюидных реакторов из термопластичных полимеров путем сочетания фотолитографии и горячего тиснения» . Лабораторный чип . 10 (4): 522–524. дои : 10.1039/b918834g . ISSN 1473-0189 . ПМИД 20126695 . S2CID 24567881 .
- ↑ Перейти обратно: Перейти обратно: а б Справочник по физическим свойствам полимеров . Джеймс Э. Марк (2-е изд.). Нью-Йорк: Спрингер. 2006. ISBN 978-0-387-31235-4 . OCLC 619279219 .
{{cite book}}: CS1 maint: другие ( ссылка ) - ↑ Перейти обратно: Перейти обратно: а б Линь, Цинхуан (2007), Марк, Джеймс Э. (ред.), «Свойства фоторезистивных полимеров» , Справочник по физическим свойствам полимеров , Нью-Йорк, Нью-Йорк: Springer New York, стр. 965–979, doi : 10.1007/978. -0-387-69002-5_57 , ISBN 978-0-387-31235-4 , получено 6 января 2023 г.
- ^ Патент США 4,491,628 «Положительные и отрицательные рабочие резистные композиции с кислотообразующим фотоинициатором и полимером с подвеской кислотолабильных групп на основной цепи полимера» Дж. М. Дж. Фреше, Х. Ито и К. Г. Уилсон, 1985. [1]
- ↑ Перейти обратно: Перейти обратно: а б Ван Стенвинкель, Дэвид; Ламмерс, Йерун Х.; Келер, Томас; Брейнард, Роберт Л.; Трефонас, Питер (2006). «Сопротивление эффектам на малых шагах» . Журнал вакуумной науки и техники Б. 24 (1): 316–320. Бибкод : 2006JVSTB..24..316V . дои : 10.1116/1.2151912 .
- ^ Чочос, ЧЛ; Исмаилова, Э. (2009). «Сверхразветвленные полимеры для фотолитографических применений - на пути к пониманию взаимосвязи между химической структурой полимерной смолы и литографическими характеристиками». Продвинутые материалы . 21 (10–11): 1121. Бибкод : 2009AdM....21.1121C . дои : 10.1002/adma.200801715 . S2CID 95710610 .
- ↑ Перейти обратно: Перейти обратно: а б С. Тагава; и др. (2000). Хулихан, Фрэнсис М. (ред.). «Радиация и фотохимия генераторов ониевых солевых кислот в химически усиленных резистах». Учеб. ШПИОН . Достижения в области технологии и обработки резистов XVII. 3999 : 204. Бибкод : 2000SPIE.3999..204T . дои : 10.1117/12.388304 . S2CID 95525894 .
- ^ Ван, Сюэ-Бин; Феррис, Ким; Ван, Лай-Шэн (2000). «Фотоотщепление газообразных многозарядных анионов, тетраанион фталоцианина тетрасульфоната меди: настройка уровней молекулярной электронной энергии путем зарядки и отрицательного связывания электронов». Журнал физической химии А. 104 (1): 25–33. Бибкод : 2000JPCA..104...25Вт . дои : 10.1021/jp9930090 .
- ^ Лу, Хун; Лонг, Фредерик Х.; Эйзенталь, КБ (1990). «Фемтосекундные исследования электронов в жидкостях». Журнал Оптического общества Америки Б. 7 (8): 1511. Бибкод : 1990JOSAB...7.1511L . дои : 10.1364/JOSAB.7.001511 .
- ^ Лукин Л; Балакин, Александр Александрович (2001). «Термализация электронов низкой энергии в жидком метилциклогексане, изученная методом фотоассистированного разделения ионных пар». Химическая физика . 265 (1): 87–104. Бибкод : 2001CP....265...87L . дои : 10.1016/S0301-0104(01)00260-9 .
- ^ ДеФорест, Уильям С. (1975). Фоторезист: материалы и процессы . Компании МакГроу-Хилл.
- ^ Лоусон, Ричард; Толберт, Ларен; Юнкин, Тодд; Хендерсон, Клифф (2009). Хендерсон, Клиффорд Л. (ред.). «Молекулярные резисты негативного тона на основе катионной полимеризации» . Учеб. SPIE 7273, Достижения в области резистивных материалов и технологий обработки . Достижения в области резистивных материалов и технологий обработки XXVI. XXVI : 72733E. Бибкод : 2009SPIE.7273E..3EL . дои : 10.1117/12.814455 . S2CID 122244702 .
- ^ Фрай, Сесил Л.; Коллинз, Уорд Т. (1 сентября 1970 г.). «Олигомерные силсесквиоксаны, (HSiO3/2)n» . Журнал Американского химического общества . 92 (19): 5586–5588. дои : 10.1021/ja00722a009 . ISSN 0002-7863 .
- ^ Моджарад, Насир; Гобрехт, Йенс; Экинчи, Ясин (18 марта 2015 г.). «За пределами EUV-литографии: сравнительное исследование эффективности эффективных фоторезистов» . Научные отчеты . 5 (1): 9235. Бибкод : 2015NatSR...5E9235M . дои : 10.1038/srep09235 . ISSN 2045-2322 . ПМЦ 4363827 . ПМИД 25783209 .
- ^ «Самособранные однослойные пленки: микроконтактная печать» (PDF) .
- ^ Монтроуз, Марк I (1999). Справочник по электронной упаковке . ЦРК Пресс.
- ^ Новак, Р.Э. (2000). Технология очистки в производстве полупроводниковых приборов . Электрохимического общества Inc. ISBN 978-1566772594 .
- ^ Кремниевая фотоника . Springer Science & Business Media. 2004.