Фоторезист
Фоторезист и (также известный как резист ) — это светочувствительный материал , используемый в нескольких процессах, таких как фотолитография фотогравировка , для формирования узорчатого покрытия на поверхности. Этот процесс имеет решающее значение в электронной промышленности . [ 1 ]
Процесс начинается с покрытия подложки светочувствительным органическим материалом. Затем на поверхность наносится узорчатая маска, блокирующая свет, так что свету будут подвергаться только незамаскированные области материала. Затем на поверхность наносится растворитель, называемый проявителем. В случае позитивного фоторезиста фоточувствительный материал разрушается под действием света, и проявитель растворяет участки, подвергшиеся воздействию света, оставляя после себя покрытие там, где была помещена маска. В случае негативного фоторезиста светочувствительный материал укрепляется (полимеризуется или сшивается) под действием света, и проявитель растворяет только те области, которые не подвергались воздействию света, оставляя после себя покрытие в тех местах, где была маска. не размещен.

Перед нанесением фоторезиста можно нанести покрытие BARC (нижнее антибликовое покрытие), чтобы избежать возникновения отражений под фоторезистом и улучшить характеристики фоторезиста на полупроводниковых узлах меньшего размера. [ 2 ] [ 3 ] [ 4 ]
Обычные фоторезисты обычно состоят из трех компонентов: смолы (связующего, обеспечивающего такие физические свойства, как адгезия, химическая стойкость и т. д.), сенсибилизатора (содержащего фотоактивное соединение) и растворителя (который сохраняет резист в жидком состоянии).
Определения
[ редактировать ]Простая полярность резиста
[ редактировать ]Положительный: свет ослабит сопротивление и создаст дыру.
Минус: свет сделает резист более жестким и создаст маску, устойчивую к травлению.
Чтобы объяснить это в графической форме, у вас может быть график зависимости энергии воздействия журнала от доли оставшейся толщины резиста. Положительный резист будет полностью удален при конечной энергии воздействия, а отрицательный резист будет полностью затвердевшим и нерастворимым к концу энергии воздействия. Наклон этого графика представляет собой коэффициент контрастности. Интенсивность (I) связана с энергией соотношением E = I*t.
Позитивный фоторезист
[ редактировать ]

— Позитивный фоторезист это тип фоторезиста, часть которого подвергается воздействию света и становится растворимой в проявителе фоторезиста. Неэкспонированная часть фоторезиста остается нерастворимой в проявителе фоторезиста.
Некоторые примеры позитивных фоторезистов:
ПММА (полиметилметакрилат) однокомпонентный
- Устойчивость к глубокому УФ, электронному лучу, рентгеновскому излучению
- Сама смола чувствительна к DUV (медленно).
- Механизм разрыва цепи
Двухкомпонентные DQN резисты:
- Обычные резисты для ртутных ламп
- Сложный эфир диазохинона (DQ) 20-50% по весу
- светочувствительный
- гидрофобный, не растворимый в воде
- Фенольная новолачная смола (N)
- Часто используется для воздействия, близкого к УФ-излучению.
- Водорастворимый
- Воздействие ультрафиолета разрушает ингибирующий эффект DQ.
- Проблемы: Адгезия, устойчивость к травлению.
Негативный фоторезист
[ редактировать ]

— Негативный фоторезист это тип фоторезиста, в котором часть фоторезиста, подвергающаяся воздействию света, становится нерастворимой в проявителе фоторезиста. Неэкспонированная часть фоторезиста растворяется проявителем фоторезиста.
- На основе циклизованного полиизопрена (каучука).
- разнообразие сенсибилизаторов (всего несколько % по весу)
- Фотосшивка полимеров, инициируемая свободными радикалами
- Проблемы:
- потенциальное ингибирование кислорода
- отек во время развития
- длинные узкие линии могут стать волнистыми
- вздутие является проблемой для создания рисунков с высоким разрешением.
- Пример: СУ-8 (полимер на эпоксидной основе), хорошая адгезия), Фоторезист Кодак (КПР).
Функция передачи модуляции
MTF (передаточная функция модуляции — это соотношение модуляции интенсивности изображения и модуляции интенсивности объекта и является параметром, указывающим возможности оптической системы.
Различия между положительным и отрицательным резистом
[ редактировать ]Следующая таблица [ 6 ] основан на обобщениях, общепринятых в индустрии изготовления микроэлектромеханических систем (МЭМС).
| Характеристика | Позитивный | Отрицательный |
|---|---|---|
| Адгезия к кремнию | Справедливый | Отличный |
| Относительная стоимость | Дороже | Менее дорогой |
| База разработчиков | Водный | Органический |
| Растворимость в проявителе | Открытая область растворима | Открытая область нерастворима |
| Минимальная функция | 0,5 мкм | 7 нм |
| Покрытие шагов | Лучше | Ниже |
| Влажная химическая стойкость | Справедливый | Отличный |
Классификация
[ редактировать ]

По химической структуре фоторезисты можно разделить на три типа: фотополимерные, фоторазлагающиеся и фотосшивающие фоторезисты.
- Фотополимерный фоторезист — это тип фоторезиста, обычно аллиловый мономер, который может генерировать свободные радикалы под воздействием света, а затем инициировать фотополимеризацию мономера с образованием полимера. Фотополимерные фоторезисты обычно используются для негативного фоторезиста, например, смеси метилметакрилата и полифталальдегида /ПАГ .
- Фоторезист с фотосшивкой — это тип фоторезиста, который может сшивать цепочку за цепочкой под воздействием света, образуя нерастворимую сетку. Фотосшивающий фоторезист обычно используется для негативного фоторезиста.

* Фоторазлагаемый фоторезист — это тип фоторезиста, который под действием света образует гидрофильные продукты. Фоторазлагающиеся фоторезисты обычно используются для позитивного фоторезиста. Типичным примером является азидхинон, например диазонафтахинон (DQ).
- Для самоорганизующегося однослойного фоторезиста SAM сначала SAM формируется на подложке путем самосборки . Затем эта поверхность, покрытая SAM, облучается через маску, аналогичную другому фоторезисту, которая создает образец с фотоузором в облученных областях. И, наконец, для удаления спроектированной части используется проявитель (может использоваться как в качестве позитивного, так и в качестве негативного фоторезиста). [ 7 ]
Источники света
[ редактировать ]Поглощение в УФ и более коротких длинах волн
[ редактировать ]В литографии уменьшение длины волны источника света является наиболее эффективным способом достижения более высокого разрешения. [ 8 ] Фоторезисты чаще всего используются при длинах волн ультрафиолетового спектра или короче (<400 нм). Например, диазонафтохинон (ДНХ) сильно поглощает в диапазоне примерно от 300 до 450 нм. Полосы поглощения можно отнести к переходам n-π* (S0–S1) и π-π* (S1–S2) в молекуле ДНХ. [ нужна ссылка ] В спектре глубокого ультрафиолета (DUV) электронный переход π-π* в бензоле [ 9 ] или хромофоры с двойной связью углерода появляются при длине волны около 200 нм. [ нужна ссылка ] Из-за появления большего количества возможных переходов поглощения, связанных с большей разницей в энергии, поглощение имеет тенденцию увеличиваться с увеличением длины волны или большей энергии фотонов . Фотоны с энергией, превышающей потенциал ионизации фоторезиста (в конденсированных растворах могут достигать 5 эВ). [ 10 ] также может высвобождать электроны, которые способны дополнительно экспонировать фоторезист. В диапазоне от примерно 5 до примерно 20 эВ фотоионизация электронов внешней « валентной зоны » является основным механизмом поглощения. [ 11 ] Выше 20 эВ внутренняя электронная ионизация и оже-переходы становятся более важными. Поглощение фотонов начинает уменьшаться по мере приближения к рентгеновской области, поскольку для более высокой энергии фотонов допускается меньшее количество оже-переходов между глубокими атомными уровнями. Поглощенная энергия может вызвать дальнейшие реакции и в конечном итоге рассеивается в виде тепла. Это связано с газовыделением и загрязнением фоторезиста.
Электронно-лучевое воздействие
[ редактировать ]Фоторезисты также можно экспонировать электронными лучами, получая те же результаты, что и экспонирование светом. Основное отличие состоит в том, что в то время как фотоны поглощаются, отдавая всю свою энергию сразу, электроны отдают свою энергию постепенно и во время этого процесса рассеиваются внутри фоторезиста. Как и в случае с длинами волн высоких энергий, многие переходы возбуждаются электронными лучами, поэтому нагрев и выделение газа по-прежнему вызывают беспокойство. Энергия диссоциации связи CC составляет 3,6 эВ. Вторичные электроны, генерируемые первичным ионизирующим излучением, имеют энергию, достаточную для диссоциации этой связи, вызывая разрыв. Кроме того, электроны с низкой энергией имеют более длительное время взаимодействия с фоторезистом из-за их более низкой скорости; по сути, электрон должен находиться в состоянии покоя относительно молекулы, чтобы наиболее сильно реагировать посредством диссоциативного присоединения электрона, когда электрон останавливается на молекуле, отдавая всю свою кинетическую энергию. [ 12 ] В результате разрыва исходный полимер разбивается на сегменты с более низкой молекулярной массой, которые легче растворяются в растворителе, или же высвобождаются другие химические соединения (кислоты), которые катализируют дальнейшие реакции разрыва (см. обсуждение химически амплифицированных резистов ниже). Для электронно-лучевого воздействия фоторезисты выбирают нечасто. Электронно-лучевая литография обычно использует резисты, специально предназначенные для воздействия электронным лучом.
Параметры
[ редактировать ]Физические, химические и оптические свойства фоторезистов влияют на их выбор для различных процессов. [ 13 ] Основными свойствами фоторезиста являются разрешающая способность, технологическая доза и фокусная широта , необходимые для отверждения, а также устойчивость к реактивному ионному травлению. [ 14 ] : 966 [ 15 ] Другими ключевыми свойствами являются чувствительность, совместимость с гидроксидом тетраметиламмония (ТМАГ), адгезия, устойчивость к окружающей среде и срок годности. [ 14 ] : 966 [ 15 ]
- Разрешение
- Разрешение — это способность различать соседние элементы на подложке. Критический размер (CD) является основным показателем разрешения. Чем меньше компакт-диск, тем выше будет разрешение.
- Контраст
- Контраст — это разница между экспонированной частью и неэкспонированной частью. Чем выше контраст, тем более очевидной будет разница между экспонированными и неэкспонированными участками.
- Чувствительность
- Чувствительность — это минимальная энергия, необходимая для создания четко выраженного элемента фоторезиста на подложке, измеряемая в мДж/см. 2 . Чувствительность фоторезиста важна при использовании глубокого ультрафиолета (DUV) или крайнего ультрафиолета (EUV).
- Вязкость
- Вязкость — это мера внутреннего трения жидкости, влияющая на то, насколько легко она будет течь. Когда необходимо получить более толстый слой, предпочтительным будет фоторезист с более высокой вязкостью.
- Приверженность
- Адгезия – это прочность сцепления между фоторезистом и подложкой. Если резист оторвется от подложки, некоторые элементы будут отсутствовать или повреждены.
- Устойчивость к травлению
- Антитравление — это способность фоторезиста противостоять воздействию высокой температуры, среды с различным pH или ионной бомбардировке в процессе постмодификации.
- Поверхностное натяжение
- Поверхностное натяжение — это натяжение, вызываемое жидкостью, стремящейся минимизировать площадь своей поверхности, что вызвано притяжением частиц в поверхностном слое. Для лучшего смачивания поверхности подложки фоторезисты должны обладать относительно низким поверхностным натяжением.
Химическая амплификация
[ редактировать ]Фоторезисты, используемые в производстве для ДУФ и более коротких волн, требуют применения химического усиления для повышения чувствительности к энергии воздействия. Это сделано для того, чтобы бороться с большим поглощением на более коротких длинах волн. Химическую амплификацию также часто используют при электронно-лучевом воздействии для повышения чувствительности к экспозиционной дозе. При этом кислоты , выделяемые в результате воздействия радиации, диффундируют на этапе постэкспозиционного обжига. Эти кислоты делают окружающий полимер растворимым в проявителе. Одна молекула кислоты может катализировать множество таких « снятия защиты реакций »; следовательно, требуется меньше фотонов или электронов. [ 16 ] Диффузия кислоты важна не только для повышения чувствительности и производительности фоторезиста, но также для ограничения шероховатости края линии из-за статистики дробового шума. [ 17 ] Однако длина диффузии кислоты сама по себе является потенциальным ограничителем разрешения. [ 18 ] Кроме того, слишком большая диффузия снижает химический контраст, что снова приводит к большей шероховатости. [ 17 ]
Следующие реакции являются примером коммерческих химически амплифицированных фоторезистов, используемых сегодня:
- фотокислотный генератор + hν (193 нм) → кислотный катион + сульфонат- анион [ 19 ]
- сульфонат-анион + hν (193 нм) → e − + сульфонат [ 20 ]
- и − + генератор фотокислоты → е − + кислотный катион + сульфонат-анион [ 19 ]
е − представляет собой сольватированный электрон или освобожденный электрон, который может реагировать с другими компонентами раствора. Обычно он проходит расстояние порядка многих нанометров, прежде чем его удерживают; [ 21 ] [ 22 ] такое большое расстояние перемещения соответствует высвобождению электронов через толстый оксид в УФ-СППЗУ в ответ на ультрафиолетовый свет. Это паразитное воздействие ухудшит разрешение фоторезиста; для 193 нм оптическое разрешение в любом случае является ограничивающим фактором, но для электронно-лучевой литографии или EUVL разрешение определяет диапазон электронов, а не оптика.
Типы
[ редактировать ]DNQ -новолачный фоторезист
[ редактировать ]G и H-линиями ртутной лампы, основан на смеси диазонафтохинона (ДНХ) и новолачной смолы (фенолформальдегидной Один очень распространенный позитивный фоторезист, используемый с I , смолы). ДНХ ингибирует растворение новолачной смолы, но под воздействием света скорость растворения увеличивается даже по сравнению со скоростью растворения чистого новолака. Механизм, с помощью которого неэкспонированный ДНХ ингибирует растворение новолака, не совсем понятен, но считается, что он связан с водородными связями (или, точнее, с диазосочетанием в неэкспонированной области). ДНХ-новолачные резисты получают путем растворения в основном растворе (обычно 0,26 н. гидроксида тетраметиламмония (ТМАГ) в воде).
Резисты на эпоксидной основе
[ редактировать ]Один очень распространенный негативный фоторезист основан на олигомере на основе эпоксидной смолы. Общее название продукта — фоторезист SU-8 , первоначально он был изобретен IBM , но сейчас продается Microchem и Gersteltec . Уникальным свойством СУ-8 является то, что его очень сложно разобрать. Таким образом, он часто используется в приложениях, где для устройства необходим постоянный рисунок резиста (который невозможно удалить и который можно использовать даже в условиях суровых температур и давлений). [ 23 ] Механизм действия полимера на основе эпоксидной смолы показан в 1.2.3 СУ-8. SU-8 склонен к разбуханию при меньших размерах элементов, что привело к разработке низкомолекулярных альтернатив, способных достигать более высокого разрешения, чем SU-8. [ 24 ]
Нестехиометрический тиол-еновый (OSTE) полимер
[ редактировать ]В 2016 году было показано, что полимеры OSTE обладают уникальным механизмом фотолитографии, основанным на диффузионно-индуцированном истощении мономера, что обеспечивает высокую точность фотоструктурирования. Полимерный материал OSTE был первоначально изобретен в Королевском технологическом институте KTH , но сейчас продается компанией Mercene Labs . Хотя материал имеет свойства, аналогичные свойствам SU8, у OSTE есть особое преимущество, заключающееся в том, что он содержит реактивные поверхностные молекулы, что делает этот материал привлекательным для микрофлюидных или биомедицинских применений. [ 13 ]
Водородный силсесквиоксан (HSQ)
[ редактировать ]HSQ — распространенный негативный резист для электронного луча , но он также полезен для фотолитографии. Первоначально изобретенный компанией Dow Corning (1970 г.), [ 25 ] и в настоящее время производится ( 2017 г. ) компанией Applied Quantum Materials Inc. ( AQM ). В отличие от других негативных резистов, HSQ неорганический и не содержит металлов. Таким образом, подвергнутый воздействию HSQ обеспечивает оксид с низкой диэлектрической проницаемостью (low-k), богатый кремнием. Сравнительное исследование с другими фоторезистами было опубликовано в 2015 году (Dow Corning HSQ). [ 26 ]
Приложения
[ редактировать ]

Микроконтактная печать
[ редактировать ]Микроконтактная печать была описана Whitesides Group в 1993 году. Обычно в этой технике эластомерный штамп используется для создания двумерных рисунков путем печати молекул «чернил» на поверхности твердого субстрата. [ 27 ]
Шаг 1 для микроконтактной печати. Схема создания мастер-штампа из полидиметилсилоксана (ПДМС). Шаг 2 микроконтактной печати. Схема нанесения краски и контактный процесс микропечатной литографии.
Печатные платы
[ редактировать ]Производство печатных плат — одно из важнейших применений фоторезиста. Фотолитография позволяет быстро, экономично и точно воспроизвести сложную схему электронной системы, как если бы она была выпущена из печатного станка. Общий процесс заключается в нанесении фоторезиста, подвергании изображения воздействию ультрафиолетовых лучей, а затем травлении для удаления медной подложки. [ 28 ]

Нанесение рисунка и травление подложек
[ редактировать ]Сюда входят специальные фотонные материалы, микроэлектромеханические системы ( МЭМС ), стеклянные печатные платы и другие по созданию микропаттернов задачи . Фоторезист не подвергается травлению растворами с pH выше 3. [ 29 ]

Микроэлектроника
[ редактировать ]Это приложение, в основном применяемое к кремниевым пластинам и кремниевым интегральным схемам, является наиболее развитой из технологий и наиболее специализированным в этой области. [ 30 ]
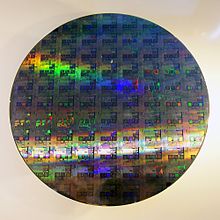
См. также
[ редактировать ]Ссылки
[ редактировать ]- ^ Эрик, Анслин; Догерти, Деннис. Современная физическая органическая химия . Университетские научные книги.
- ^ «Верхние антибликовые покрытия против нижних антибликовых покрытий» .
- ^ Микрохимия. «Основы микроструктурирования: антибликовые покрытия» (PDF) . Микрохимикс ГмбХ . Проверено 31 января 2020 г.
- ^ «Антибликовое покрытие днища AR™ 10L (BARC) | DuPont» . dupont.com .
- ^ Ито, Х.; Уилсон, CG; Фреше, JHJ (1 сентября 1982 г.). «Новые УФ-стойки с отрицательным или положительным тоном» . Симпозиум 1982 года по технологии СБИС. Сборник технических статей : 86–87.
- ^ Маду, Марк (13 марта 2002 г.). Основы микропроизводства . ЦРК Пресс. ISBN 978-0-8493-0826-0 .
- ^ Хуан, Цзинъюй; Дальгрен, Дэвид А.; Хеммингер, Джон К. (1 марта 1994 г.). «Фотопаттерн самоорганизующихся монослоев алкантиолата на золоте: простой однослойный фоторезист с использованием водной химии». Ленгмюр . 10 (3): 626–628. дои : 10.1021/la00015a005 . ISSN 0743-7463 .
- ^ Браттон, Дэниел; Ян, Да; Дай, Джуньян; Обер, Кристофер К. (1 февраля 2006 г.). «Последние достижения в литографии высокого разрешения». Полимеры для передовых технологий . 17 (2): 94–103. дои : 10.1002/пат.662 . ISSN 1099-1581 . S2CID 55877239 .
- ^ Она, Хироюки; Усуи, Синдзи; Дуки, Кацудзи; Кадзита, Тору; Чаванья, Хитоши; Симокава, Цутому (1 января 2000 г.). Хулихан, Фрэнсис М. (ред.). «Дизайн и литографические характеристики генераторов фотокислоты, специфичных для 193». Достижения в области технологии и обработки резистов XVII . 3999 : 1120–1127. Бибкод : 2000SPIE.3999.1120I . дои : 10.1117/12.388276 . S2CID 98281255 .
- ^ Бельбруно, Джозеф (1990). «Многофотонная химия фенола в гексане при длине волны 266 нм» . Письма по химической физике . 166 (2): 167–172. Бибкод : 1990CPL...166..167B . дои : 10.1016/0009-2614(90)87271-р .
- ^ Вайнгартнер, Джозеф С; Дрен, Б.Т.; Барр, Дэвид К. (2006). «Фотоэлектрическая эмиссия пылевых зерен, подвергшихся воздействию крайнего ультрафиолетового и рентгеновского излучения». Астрофизический журнал . 645 (2): 1188–1197. arXiv : astro-ph/0601296 . Бибкод : 2006ApJ...645.1188W . дои : 10.1086/504420 . S2CID 13859981 .
- ^ Браун, М; Грубер, Ф; Руф, М.-Ж; Кумар, С.В.К; Илленбергер, Э; Хотоп, Х (2006). «Усиленное ИК-фотоном диссоциативное присоединение электронов к SF6: зависимость от энергии фотонов, колебаний и электронов». Химическая физика . 329 (1–3): 148. Бибкод : 2006CP....329..148B . doi : 10.1016/j.chemphys.2006.07.005 .
- ^ Jump up to: а б Гринер, Джесси; Ли, Вэй; Рен, Джуди; Войку, Дэн; Пахаренко Виктория; Тан, Тянь; Кумачева, Евгения (2 февраля 2010 г.). «Быстрое и экономичное изготовление микрофлюидных реакторов из термопластичных полимеров путем сочетания фотолитографии и горячего тиснения» . Лабораторный чип . 10 (4): 522–524. дои : 10.1039/b918834g . ISSN 1473-0189 . ПМИД 20126695 . S2CID 24567881 .
- ^ Jump up to: а б Справочник по физическим свойствам полимеров . Джеймс Э. Марк (2-е изд.). Нью-Йорк: Спрингер. 2006. ISBN 978-0-387-31235-4 . OCLC 619279219 .
{{cite book}}: CS1 maint: другие ( ссылка ) - ^ Jump up to: а б Линь, Цинхуан (2007), Марк, Джеймс Э. (редактор), «Свойства фоторезистивных полимеров» , Справочник по физическим свойствам полимеров , Нью-Йорк, Нью-Йорк: Springer New York, стр. 965–979, doi : 10.1007/978. -0-387-69002-5_57 , ISBN 978-0-387-31235-4 , получено 6 января 2023 г.
- ^ Патент США 4,491,628 «Композиции положительного и отрицательного рабочего резиста с кислотообразующим фотоинициатором и полимером с подвеской кислотолабильных групп на основной цепи полимера» Дж. М. Дж. Фреше, Х. Ито и К. Г. Уилсон, 1985. [1]
- ^ Jump up to: а б Ван Стенвинкель, Дэвид; Ламмерс, Йерун Х.; Келер, Томас; Брейнард, Роберт Л.; Трефонас, Питер (2006). «Сопротивление эффектам на малых шагах» . Журнал вакуумной науки и техники Б. 24 (1): 316–320. Бибкод : 2006JVSTB..24..316V . дои : 10.1116/1.2151912 .
- ^ Чочос, ЧЛ; Исмаилова, Э. (2009). «Сверхразветвленные полимеры для фотолитографических применений - на пути к пониманию взаимосвязи между химической структурой полимерной смолы и литографическими характеристиками». Продвинутые материалы . 21 (10–11): 1121. Бибкод : 2009AdM....21.1121C . дои : 10.1002/adma.200801715 . S2CID 95710610 .
- ^ Jump up to: а б С. Тагава; и др. (2000). Хулихан, Фрэнсис М. (ред.). «Радиация и фотохимия генераторов ониевых солевых кислот в химически усиленных резистах». Учеб. ШПИОН . Достижения в области технологии и обработки резистов XVII. 3999 : 204. Бибкод : 2000SPIE.3999..204T . дои : 10.1117/12.388304 . S2CID 95525894 .
- ^ Ван, Сюэ-Бин; Феррис, Ким; Ван, Лай-Шэн (2000). «Фотоотщепление газообразных многозарядных анионов, тетраанион фталоцианина тетрасульфоната меди: настройка уровней молекулярной электронной энергии путем зарядки и отрицательного связывания электронов». Журнал физической химии А. 104 (1): 25–33. Бибкод : 2000JPCA..104...25Вт . дои : 10.1021/jp9930090 .
- ^ Лу, Хун; Лонг, Фредерик Х.; Эйзенталь, КБ (1990). «Фемтосекундные исследования электронов в жидкостях». Журнал Оптического общества Америки Б. 7 (8): 1511. Бибкод : 1990JOSAB...7.1511L . дои : 10.1364/JOSAB.7.001511 .
- ^ Лукин Л; Балакин, Александр Александрович (2001). «Термализация электронов низкой энергии в жидком метилциклогексане, изученная методом фотоассистированного разделения ионных пар». Химическая физика . 265 (1): 87–104. Бибкод : 2001CP....265...87L . дои : 10.1016/S0301-0104(01)00260-9 .
- ^ ДеФорест, Уильям С. (1975). Фоторезист: материалы и процессы . Компании МакГроу-Хилл.
- ^ Лоусон, Ричард; Толберт, Ларен; Юнкин, Тодд; Хендерсон, Клифф (2009). Хендерсон, Клиффорд Л. (ред.). «Молекулярные резисты негативного тона на основе катионной полимеризации» . Учеб. SPIE 7273, Достижения в области резистивных материалов и технологий обработки . Достижения в области резистивных материалов и технологий обработки XXVI. XXVI : 72733E. Бибкод : 2009SPIE.7273E..3EL . дои : 10.1117/12.814455 . S2CID 122244702 .
- ^ Фрай, Сесил Л.; Коллинз, Уорд Т. (1 сентября 1970 г.). «Олигомерные силсесквиоксаны, (HSiO3/2)n» . Журнал Американского химического общества . 92 (19): 5586–5588. дои : 10.1021/ja00722a009 . ISSN 0002-7863 .
- ^ Моджарад, Насир; Гобрехт, Йенс; Экинчи, Ясин (18 марта 2015 г.). «За пределами EUV-литографии: сравнительное исследование эффективности эффективных фоторезистов» . Научные отчеты . 5 (1): 9235. Бибкод : 2015NatSR...5E9235M . дои : 10.1038/srep09235 . ISSN 2045-2322 . ПМЦ 4363827 . ПМИД 25783209 .
- ^ «Самособранные однослойные пленки: микроконтактная печать» (PDF) .
- ^ Монтроуз, Марк I (1999). Справочник по электронной упаковке . ЦРК Пресс.
- ^ Новак, Р.Э. (2000). Технология очистки в производстве полупроводниковых приборов . Электрохимического общества Inc. ISBN 978-1566772594 .
- ^ Кремниевая фотоника . Springer Science & Business Media. 2004.