Рентгеновская литография
Эта статья нуждается в дополнительных цитатах для проверки . ( июнь 2022 г. ) |
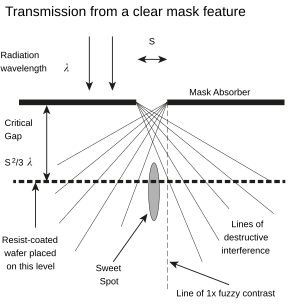
Рентгеновская литография — это процесс, используемый в производстве полупроводниковых приборов для выборочного удаления частей тонкой пленки фоторезиста. Он использует рентгеновские лучи для переноса геометрического рисунка с маски на светочувствительный химический фоторезист или просто «сопротивляться» на подложке, чтобы достичь чрезвычайно малого топологического размера объекта. Затем в результате серии химических обработок полученный рисунок гравируется на материале под фоторезистом.
В коммерческом производстве он используется реже из-за непомерно высокой стоимости материалов (например, золота, используемого для блокировки рентгеновских лучей) и т. д. [1]
Механизмы
[ редактировать ]Рентгеновская литография возникла как кандидат на литографию следующего поколения для полупроводниковой промышленности. [1] партиями микропроцессоров , с успешно произведенными . Имея короткие длины волн (менее 1 нм), рентгеновские лучи преодолевают дифракционные пределы оптической литографии , позволяя уменьшить размеры элементов . Если источник рентгеновского излучения не коллимирован, как в случае синхротронного излучения используются элементарные коллимирующие зеркала или дифракционные , вместо преломляющих линз, используемых в оптике, линзы. Рентгеновские лучи освещают маску, расположенную рядом с пластиной, покрытой резистом. Рентгеновские лучи широкополосные, обычно от компактного источника синхротронного излучения , что обеспечивает быстрое облучение. Глубокая рентгеновская литография (DXRL) использует еще более короткие длины волн, порядка 0,1 нм , и модифицированные процедуры, такие как процесс LIGA , для изготовления глубоких и даже трехмерных структур.
Маска состоит из поглотителя рентгеновских лучей, обычно из золота или соединений тантала или вольфрама , на мембране, прозрачной для рентгеновских лучей, обычно из карбида кремния или алмаза . Узор на маске наносится методом прямой электронно-лучевой литографии на резист, полученный традиционными полупроводниковыми процессами. Мембрану можно растягивать для обеспечения точности наложения.
Большинство демонстраций рентгеновской литографии выполнялось путем копирования с точностью изображения (без увеличения) на линии нечеткого контраста, как показано на рисунке. Однако с ростом потребности в высоком разрешении рентгеновская литография теперь выполняется в так называемой «золотой зоне», используя локальное «уменьшение увеличения за счет смещения». [2] [3] Плотные структуры создаются в результате многократного воздействия с трансляцией. Преимущества использования 3-кратного уменьшения включают в себя упрощение изготовления маски, увеличение зазора между маской и пластиной и повышение контрастности. Эту технику можно расширить до плотных отпечатков толщиной 15 нм .
Рентгеновские лучи генерируют вторичные электроны, как в случае литографии в крайнем ультрафиолете и электронно-лучевой литографии . Хотя четкость четкого рисунка обусловлена главным образом вторичными электронами оже-электронов с короткой длиной пути, первичные электроны будут сенсибилизировать резист в большей области, чем воздействие рентгеновских лучей. Хотя это не влияет на разрешение шага рисунка, которое определяется длиной волны и зазором, контраст экспозиции изображения (макс-мин)/(макс+мин) уменьшается, поскольку шаг находится на уровне диапазона первичного фотоэлектрона. Эти вторичные электроны влияют на шероховатость и наклоны боковой стенки, поскольку они могут перемещаться на несколько микрометров в области под поглотителем, в зависимости от энергии рентгеновского излучения. [4] несколько отпечатков на длине волны около 30 нм . Опубликовано [5]
Другим проявлением фотоэлектронного эффекта является воздействие рентгеновских лучей на толстые пленки золота, используемые для изготовления дочерних масок. [6] Моделирование показывает, что генерация фотоэлектронов на золотой подложке может влиять на скорость растворения.
Фотоэлектроны, вторичные электроны и оже-электроны
[ редактировать ]Вторичные электроны имеют энергию 25 эВ или меньше и могут генерироваться любым ионизирующим излучением ( ВУФ , ЭУФ, рентгеновскими лучами, ионами и другими электронами). Оже-электроны имеют энергию в сотни электронвольт. Вторичные фотоэлектроны (генерируемые оже- и первичными фотоэлектронами и превосходящие их по численности) являются основными агентами резистивного воздействия. [ нужна ссылка ]
Относительные пробеги первичных фотоэлектронов и оже-электронов зависят от их соответствующих энергий. Эти энергии зависят от энергии падающего излучения и состава резиста. Существует значительное пространство для оптимального выбора (ссылка 3 статьи). Когда оже-электроны имеют более низкую энергию, чем первичные фотоэлектроны, они имеют более короткий пробег. Оба распадаются на вторичные вещества, которые взаимодействуют с химическими связями. [7] Когда вторичная энергия слишком мала, она не может разорвать химические связи и перестает влиять на разрешение печати. Эксперименты доказывают, что объединенный диапазон составляет менее 20 нм. С другой стороны, вторичные компоненты следуют другой тенденции ниже ≈30 эВ: чем ниже энергия, тем длиннее длина свободного пробега , хотя тогда они не могут повлиять на сопротивление развитию. [ нужна ссылка ]
По мере распада первичные фотоэлектроны и оже-электроны в конечном итоге становятся физически неотличимыми (как в статистике Ферми – Дирака ) от вторичных электронов. Пробег низкоэнергетических вторичных электронов иногда превышает пробег первичных фотоэлектронов или оже-электронов. Для рентгеновской литографии важен эффективный диапазон электронов, обладающих достаточной энергией для создания или разрыва химических связей в отрицательных или положительных резистах. [ нужна ссылка ]
Литографический электронный диапазон
[ редактировать ]Рентгеновские снимки не требуют оплаты. Относительно большая длина свободного пробега (~ 20 нм) вторичных электронов затрудняет контроль разрешения в нанометровом масштабе. В частности, электронно-лучевая литография подвергается отрицательному заряду падающих электронов и, как следствие, растеканию луча, что ограничивает разрешение. Поэтому трудно выделить эффективный диапазон вторичных частиц, который может составлять менее 1 нм.
Комбинированная длина свободного пробега электронов приводит к размытию изображения, которое обычно моделируется как функция Гаусса (где σ = размытие), которая свертывается с ожидаемым изображением. Когда желаемое разрешение приближается к размытию, изображение дозы становится шире, чем аэрофотоснимок падающих рентгеновских лучей. Размытие, которое имеет значение, — это скрытое изображение , которое описывает создание или разрыв связей во время воздействия резиста. Проявленное изображение является окончательным рельефным изображением, полученным с помощью выбранного высококонтрастного процесса проявления скрытого изображения.
диапазон первичных, оже-, вторичных и сверхнизкоэнергетических электронов генерации более высокого порядка, которые печатают (как показали исследования СТМ Согласно различным цитируемым публикациям, ), может быть большим (десятки нм) или малым (нм). Поскольку этот диапазон не является фиксированным числом, его трудно определить количественно. Неровность края линии усугубляется связанной с этим неопределенностью. Шероховатость края линии предположительно имеет статистическую природу и лишь косвенно зависит от среднего диапазона. В обычно практикуемых условиях литографии можно контролировать и использовать различные диапазоны электронов.
Зарядка
[ редактировать ]Рентгеновские лучи не несут заряда, но при соответствующих энергиях оже-распад ионизированных частиц в образце более вероятен, чем радиационный распад. Излучение высокой энергии, превышающей потенциал ионизации, также генерирует свободные электроны, которые пренебрежимо малы по сравнению с теми, которые производятся заряженными электронными лучами. Зарядка образца после ионизации представляет собой чрезвычайно слабую возможность, когда нельзя гарантировать, что ионизированные электроны, покидающие поверхность или оставшиеся в образце, будут адекватно сбалансированы во времени от других источников. Передача энергии электронам в результате ионизирующего излучения приводит к разделению положительных и отрицательных зарядов, которые быстро рекомбинируются, отчасти из-за дальнего действия кулоновской силы. Было обнаружено, что изолирующие пленки, такие как затворные оксиды и резисты, заряжаются до положительного или отрицательного потенциала при облучении электронным лучом. Изолирующие пленки в конечном итоге локально нейтрализуются пространственным зарядом (электроны входят и покидают поверхность) на границе резист-вакуум и Инъекция Фаулера-Нордгейма из подложки. [8] На пробег электронов в пленке может влиять локальное электрическое поле. Ситуация осложняется наличием дырок (положительно заряженных электронных вакансий), которые генерируются вместе с вторичными электронами и которые, как можно ожидать, будут следовать за ними. По мере того как нейтрализация продолжается, любая начальная концентрация заряда фактически начинает распространяться. Окончательное химическое состояние пленки достигается после завершения нейтрализации, когда все электроны в конечном итоге замедлились. Обычно, за исключением рентгеновских шаговых двигателей, зарядку можно дополнительно контролировать с помощью пистолета-распылителя, толщины резиста или слоя рассеивания заряда.
См. также
[ редактировать ]- Фотолитография
- Экстремальная ультрафиолетовая литография
- Электронно-лучевая литография
- Ионно-лучевая литография
Примечания
[ редактировать ]- ^ Ю. Владимирский, «Литография» в вакуумной ультрафиолетовой спектроскопии II под ред. Дж.А.Самсон и Д.Л.Эдерер, глава 10, стр. 205–223, Academic Press (1998).
- ^ Владимирский, Юлий; Бурдиллон, Энтони; Владимирский, Ольга; Цзян, Вэньлун; Леонард, Куинн (1999). «Уменьшение увеличения при бесконтактной рентгеновской литографии и расширение до 25 нм за счет оптимизации дифракции Френеля». Журнал физики D: Прикладная физика . 32 (22): 114. Бибкод : 1999JPhD...32..114В . дои : 10.1088/0022-3727/32/22/102 .
- ^ Энтони Бурдиллон и Юлий Владимирский, Рентгеновская литография в зоне наилучшего восприятия , UHRL, Сан-Хосе, (2006) ISBN 978-0-9789839-0-1
- ^ Вора, К.Д.; Шью, BY; Харви, ЕС; Хейс, JP; Пил, AG (2008). «Откосы боковины СУ-8 ХАРМСТ с использованием глубокой рентгеновской литографии». Журнал микромеханики и микроинженерии . 18 (3): 035037. Бибкод : 2008JMiMi..18c5037V . дои : 10.1088/0960-1317/18/3/035037 .
- ^ Рано, К; Шаттенбург, М; Смит, Х. (1990). «Отсутствие ухудшения разрешения в рентгеновской литографии для λ от 4,5 до 0,83 нм». Микроэлектронная инженерия . 11 : 317. doi : 10.1016/0167-9317(90)90122-A .
- ^ Картер, DJD (1997). «Прямое измерение эффекта фотоэлектронов подложки в рентгеновской нанолитографии». Журнал вакуумной науки и техники Б. 15 (6): 2509. Бибкод : 1997JVSTB..15.2509C . дои : 10.1116/1.589675 .
- ^ Луд, Саймон К.; Стинакерс, Марин; Джордан, Райнер; Бруно, Паола; Грюн, Дитер М.; Фёлнер, Питер; Гарридо, Хосе А.; Штуцманн, Мартин (2006). «Химическая прививка самоорганизующихся монослоев бифенила на ультрананокристаллический алмаз». Журнал Американского химического общества . 128 (51): 16884–91. дои : 10.1021/ja0657049 . ПМИД 17177439 .
- ^ Главатских И.А.; Кортов В.С.; Фиттинг, Х.-Дж. (2001). «Самосогласованный электрический заряд изолирующих слоев и структур металл-изолятор-полупроводник». Журнал прикладной физики . 89 : 440. Бибкод : 2001JAP....89..440G . дои : 10.1063/1.1330242 .
Ссылки
[ редактировать ]- ^ «Pdf — Полупроводниковые технологии от А до Я — Halbleiter.org» . www.halbleiter.org . Проверено 14 июня 2022 г.