Химическое осаждение из паровой фазы

Химическое осаждение из паровой фазы ( CVD ) — это метод вакуумного осаждения, используемый для производства высококачественных и высокопроизводительных твердых материалов. Этот процесс часто используется в полупроводниковой промышленности для производства тонких пленок . [ 1 ]
При типичном CVD пластина (подложка) подвергается воздействию одного или нескольких летучих предшественников , которые реагируют и/или разлагаются на поверхности подложки с образованием желаемого покрытия. Часто образуются также летучие побочные продукты , которые удаляются потоком газа через реакционную камеру.
В процессах микропроизводства широко используется CVD для нанесения материалов в различных формах, в том числе: монокристаллических , поликристаллических , аморфных и эпитаксиальных . К этим материалам относятся: кремний ( диоксид , карбид , нитрид , оксинитрид ), углерод ( волокно , нановолокна , нанотрубки , алмаз и графен ), фторуглероды , нити , вольфрам , нитрид титана и различные диэлектрики с высоким κ .
Термин «химическое осаждение из паровой фазы» был введен в 1960 году Джоном М. Блохером-младшим, который намеревался отличить химическое осаждение от физического осаждения из паровой фазы (PVD).
Типы
[ редактировать ]
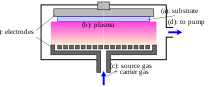
CVD практикуется в различных форматах. Эти процессы обычно различаются способами инициирования химических реакций.
- Классификация по условиям эксплуатации:
- CVD при атмосферном давлении (APCVD) – CVD при атмосферном давлении.
- CVD низкого давления (LPCVD) – CVD при давлении ниже атмосферного. [ 2 ] Пониженное давление имеет тенденцию уменьшать нежелательные газофазные реакции и улучшать однородность пленки по всей пластине.
- CVD в сверхвысоком вакууме (UHVCVD) – CVD при очень низком давлении, обычно ниже 10. −6 Ну (≈ 10 −8 Торр ). более низкое деление между высоким и сверхвысоким вакуумом , часто 10. Обратите внимание, что в других областях распространено −7 Хорошо.
- CVD при субатмосферном давлении (SACVD) – CVD при давлении ниже атмосферного. Использует тетраэтилортосиликат (ТЭОС) и озон для заполнения структур Si с высоким аспектным соотношением диоксидом кремния (SiO 2 ). [ 3 ]
Большинство современных ССЗ — это LPCVD или UHVCVD.
- Классифицируется по физическим характеристикам пара:
- CVD с использованием аэрозоля (AACVD) – CVD, при котором предшественники переносятся к подложке с помощью жидкостного/газового аэрозоля, который можно генерировать ультразвуком. Этот метод подходит для использования с нелетучими прекурсорами.
- CVD с прямым впрыском жидкости (DLICVD) – CVD, при котором прекурсоры находятся в жидкой форме (жидкость или твердое вещество, растворенное в подходящем растворителе). Жидкие растворы впрыскиваются в испарительную камеру по направлению к форсункам (обычно автомобильным). Затем пары прекурсора транспортируются к подложке, как и в классическом CVD. Этот метод подходит для использования с жидкими или твердыми прекурсорами. Используя этот метод, можно достичь высоких темпов роста.
- Классификация по типу нагрева подложки:
- CVD с горячей стенкой - CVD, при котором камера нагревается внешним источником энергии, а подложка нагревается излучением нагретых стенок камеры.
- CVD с холодной стенкой - CVD, при котором непосредственно нагревается только подложка либо за счет индукции, либо путем пропускания тока через саму подложку или нагреватель, находящийся в контакте с подложкой. Стенки камеры имеют комнатную температуру.
- Плазменные методы (см. также Плазменная обработка ):
- CVD с микроволновой плазмой (MPCVD)
- CVD с плазменным усилением (PECVD) – CVD, в котором плазма используется для повышения скорости химических реакций предшественников. [ 4 ] PECVD-обработка позволяет осуществлять осаждение при более низких температурах, что часто имеет решающее значение при производстве полупроводников. Более низкие температуры также позволяют наносить органические покрытия, такие как плазменные полимеры, которые используются для функционализации поверхности наночастиц . [ 5 ]
- Дистанционное CVD с плазменным усилением (RPECVD) - аналогично PECVD, за исключением того, что подложка пластины не находится непосредственно в области плазменного разряда. Удаление пластины из области плазмы позволяет снизить температуру обработки до комнатной.
- Химическое осаждение из газовой фазы с низким энергопотреблением в плазме (LEPECVD) - CVD, в котором используется плазма высокой плотности и низкой энергии для эпитаксиального осаждения полупроводниковых материалов с высокими скоростями и низкими температурами.
- CVD атомного слоя ( ALCVD ) – наносит последовательные слои различных веществ для получения слоистых кристаллических пленок. См. Атомно-слоевая эпитаксия .
- Химическое осаждение из паровой фазы горением (CCVD). Химическое осаждение из паровой фазы горением или пламенный пиролиз представляет собой метод на основе пламени в открытой атмосфере для осаждения высококачественных тонких пленок и наноматериалов .
- CVD с горячей нитью (HFCVD) - также известный как каталитический CVD (Cat-CVD) или, чаще, инициированный CVD. В этом процессе используется горячая нить накала для химического разложения исходных газов. [ 6 ] Таким образом, температура нити и температура подложки контролируются независимо, что позволяет использовать более низкие температуры для лучшей скорости поглощения на подложке и более высокие температуры, необходимые для разложения предшественников на свободные радикалы на нити. [ 7 ]
- Гибридное физико-химическое осаждение из паровой фазы (HPCVD). Этот процесс включает в себя как химическое разложение газа-прекурсора, так и испарение твердого источника.
- Химическое осаждение из паровой фазы металлорганических соединений (MOCVD). Этот процесс CVD основан на использовании металлорганических предшественников.
- Быстрое термическое CVD (RTCVD). В этом процессе CVD используются нагревательные лампы или другие методы для быстрого нагрева подложки пластины. Нагрев только подложки, а не газа или стенок камеры, помогает уменьшить нежелательные газофазные реакции, которые могут привести к образованию частиц .
- Парофазная эпитаксия (ВПЭ)
- Фотоинициируемое CVD (PICVD). В этом процессе используется ультрафиолетовый свет для стимуляции химических реакций. Это похоже на плазменную обработку, поскольку плазма является сильным излучателем УФ-излучения. При определенных условиях PICVD может работать при атмосферном давлении или близком к нему. [ 8 ]
- Лазерное химическое осаждение из паровой фазы (LCVD). В этом процессе CVD используются лазеры для нагрева пятен или линий на подложке в полупроводниковых приложениях. В МЭМС и производстве волокон лазеры быстро используются для разрушения исходного газа (температура процесса может превышать 2000 °C) для создания твердой структуры почти так же, как 3D-принтеры на основе лазерного спекания создают твердые вещества из порошков. .
Использование
[ редактировать ]CVD обычно используется для нанесения конформных пленок и увеличения поверхности подложки способами, на которые не способны более традиционные методы модификации поверхности. CVD чрезвычайно полезен в процессе осаждения атомных слоев при нанесении чрезвычайно тонких слоев материала. Существует множество применений таких пленок. Арсенид галлия используется в некоторых интегральных схемах (ИС) и фотоэлектрических устройствах. Аморфный поликремний используется в фотоэлектрических устройствах. Некоторые карбиды и нитриды придают износостойкость. [ 9 ] Полимеризация методом CVD, возможно, наиболее универсальная из всех областей применения, позволяет создавать сверхтонкие покрытия, обладающие некоторыми очень желательными качествами, такими как смазывающая способность, гидрофобность и устойчивость к атмосферным воздействиям, и это лишь некоторые из них. [ 10 ] Недавно было продемонстрировано CVD металлоорганических каркасов , класса кристаллических нанопористых материалов. [ 11 ] Недавно был расширен до уровня интегрированного процесса в чистых помещениях для нанесения подложек большой площади. [ 12 ] Ожидается, что эти пленки найдут применение в газовых сенсорах и диэлектриках с низким κ . Методы CVD также выгодны для мембранных покрытий, например, при опреснении или очистке воды, поскольку эти покрытия могут быть достаточно однородными (конформными) и тонкими, чтобы не закупоривать поры мембраны. [ 13 ]
Коммерчески важные материалы, приготовленные методом CVD.
[ редактировать ]Поликремний
[ редактировать ]Поликристаллический кремний осаждают из трихлорсилана (SiHCl 3 ) или силана (SiH 4 ) по следующим реакциям: [ 14 ]
- SiHCl 3 → Si + Cl 2 + HCl
- SiH 4 → Si + 2 H 2
Эту реакцию обычно проводят в системах LPCVD либо с чистым силановым сырьем, либо с раствором силана с 70–80% азота . Температуры от 600 до 650 ° C и давления от 25 до 150 Па обеспечивают скорость роста от 10 до 20 нм в минуту. В альтернативном процессе используется раствор на основе водорода . Водород снижает скорость роста, но для компенсации температуру повышают до 850 или даже 1050 °C. Поликремний можно выращивать непосредственно с легированием, если такие газы, как фосфин , арсин или диборан в камеру CVD добавить . Диборан увеличивает скорость роста, а арсин и фосфин снижают ее.
Диоксид кремния
[ редактировать ]Диоксид кремния (в полупроводниковой промышленности его обычно называют просто «оксидом») можно осаждать с помощью нескольких различных процессов. Общие исходные газы включают силан и кислород , дихлорсилан (SiCl 2 H 2 ) и закись азота. [ 15 ] (N 2 O) или тетраэтилортосиликат (ТЭОС; Si(OC 2 H 5 ) 4 ). Реакции следующие: [ 16 ]
- SiH 4 + O 2 → SiO 2 + 2 H 2
- SiCl 2 H 2 + 2 N 2 O → SiO 2 + 2 N 2 + 2 HCl
- Si(OC 2 H 5 ) 4 → SiO 2 + побочные продукты
Выбор исходного газа зависит от термической стабильности подложки; например, алюминий чувствителен к высокой температуре. Силан откладывается при температуре от 300 до 500 °C, дихлорсилан — при температуре около 900 °C, а TEOS — при температуре от 650 до 750 °C, в результате чего образуется слой низкотемпературного оксида (LTO). Однако силан дает оксид более низкого качества, чем другие методы ( более низкая диэлектрическая прочность например, ), и он осаждается неконформно . Любую из этих реакций можно использовать в LPCVD, но силановую реакцию также проводят в APCVD. Оксид CVD всегда имеет более низкое качество, чем термический оксид , но термическое окисление можно использовать только на самых ранних стадиях производства ИС.
Оксид также можно выращивать с примесями ( легированием или « легированием »). Это может иметь две цели. На дальнейших этапах процесса, которые происходят при высокой температуре, примеси могут диффундировать из оксида в соседние слои (особенно в кремний) и легировать их. Для этой цели часто используют оксиды, содержащие 5–15% примесей по массе. Кроме того, диоксид кремния, легированный пятиокисью фосфора для сглаживания неровных поверхностей можно использовать («П-стекло»). П-стекло размягчается и оплавляется при температуре выше 1000 °C. Этот процесс требует концентрации фосфора не менее 6%, но концентрации выше 8% могут вызвать коррозию алюминия. Фосфор осаждается из газообразного фосфина и кислорода:
- 4 РН 3 + 5 О 2 → 2 П 2 О 5 + 6 Н 2
Стекла, содержащие как бор, так и фосфор (борофосфорсиликатное стекло, БФСГ), подвергаются вязкому течению при более низких температурах; около 850 °C достижима для стекол, содержащих около 5 мас.% обоих компонентов, но добиться стабильности на воздухе бывает сложно. Оксид фосфора в высоких концентрациях взаимодействует с окружающей влагой с образованием фосфорной кислоты. Кристаллы BPO 4 могут также выпадать из жидкого стекла при охлаждении; эти кристаллы нелегко травить в стандартной реактивной плазме, используемой для формирования рисунка оксидов, и это приведет к дефектам схем при производстве интегральных схем.
Помимо этих преднамеренных примесей, оксид CVD может содержать побочные продукты осаждения. ТЭОС дает относительно чистый оксид, тогда как силан вносит примеси водорода, а дихлорсилан – хлор .
Также было исследовано осаждение диоксида кремния и легированных стекол из ТЭОС при более низкой температуре с использованием озона, а не кислорода (от 350 до 500 ° C). Озоновые стекла обладают превосходной конформностью, но имеют тенденцию быть гигроскопичными, то есть они поглощают воду из воздуха из-за включения в стекло силанола (Si-OH). Инфракрасная спектроскопия и зависимость механической деформации от температуры являются ценными диагностическими инструментами для диагностики таких проблем.
Нитрид кремния
[ редактировать ]Нитрид кремния часто используется в качестве изолятора и химического барьера при производстве микросхем. Следующие две реакции выделяют нитрид кремния из газовой фазы:
- 3 SiH 4 + 4 NH 3 → Si 3 N 4 + 12 H 2
- 3 SiCl 2 H 2 + 4 NH 3 → Si 3 N 4 + 6 HCl + 6 H 2
Нитрид кремния, нанесенный методом LPCVD, содержит до 8% водорода. Он также испытывает сильное растягивающее напряжение , которое может привести к растрескиванию пленок толщиной более 200 нм. Однако он имеет более высокое удельное сопротивление и диэлектрическую прочность, чем большинство изоляторов, обычно доступных в микропроизводстве (10 16 Ом ·см и 10 МВ / см соответственно).
Для осаждения SiNH в плазме можно использовать еще две реакции:
- 2 SiH 4 + N 2 → 2 SiNH + 3 H 2
- SiH 4 + NH 3 → Синь + 3 H 2
Эти пленки имеют гораздо меньшие растягивающие напряжения, но худшие электрические свойства (удельное сопротивление 10 6 до 10 15 Ом·см и диэлектрическая прочность от 1 до 5 МВ/см). [ 17 ]
Металлы
[ редактировать ]Вольфрам CVD, используемый для формирования проводящих контактов, переходных отверстий и вилок в полупроводниковых устройствах. [ 18 ] достигается за счет гексафторида вольфрама (WF 6 ), который может быть нанесен двумя способами:
- ВФ 6 → В + 3 Ж 2
- ВФ 6 + 3 Ч 2 → Ж + 6 ВЧ
Другие металлы, особенно алюминий и медь , можно наносить методом CVD. По состоянию на 2010 год [update]коммерчески рентабельного CVD для меди не существовало, хотя существуют летучие источники, такие как Cu( hfac ) 2 . Медь обычно наносят гальваническим способом . Алюминий может быть осажден из триизобутилалюминия (ТИБАЛ) и родственных алюминийорганических соединений .
CVD для молибдена , тантала , титана , никеля. Широко используется [ 19 ] Эти металлы могут образовывать полезные силициды при осаждении на кремний. Mo, Ta и Ti осаждаются методом LPCVD из их пентахлоридов. Никель, молибден и вольфрам могут быть осаждены при низких температурах из их карбонильных предшественников. В общем случае для произвольного металла M реакция осаждения хлоридов выглядит следующим образом:
- 2 MCl 5 + 5 H 2 → 2 M + 10 HCl
тогда как реакция разложения карбонила может происходить самопроизвольно при термической обработке или акустической кавитации и заключается в следующем:
- M(CO) n → M + n CO
разложение карбонилов металлов часто резко ускоряется под действием влаги или воздуха, когда кислород реагирует с предшественником металла с образованием металла или оксида металла вместе с диоксидом углерода.
Слои оксида ниобия(V) могут быть получены термическим разложением этоксида ниобия(V) с потерей диэтилового эфира. [ 20 ] [ 21 ] согласно уравнению:
- 2 Nb(OC 2 H 5 ) 5 → Nb 2 O 5 + 5 C 2 H 5 OC 2 H 5
Графен
[ редактировать ]Для синтеза графена можно использовать множество вариантов CVD. Хотя было достигнуто множество достижений, перечисленные ниже процессы пока не являются коммерчески жизнеспособными.
- Источник углерода
Самым популярным источником углерода, который используется для производства графена, является газ метан. Одним из менее популярных вариантов является нефтяной асфальт, который отличается дешевизной, но с ним сложнее работать. [ 22 ]
Хотя метан является наиболее популярным источником углерода, в процессе приготовления требуется водород, чтобы способствовать осаждению углерода на подложке. Если соотношение потоков метана и водорода не является подходящим, это приведет к нежелательным результатам. Во время роста графена роль метана заключается в обеспечении источника углерода, роль водорода заключается в предоставлении атомов H для коррозии аморфного углерода. [ 23 ] и улучшить качество графена. Но избыток атомов водорода также может разъедать графен. [ 24 ] В результате целостность кристаллической решетки нарушается, а качество графена ухудшается. [ 25 ] Следовательно, оптимизируя скорость потока газов метана и водорода в процессе роста, можно улучшить качество графена.
- Использование катализатора
Использование катализатора позволяет изменить физический процесс производства графена. Яркие примеры включают наночастицы железа, пену никеля и пары галлия. Эти катализаторы можно использовать либо in situ во время накопления графена, либо [ 22 ] [ 26 ] или расположен на некотором расстоянии от места осаждения. [ 27 ] Для некоторых катализаторов требуется еще один этап удаления их из материала пробы. [ 26 ]
Прямой рост высококачественных крупных монокристаллических доменов графена на диэлектрической подложке имеет жизненно важное значение для приложений в электронике и оптоэлектронике. Сочетая в себе преимущества каталитического CVD и сверхплоской диэлектрической подложки, газообразный катализатор CVD [ 28 ] открывает путь к синтезу высококачественного графена для приложений в устройствах, избегая при этом процесса переноса.
- Физические условия
Физические условия, такие как окружающее давление, температура, газ-носитель и материал камеры, играют большую роль в производстве графена.
В большинстве систем используется LPCVD с давлением от 1 до 1500 Па. [ 22 ] [ 27 ] Однако некоторые все еще используют APCVD. [ 26 ] Низкое давление используется чаще, поскольку оно помогает предотвратить нежелательные реакции и обеспечить более равномерную толщину осаждения на подложке.
С другой стороны, используемые температуры варьируются от 800 до 1050 °C. [ 22 ] [ 26 ] Высокие температуры приводят к увеличению скорости реакции. Необходимо проявлять осторожность, поскольку высокие температуры представляют собой более высокий уровень опасности, а также более высокие затраты на электроэнергию.
- Газ-носитель
В систему подаются газообразный водород и инертные газы, такие как аргон. [ 22 ] [ 26 ] Эти газы действуют как носитель, усиливая поверхностную реакцию и скорость реакции, тем самым увеличивая осаждение графена на подложку.
- Материал камеры
Для CVD графена используются стандартные кварцевые трубки и камеры. [ 29 ] [ 30 ] Кварц выбран потому, что он имеет очень высокую температуру плавления и химически инертен. Другими словами, кварц не препятствует никаким физическим или химическим реакциям независимо от условий.
- Методы анализа результатов
Рамановская спектроскопия, рентгеновская спектроскопия, просвечивающая электронная микроскопия (ПЭМ) и сканирующая электронная микроскопия (СЭМ) используются для исследования и характеристики образцов графена. [ 29 ] [ 30 ]
Рамановская спектроскопия используется для характеристики и идентификации частиц графена; Рентгеновская спектроскопия используется для характеристики химических состояний; ПЭМ используется для получения подробной информации о внутреннем составе графена; СЭМ используется для исследования поверхности и топографии.
Иногда атомно-силовая микроскопия (АСМ) используется для измерения локальных свойств, таких как трение и магнетизм. [ 29 ] [ 30 ]
Метод CVD с холодной стенкой можно использовать для изучения лежащих в основе науки о поверхности, связанных с зарождением и ростом графена, поскольку он позволяет беспрецедентно контролировать параметры процесса, такие как скорость потока газа, температуру и давление, как продемонстрировано в недавнем исследовании. Исследование проводилось в самодельной вертикальной системе с холодными стенами, в которой использовался резистивный нагрев путем пропускания постоянного тока через подложку. Это дало убедительное представление о типичном механизме зародышеобразования и роста, опосредованном поверхностью, в двумерных материалах, выращенных с использованием каталитического CVD в условиях, искомых в полупроводниковой промышленности. [ 31 ] [ 32 ]
Графеновая нанолента
[ редактировать ]Несмотря на замечательные электронные и тепловые свойства графена, он непригоден в качестве транзистора для будущих цифровых устройств из-за отсутствия запрещенной зоны между зоной проводимости и валентной зоной. Это делает невозможным переключение между состояниями включения и выключения относительно потока электронов. Уменьшая масштаб, графеновые наноленты шириной менее 10 нм действительно имеют электронную запрещенную зону и, следовательно, являются потенциальными кандидатами на роль цифровых устройств. Однако точный контроль над их размерами и, следовательно, электронными свойствами представляет собой сложную задачу, и ленты обычно имеют неровные края, которые ухудшают их характеристики.
Алмаз
[ редактировать ]

CVD можно использовать для производства синтетического алмаза , создавая условия, необходимые для того, чтобы атомы углерода в газе осаждались на подложке в кристаллической форме. Методу CVD алмазов уделяется большое внимание в материаловедении, поскольку он открывает множество новых применений, которые ранее считались слишком дорогими. Рост алмазов CVD обычно происходит при низком давлении (1–27 кПа ; 0,145–3,926 фунтов на квадратный дюйм ; 7,5–203 Торр ) и включает в себя подачу различного количества газов в камеру, подачу в нее энергии и обеспечение условий для роста алмазов на подложке. Газы всегда включают источник углерода и обычно также включают водород, хотя используемые количества сильно различаются в зависимости от типа выращиваемого алмаза. Источники энергии включают , среди прочего, горячую нить накала , микроволновую энергию и дуговые разряды . Источник энергии предназначен для генерации плазмы, в которой газы расщепляются и происходят более сложные химические процессы. Фактический химический процесс выращивания алмазов все еще находится в стадии изучения и осложняется очень большим разнообразием используемых процессов выращивания алмазов.
Используя CVD, пленки алмаза можно выращивать на больших площадях подложки, контролируя свойства получаемого алмаза. В прошлом, когда для производства алмазов использовались методы высокого давления и высокой температуры (HPHT), в результате обычно получались очень маленькие отдельно стоящие алмазы разных размеров. С помощью CVD-алмаза были достигнуты зоны роста диаметром более пятнадцати сантиметров (шести дюймов), и в будущем, вероятно, гораздо большие площади будут успешно покрыты алмазом. Улучшение этого процесса является ключом к созданию нескольких важных приложений.
Выращивание алмаза непосредственно на подложке позволяет придать другим материалам многие важные качества алмаза. Поскольку алмаз обладает самой высокой теплопроводностью среди всех объемных материалов, нанесение слоя алмаза на электронику с высоким тепловыделением (например, оптику и транзисторы) позволяет использовать алмаз в качестве теплоотвода. [ 33 ] [ 34 ] Алмазные пленки выращиваются на кольцах клапанов, режущих инструментах и других предметах, преимущества которых заключаются в твердости алмаза и чрезвычайно низкой скорости износа. В каждом случае рост алмаза должен производиться осторожно, чтобы добиться необходимой адгезии к подложке. Очень высокая устойчивость к царапинам и теплопроводность алмаза в сочетании с более низким коэффициентом теплового расширения , чем у стекла Pyrex , коэффициентом трения, близким к коэффициенту тефлона ( политетрафторэтилена ), и сильной липофильностью делают его почти идеальным антипригарным покрытием для посуды большого размера. области подложки могут быть покрыты экономично.
CVD-рост позволяет контролировать свойства получаемого алмаза. В области выращивания алмазов слово «алмаз» используется для описания любого материала, состоящего в основном из углерода с sp3-связями , и сюда входит множество различных типов алмазов. Регулируя параметры обработки — особенно вводимые газы, а также давление, под которым работает система, температуру алмаза и метод генерации плазмы — можно создать множество различных материалов, которые можно считать алмазами. Монокристаллический алмаз может быть изготовлен с использованием различных легирующих добавок . [ 35 ] поликристаллический алмаз с размером зерен от нескольких нанометров до нескольких микрометров . Можно вырастить [ 33 ] [ 36 ] Некоторые зерна поликристаллического алмаза окружены тонким неалмазным углеродом, а другие — нет. Эти различные факторы влияют на твердость, гладкость, проводимость, оптические свойства алмаза и многое другое.
Халькогениды
[ редактировать ]С коммерческой точки зрения теллурид ртути-кадмия представляет постоянный интерес для обнаружения инфракрасного излучения. Этот материал, состоящий из сплава CdTe и HgTe, может быть получен из диметилпроизводных соответствующих элементов.
См. также
[ редактировать ]- Аполлон Даймонд
- Пузырьковый цилиндр
- Карбонильная металлургия
- Электростатическое распыление методом осаждения из паровой фазы
- Элемент Шесть
- Ионное покрытие
- Металлоорганическая парофазная эпитаксия
- Виртуальная метрология
- Лиза МакЭлви-Уайт
- Список предшественников металлоорганических химических осаждений из паровой фазы
- Список производителей синтетических алмазов
Ссылки
[ редактировать ]- ^ Садри, Рад (15 января 2021 г.). «Контролируемые физические свойства и механизм роста наностержней силицида марганца» . Журнал сплавов и соединений . 851 : 156693. doi : 10.1016/j.jallcom.2020.156693 . S2CID 224922987 .
- ^ «Химическое осаждение из паровой фазы под низким давлением – технология и оборудование» . Кристек Технолоджи Трейдинг ГмбХ.
- ^ Шариф, Айова; Рублофф, Г.В.; Андерле, М.; Гилл, Западная Нью-Йорк; Котт, Дж.; Ким, Д.Х. (1 июля 1995 г.). «Субатмосферное химическое осаждение из паровой фазы озоном/ТЭОС для заполнения траншей SiO 2 ». Журнал вакуумной науки и технологий B: Микроэлектроника и обработка, измерение и явления нанометровых структур . 13 (4): 1888–1892. Бибкод : 1995JVSTB..13.1888S . дои : 10.1116/1.587830 . ISSN 1071-1023 .
- ^ Crystec Technology Trading GmbH, Плазменное химическое осаждение из паровой фазы – технологии и оборудование
- ^ Таварес, Джейсон; Суонсон, Э.Дж.; Куломб, С. (2008). «Плазменный синтез металлических наночастиц с покрытием, свойства поверхности которых адаптированы для диспергирования». Плазменные процессы и полимеры . 5 (8): 759. doi : 10.1002/ppap.200800074 .
- ^ Шропп, РЭИ; Б. Станновский; А. М. Брокгоф; ПАТТ ван Венендал; Дж. К. Рат. «CVD с горячей проволокой гетерогенных и поликристаллических кремниевых полупроводниковых тонких пленок для применения в тонкопленочных транзисторах и солнечных элементах» (PDF) . Физика материалов и механика . стр. 73–82. Архивировано (PDF) из оригинала 15 февраля 2005 г.
- ^ Глисон, Карен К.; Кеннет К.С. Лау; Джеффри А. Колфилд (2000). «Структура и морфология фторуглеродных пленок, выращенных методом химического осаждения из паровой фазы с горячим волокном». Химия материалов . 12 (10): 3032. doi : 10.1021/cm000499w . S2CID 96618488 .
- ^ Дорваль Дион, Калифорния; Таварес, младший (2013). «Фотоинициируемое химическое осаждение из паровой фазы как масштабируемая технология функционализации частиц (практический обзор)» (PDF) . Порошковая технология . 239 : 484–491. дои : 10.1016/j.powtec.2013.02.024 .
- ^ Валь, Георг и др. (2000) «Тонкие пленки» в Энциклопедии промышленной химии Ульмана , Wiley-VCH, Вайнхайм. два : 10.1002/14356007.a26_681
- ^ Глисон, Карен; Айше Асатекин; Майлз К. Барр; Самаан Х. Баксамуса; Кеннет К.С. Лау; Вятт Тенхаефф; Цзинцзин Сюй (май 2010 г.). «Проектирование полимерных поверхностей методом осаждения из паровой фазы» . Материалы сегодня . 13 (5): 26–33. дои : 10.1016/S1369-7021(10)70081-X . hdl : 1721.1/88187 .
- ^ Стассен, Я; Стайлз, М; Гренци, Дж; Ван Горп, Х; Вандерлинден, В; Де Фейтер, С; Фалькаро, П; Де Вос, Д; Верикекен, П; Амелут, Р. (2015). «Химическое осаждение тонких пленок каркаса из цеолитового имидазолата» . Природные материалы . 15 (3): 304–10. Бибкод : 2016NatMa..15..304S . дои : 10.1038/nmat4509 . ПМИД 26657328 .
- ^ Круз, А.; Стассен, И.; Кристаб, М.; Маркоэн, К.; Стассин Т.; Родригес-Эрмида, С.; Тейсандье, Дж.; Плетинкс, С.; Вербеке, Р.; Рубио-Хименес, В.; Папа, С.; Марти-Гастальдо, К.; Меершаут, Дж.; Верикекен, премьер-министр; Де Фейтер, С.; Хауфман, Т.; Амелут, Р. (2019). «Интегрированный процесс в чистых помещениях для осаждения из паровой фазы тонких пленок цеолитового имидазолатного каркаса большой площади» . Химия материалов . 31 (22): 9462–9471. doi : 10.1021/acs.chemmater.9b03435 . hdl : 10550/74201 . S2CID 208737085 .
- ^ Серви, Амелия Т.; Гильен-Бурьеза, Елена; Варсингер, Дэвид М.; Ливернуа, Уильям; Нотаранжело, Кэти; Харраз, Джихад; Линхард В., Джон Х.; Арафат, Хасан А.; Глисон, Карен К. (2017). «Влияние толщины и конформности пленки iCVD на проницаемость и смачивание мембран MD» (PDF) . Журнал мембранной науки . 523 : 470–479. дои : 10.1016/j.memsci.2016.10.008 . hdl : 1721.1/108260 . ISSN 0376-7388 . S2CID 4225384 . Архивировано (PDF) из оригинала 23 июля 2018 г.
- ^ Зиммлер, В. «Неорганические соединения кремния». Энциклопедия промышленной химии Ульмана . Вайнхайм: Wiley-VCH. дои : 10.1002/14356007.a24_001 . ISBN 978-3527306732 .
- ^ Материалы Третьего Всемирного конгресса химической инженерии, Токио, с. 290 (1986)
- ^ Цао, Гочжун; Ван, Ин (2011). Наноструктуры и наноматериалы - синтез, свойства и применение . Мировое научное издательство. п. 248. дои : 10.1142/7885 . ISBN 978-981-4322-50-8 .
- ^ Сзе, С.М. (2008). Полупроводниковые приборы: физика и технология . Вили-Индия. п. 384. ИСБН 978-81-265-1681-0 .
- ^ «Семейство продуктов ALTUS» . Ламские исследования . Проверено 21 апреля 2021 г.
- ^ «Химическое осаждение из паровой фазы — обзор | Темы ScienceDirect» . www.sciencedirect.com . Проверено 20 октября 2022 г.
- ^ Маруяма, Тосиро (1994). «Электрохромные свойства тонких пленок оксида ниобия, полученных методом химического осаждения из паровой фазы». Журнал Электрохимического общества . 141 (10): 2868–2871. Бибкод : 1994JElS..141.2868M . дои : 10.1149/1.2059247 .
- ^ Рахту, Антти (2002). Атомно-слоевое осаждение оксидов с высокой диэлектрической проницаемостью: рост пленки и исследования in situ (Диссертация). Университет Хельсинки. hdl : 10138/21065 . ISBN 952-10-0646-3 .
- ^ Перейти обратно: а б с д и Лю, Чжучен; Ты, Чжицян; Ли, Юнфэн; Ян, Фань; Хан, Шуан; Ян, Ван; Чжан, Лицян; Ван, Банда; Сюй, Чуньмин (01 мая 2014 г.). «Синтез трехмерного графена из нефтяного асфальта методом химического осаждения из паровой фазы». Материалы писем . 122 : 285–288. дои : 10.1016/j.matlet.2014.02.077 .
- ^ Пак, Хе Джин; Мейер, Янник; Рот, Зигмар; Скакалова, Виера (весна 2010 г.). «Рост и свойства многослойного графена, полученного методом химического осаждения из паровой фазы». Карбон . 48 (4): 1088–1094. arXiv : 0910.5841 . doi : 10.1016/j.carbon.2009.11.030 . ISSN 0008-6223 . S2CID 15891662 .
- ^ Вэй, Даченг; Лу, Юнхао; Хан, Ченг; Ню, Тяньчао; Чен, Вэй; Ви, Эндрю Тай Шен (31 октября 2013 г.). «Критический рост кристаллов графена на диэлектрических подложках при низкой температуре для электронных устройств». Ангеванде Хеми . 125 (52): 14371–14376. Бибкод : 2013AngCh.12514371W . дои : 10.1002/ange.201306086 . ISSN 0044-8249 . ПМИД 24173776 .
- ^ Чен, Цзяньи; Го, Юньлун; Вэнь, Югэн; Хуан, Липин; Сюэ, Юньчжоу; Гэн, Дечао; Ву, Бин; Ло, Биронг; Ю, Гуй (14 февраля 2013 г.). «Графен: двухстадийный рост высококачественных поликристаллических графеновых пленок без использования металлических катализаторов на подложках из нитрида кремния (Adv. Mater. 7/2013)» . Продвинутые материалы . 25 (7): 992–997. Бибкод : 2013AdM....25..938C . дои : 10.1002/adma.201370040 . ISSN 0935-9648 .
- ^ Перейти обратно: а б с д и Патель, Раджен Б.; Ю, Чи; Чжоу, Цэнмин; Икбал, Зафар (2014). «Новый путь синтеза графена с использованием наночастиц железа». Журнал исследования материалов . 29 (14): 1522–1527. Бибкод : 2014JMatR..29.1522P . дои : 10.1557/jmr.2014.165 . S2CID 137786071 .
- ^ Перейти обратно: а б Мураками, Кацухиса; Танака, Сюнсукэ; Хирукава, Аяка; Хияма, Такаки; Кувадзима, Томоя; Кано, Эмили; Такегучи, Масаки; Фудзита, Дзюнъити (2015). «Прямой синтез графена большой площади на изолирующей подложке путем химического осаждения из паровой фазы галлия». Письма по прикладной физике . 106 (9): 093112. Бибкод : 2015ApPhL.106i3112M . дои : 10.1063/1.4914114 .
- ^ Тан, Шуцзе; Ван, Хаоминь; Ван, Хуэйшань (2015). «Быстрый рост крупного монокристаллического графена на гексагональном нитриде бора, катализируемый силаном» . Природные коммуникации . 6 : 6499. arXiv : 1503.02806 . Бибкод : 2015NatCo...6.6499T . дои : 10.1038/ncomms7499 . ПМЦ 4382696 . ПМИД 25757864 .
- ^ Перейти обратно: а б с Чжан, ЦаньКунь; Чжао, Чжицзюань; Чжань, Линьцзе; Цай, ВэйВэй (05 сентября 2015 г.) «CVD-синтез графена, легированного азотом, с использованием мочевины» . Механика и астрономия . 58 (10): 107801. Бибкод : 2015SCPMA..58.7801Z , doi : /s11433-015-5717-0 . S2CID 101408264 10.1007
- ^ Перейти обратно: а б с Ким, Сан-Мин; Ким, Джэ Хён; Ким, Кван Соп; Хванбо, Юн; Юн, Чон Хёк; Ли, Ын-Гю; Рю, Джечоль; Ли, Хак-Джу; Чо, Сынмин (2014). «Синтез CVD-графена на быстронагретой медной фольге». Наномасштаб . 6 (9): 4728–34. Бибкод : 2014Nanos...6.4728K . дои : 10.1039/c3nr06434d . ПМИД 24658264 . S2CID 5241809 .
- ^ Дас, Шантану; Друкер, Джефф (2017). «Зародышеобразование и рост однослойного графена на электроосажденной меди методом химического осаждения из паровой фазы с холодной стенкой» . Нанотехнологии . 28 (10): 105601. Бибкод : 2017Nanot..28j5601D . дои : 10.1088/1361-6528/aa593b . ПМИД 28084218 . S2CID 13407439 .
- ^ Дас, Шантану; Друкер, Джефф (28 мая 2018 г.). «Масштабирование размеров графеновых островков перед слиянием». Журнал прикладной физики . 123 (20): 205306. Бибкод : 2018JAP...123t5306D . дои : 10.1063/1.5021341 . S2CID 126154018 .
- ^ Перейти обратно: а б Костелло, М; Тосселл, Д; Рис, Д; Брайерли, К; Сэвидж, Дж (1994). «Алмазные защитные покрытия для оптических компонентов». Алмаз и родственные материалы . 3 (8): 1137–1141. Бибкод : 1994DRM.....3.1137C . дои : 10.1016/0925-9635(94)90108-2 .
- ^ Сунь Ли, Ун; Ю, Джин (2005). «Сравнительное исследование теплопроводящих наполнителей подзаливок электронных компонентов». Алмаз и родственные материалы . 14 (10): 1647–1653. Бибкод : 2005DRM....14.1647S . дои : 10.1016/j.diamond.2005.05.008 .
- ^ Исберг, Дж (2004). «Монокристаллический алмаз для электронного применения» . Алмаз и родственные материалы . 13 (2): 320–324. Бибкод : 2004DRM....13..320I . дои : 10.1016/j.diamond.2003.10.017 .
- ^ Краусс, А (2001). «Ультрананокристаллические алмазные тонкие пленки для МЭМС и движущихся механических сборочных устройств». Алмаз и родственные материалы . 10 (11): 1952–1961. Бибкод : 2001DRM....10.1952K . дои : 10.1016/S0925-9635(01)00385-5 .
Дальнейшее чтение
[ редактировать ]- Джагер, Ричард К. (2002). «Кинодепонирование». Введение в производство микроэлектроники (2-е изд.). Река Аппер-Седл: Прентис-Холл. ISBN 978-0-201-44494-0 .
- Смит, Дональд (1995). Нанесение тонких пленок: принципы и практика . МакГроу-Хилл. ISBN 978-0-07-058502-7 .
- Добкин и Зурав (2003). Принципы химического осаждения из паровой фазы . Клювер. ISBN 978-1-4020-1248-8 .
- Окада К. (2007). «Плазменно-химическое осаждение из паровой фазы нанокристаллического алмаза» Науч. Технол. Адв. Матер. 8, 624 обзор для бесплатного скачивания
- Лю Т., Раабе Д. и Цефферер С. (2008). «3D-томографический EBSD-анализ тонкой алмазной пленки CVD» Sci. Технол. Адв. Матер. 9 (2008) 035013 скачать бесплатно
- Дикий, Кристоф (2008). CVD Diamond «Свойства и полезная формула» Буклет CVD Diamond PDF для бесплатной загрузки
- Хесс, Деннис В. (1988). Химическое осаждение диэлектриков и металлических пленок из паровой фазы. Архивировано 1 августа 2013 г. в Wayback Machine . Бесплатная загрузка с сайта Electronic Materials and Processing: Proceedings of the First Electronic Materials and Processing Congress, состоявшегося в рамках Всемирного конгресса материалов 1988 г., Чикаго, Иллинойс, США, 24–30 сентября 1988 г., под редакцией Прабджита Сингха (при поддержке Electronic Materials and Processing). Перерабатывающее подразделение ASM International).