Отражение высокоэнергетическая дифракция электронов
Отражение высокоэнергетической дифракции электронов ( RHEED )-это метод, используемый для характеристики поверхности кристаллических материалов. Системы RHEED собирают информацию только от поверхностного слоя образца, который отличает RHEED от других методов характеристики материалов , которые также основаны на дифракции высокоэнергетических электронов . Электронная микроскопия прохождения , еще одна общая дифракционная дифракционная выборка электронов , в основном основная часть образца из -за геометрии системы, хотя в особых случаях она может предоставить поверхностную информацию. Дифракция электронов с низким энергопотреблением (LEED) также чувствительна к поверхности, но LEED достигает чувствительности поверхности за счет использования электронов с низкой энергией.
Введение
[ редактировать ]Система RHEED требует источника электрона (пистолета), экрана фотолюминесцентного детектора и образец с чистой поверхностью, хотя современные системы RHEED имеют дополнительные детали для оптимизации техники. [ 1 ] [ 2 ] Электронный пистолет генерирует луч из электронов, которые ударяют образец под очень маленьким углом по сравнению с поверхностью образца. Падающие электроны дифракуруют от атомов на поверхности образца, и небольшая доля дифрагированных электронов конструктивно мешает определенным углам и образует регулярные паттерны на детекторе. Электроны мешают в зависимости от положения атомов на поверхности образца, поэтому дифракционная картина в детекторе является функцией поверхности образца. На рисунке 1 показана самая основная настройка системы RHEED.
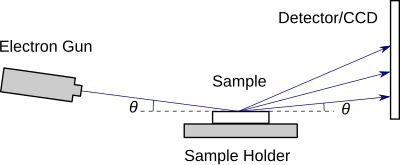
Поверхностная дифракция
[ редактировать ]В установке RHEED только атомы на поверхности образца способствуют схеме RHEED. [ 3 ] Угол срока действия падающих электронов позволяет им избежать основной части образца и добраться до детектора. Атомы на поверхностной дифраке образца (разбросаны) падающие электроны из -за волновых свойств электронов.
Дифрагированные электроны конструктивно вмешиваются под определенные углы в соответствии с кристаллической структурой и расстоянием атомов на поверхности образца и длине волны падающих электронов. Некоторые из электронных волн, созданных конструктивным интерференционным столкновением с детектором, создавая определенные дифракционные паттерны в соответствии с поверхностными характеристиками образца. Пользователи характеризуют кристаллографию поверхности образца посредством анализа дифракционных паттернов. На рисунке 2 показан рисунок RHEED. Видео 1 изображает метрологический инструмент, регистрирующий колебания интенсивности RHEED и скорость осаждения для контроля и анализа процесса.

Два типа дифракции способствуют узорам RHEED. Некоторые падающие электроны подвергаются одному, эластичному событию рассеяния на поверхности кристалла, процесс, называемый кинематическим рассеянием. [ 1 ] Динамическое рассеяние происходит, когда электроны подвергаются множеству дифракционных событий в кристалле и теряют часть своей энергии из -за взаимодействия с образцом. [ 1 ] Пользователи извлекают не квалитирующие данные из кинематических дифрагированных электронов. Эти электроны учитывают пятна с высокой интенсивностью или кольца, общие для рисунков. Пользователи RHEED также анализируют динамически рассеянные электроны со сложными методами и моделями для сбора количественной информации из шаблонов RHEED. [ 3 ]
Кинематический анализ рассеяния
[ редактировать ]Пользователи RHEED строили сферы Эвальда , чтобы найти кристаллографические свойства поверхности образца. Сферы Эвальда показывают допустимые дифракционные условия для кинематически рассеянных электронов в заданной настройке RHEED. Дифракционная картина на экране относится к геометрии сферы Эвальда, поэтому пользователи RHEED могут напрямую рассчитать взаимную решетку образца с помощью рисунка RHEED, энергии падающих электронов и расстояния от детектора до образца. Пользователь должен связывать геометрию и расстояние пятен идеального рисунка с сферой Эвальда, чтобы определить взаимную решетку поверхности образца.
Анализ сферы Ewald's аналогичен сведению для объемных кристаллов, однако взаимная решетка для образца отличается от того, что для трехмерного материала из -за чувствительности поверхности процесса RHEED. Взаимные решетки массовых кристаллов состоят из набора точек в трехмерном пространстве. Тем не менее, только первые несколько слоев материала способствуют дифракции в RHEED, поэтому в измерении нет условий дифракции, перпендикулярной поверхности образца. Из -за отсутствия состояния третьей дифрагирования обратная решетка на поверхности кристаллической поверхности представляет собой серию бесконечных стержней, простирающихся перпендикулярной поверхности образца. [ 4 ] Эти стержни происходят в обычных 2D -взаимных точках решетки поверхности образца.
Сфера Эвальда сосредоточена на поверхности образца с радиусом, равным величине волнового вектора падающих электронов,
где λ - длина волны De Broglie .

Дифракционные условия удовлетворяются там, где стержни взаимной решетки пересекают сферу Эвальда. Следовательно, величина вектора от происхождения сферы Эвальда до пересечения любых взаимных решетчатых стержней равна по величине к величине падающего луча. Это выражается как
(2)
Здесь K HL является волновым вектором эластически дифрагированных электронов порядка (HL) на любом пересечении взаимных решетчатых стержней со сферой Эвальда
Проекции двух векторов на плоскость поверхности образца отличаются от взаимного вектора решетки G HL ,
(3)
На рисунке 3 показана конструкция сферы Эвальда и приводит примеры G, K HL и K I. векторов
Многие из взаимных решетчатых стержней соответствуют дифракционному состоянию, однако система RHEED разработана таким образом, что на детекторе приходят только низкие порядки дифракции. Образец RHEED в детекторе представляет собой проекцию только k векторов, которые находятся в угловом диапазоне, которые содержат детектор. Размер и положение детектора определяют, какой из дифрагированных электронов находится внутри углового диапазона, который достигает детектора, поэтому геометрия рисунка RHEED может быть связана обратно с геометрией взаимной решетки поверхности образца с помощью использования тригонометрических отношений и расстояние от образца до детектора.
Векторы K помечены так, что вектор K00, который образует наименьший угол с поверхностью образца, называется луча 0 -го порядка. [ 3 ] Луч 0 -го порядка также известен как зеркальный луч. Каждое последовательное пересечение стержня и сферы дальше от поверхности образца помечено как отражение более высокого порядка. Из -за того, как расположен центр сферы Эвальда, зеркальный луч образует тот же угол с подложкой, что и падающий электронный луч. Зеркальная точка имеет наибольшую интенсивность на рисунке RHEED и помечена как (00) точка по соглашению. [ 3 ] Другие точки на рисунке RHEED индексируются в соответствии с порядком отражения, который они проецируют.
Радиус сферы Эвальда намного больше, чем расстояние между взаимными решетчатыми стержнями, потому что падающая луч имеет очень короткую длину волны из-за его высокоэнергетических электронов. Ряды взаимных решетчатых стержней фактически пересекают сферу Эвальда в качестве приблизительной плоскости, потому что идентичные ряды параллельных взаимных решетчатых стержней расположены непосредственно спереди и позади одного ряда. [ 1 ] На рисунке 3 показан поперечный вид с одной строкой взаимных решетчатых стержней, заполненных условиями дифракции. Взаимные решетки на рисунке 3 показывают конец этих плоскостей, которые перпендикулярны экрану компьютера на рисунке.
Пересечения этих эффективных плоскостей с сферой Эвальда образуют круги, называемые кругами Laue. Узор RHEED представляет собой набор точек по периметрам концентрических кругов LAUE вокруг центральной точки. Тем не менее, эффекты интерференции между дифрагированными электронами все еще дают сильные интенсивности в отдельных точках на каждом круге Laue. На рисунке 4 показано пересечение одного из этих плоскостей с сферой Эвальда.

Азимутальный угол влияет на геометрию и интенсивность рисунков RHEED. [ 4 ] Азимутальный угол - это угол, при котором падающие электроны пересекают упорядоченную кристаллическую решетку на поверхности образца. Большинство систем RHEED оснащены держателем образца, который может вращать кристалл вокруг оси, перпендикулярной поверхности образца. Пользователи RHEED вращают образец, чтобы оптимизировать профили интенсивности шаблонов. Пользователи, как правило, индексируют как минимум 2 сканирования RHEED под разными углами азимута для надежной характеристики структуры поверхности кристалла. [ 4 ] На рисунке 5 показана схематическая диаграмма электронного луча, падающего на образец под разными азимутальными углами.

Пользователи иногда поворачивают образец вокруг оси, перпендикулярной поверхности отбора проб во время экспериментов RHEED, чтобы создать рисунок RHEED, называемый азимутальным графиком. [ 4 ] Вращение образца изменяет интенсивность дифрагированных балок из -за их зависимости от угла азимута. [ 5 ] Специалисты RHEED характеризуют морфологию пленки путем измерения изменений интенсивности луча и сравнения этих изменений с теоретическими расчетами, которые могут эффективно моделировать зависимость интенсивности дифрагированных пучков от угла азимута. [ 5 ]
Анализ динамического рассеяния
[ редактировать ]Динамически или неластично рассеянные электроны также предоставляют несколько типов информации о образце. Яркость или интенсивность в точке детектора зависит от динамического рассеяния, поэтому весь анализ, включающий интенсивность, должен учитывать динамическое рассеяние. [ 1 ] [ 3 ] Некоторые неластически рассеянные электроны проникают в объемный кристалл и выполняют дифракционные условия Брэгга. Эти неластично рассеянные электроны могут достичь детектора с учетом дифракционных схем кикучи, которые полезны для расчета условий дифракции. [ 3 ] Паттерны кикучи характеризуются линиями, соединяющими интенсивные точки дифракции на рисунке RHEED. На рисунке 6 показан рисунок RHEED с видимыми линиями кикучи .

Требования к системе RHEED
[ редактировать ]Электронный пистолет
[ редактировать ]Электронный пистолет является одним из самых важных оборудования в системе RHEED. [ 1 ] Пистолет ограничивает пределы разрешения и тестирования системы. Вольфрамовые филаменты являются основным источником электронов для электронного пистолета большинства систем RHEED из -за низкой работы вольфрама. В типичной установке вольфрамовая нить представляет собой катод, а положительно смещенный анод вытягивает электроны от кончика вольфрамовой нити. [ 1 ]
Величина смещения анода определяет энергию падающих электронов. Оптимальное смещение анода зависит от типа желаемой информации. При больших углах падения электроны с высокой энергией могут проникнуть на поверхность образца и ухудшить чувствительность поверхности прибора. [ 1 ] Тем не менее, размеры зон Laue пропорциональны обратному квадрату энергии электрона, что означает, что у детектора больше записывается дополнительная информация при более высоких энергиях электронов. [ 1 ] Для общей характеристики поверхности электронный пистолет управляет диапазоном 10-30 кэВ. [ 3 ]
В типичной установке RHEED одно магнитное и одно электрическое поле фокусируют падающую луч электронов. [ 1 ] Негативно смещенный электрод Wehnelt, расположенный между катодной нити, и анодом применяет небольшое электрическое поле, которое фокусирует электроны при прохождении через анод. Регулируемая магнитная линза фокусирует электроны на поверхности образца после того, как они проходят через анод. Типичный источник RHEED имеет фокусное расстояние около 50 см. [ 3 ] Луч сосредоточен на максимально маленькой точке на детекторе, а не на поверхности образца, так что дифракционная картина имеет наилучшее разрешение. [ 1 ]
Экраны фосфора, которые демонстрируют фотолюминесценцию, широко используются в качестве детекторов. Эти детекторы испускают зеленый свет из областей, где электроны попадают на их поверхность и также являются общими для ПЭМ. Экран детектора полезен для выравнивания шаблона с оптимальной позицией и интенсивностью. Камеры CCD захватывают шаблоны, чтобы обеспечить цифровой анализ.
Поверхность образца
[ редактировать ]Поверхность образца должна быть чрезвычайно чистой для эффективных экспериментов RHEED. Загрязняющие вещества на поверхности образца мешают электронному лучу и разлагают качество рисунка RHEED. Пользователи RHEED используют два основных метода для создания чистых поверхностей образцов. Небольшие образцы могут быть расщеплены в вакуумной камере до анализа RHEED. [ 6 ] Недавно обнаженная, расщепленная поверхность анализируется. Большие образцы или те, которые не могут быть расщеплены до анализа RHEED, могут быть покрыты пассивным оксидным слоем до анализа. [ 6 ] Последующая термообработка под вакуумом камеры RHEED удаляет слой оксида и обнажает чистую поверхность образца.
Вакуумные требования
[ редактировать ]Поскольку молекулы газа дифракт электронов и влияют на качество электронного пистолета, эксперименты RHEED проводятся в вакууме. Система RHEED должна работать при давлении, достаточно низком, чтобы предотвратить значительное рассеяние электронных балок молекулами газа в камере. При энергии электронов 10 кэВ, давление камеры 10 −5 MBAR или ниже необходимы для предотвращения значительного рассеяния электронов по фоновым газам. [ 6 ] На практике системы RHEED эксплуатируются под ультра -высокими вакуумами. Давление камеры сводит к минимуму как можно больше, чтобы оптимизировать процесс. Условия вакуума ограничивают типы материалов и процессов, которые можно контролировать in situ с помощью RHEED.
Rheed Patterns of Real Surfaces
[ редактировать ]Предыдущий анализ был сосредоточен только на дифракции от совершенно плоской поверхности кристаллической поверхности. Тем не менее, поверхности, не являющиеся флат, добавляют дополнительные дифракционные условия в анализ RHEED.
Странированные или удлиненные пятна являются общими для узоров RHEED. Как показано на рис. Падающий электронный луч расходится, а электроны в луче имеют диапазон энергий, поэтому на практике сфера Эвальда не является бесконечно тонкой, поскольку она теоретически смоделирована. Взаимные решетки также имеют конечную толщину, а их диаметры зависят от качества поверхности образца. Полосы появляются вместо идеальных точек, когда расширенные стержни пересекают сферу Эвальда. Условия дифракции выполняются по всему пересечению стержней с сферой, давая удлиненные точки или «полосы» вдоль вертикальной оси рисунка RHEED. В реальных случаях полосатые паттерны RHEED указывают на плоскую поверхность образца, в то время как расширение полос указывает на небольшую площадь когерентности на поверхности.

Поверхностные особенности и поликристаллические поверхности добавляют сложность или изменяют узоры RHEED от идеально плоских поверхностей. Растущие пленки, зародышевые частицы, кристалл -близнецы, зерна различного размера и адсорбированные виды добавляют сложные дифракционные условия к идеальной поверхности. [ 7 ] [ 8 ] Наложенные паттерны субстрата и гетерогенных материалов, сложные интерференционные паттерны и деградация разрешения характерны для сложных поверхностей или, частично покрытых гетерогенными материалами.
Специализированные методы RHEED
[ редактировать ]Рост фильма
[ редактировать ]Rheed - чрезвычайно популярный метод для мониторинга роста тонких пленок. В частности, RHEED хорошо подходит для использования с эпитаксией молекулярной луча (MBE), процессом, используемым для формирования высококачественных тонких пленок ультрачистики, в условиях роста сверхвысокого вакуума. [ 9 ] Интенсивность отдельных пятен на рисунке RHEED периодически колеблется в результате относительного поверхностного покрытия растущей тонкой пленки. На рисунке 8 показан пример интенсивности, колеблющейся в одной точке RHEED во время роста MBE.

Каждый полный период соответствует образованию тонкой пленки одного атомного слоя. Период колебаний сильно зависит от материальной системы, энергии электронов и угла инцидента, поэтому исследователи получают эмпирические данные для корреляции колебаний интенсивности и освещения пленки перед использованием RHEED для мониторинга роста пленки. [ 6 ]
Видео 1 изображает метрологический инструмент, регистрирующий колебания интенсивности RHEED и скорость осаждения для контроля и анализа процесса.
RHEED-TRAXS
[ редактировать ]Отражение Электронная дифракция высокой энергии - рентгеновская спектроскопия общего угла отражения является методом мониторинга химического состава кристаллов. [ 10 ] Rheed-Traxs анализирует рентгеновские спектральные линии, испускаемые из кристалла в результате электронов из ружья, сталкивающихся с поверхностью.
RHEED-TRAXS является преимущественным для рентгеновского микроанализа (XMA) (например, EDS и WDS ), потому что угол падения электронов на поверхности очень мал, как правило, менее 5 °. В результате электроны не проникают глубоко в кристалл, что означает, что рентгеновское излучение ограничено верхней частью кристалла, что позволяет контролировать поверхностную стехиометрию в реальном времени.
Экспериментальная установка довольно проста. Электроны запускаются в образцы, вызывая рентгеновский излучение. Эти рентгеновские снимки затем обнаруживаются с использованием кристалла кремния - лития Si-Li, расположенного за бериллиевыми окнами, используемым для поддержания вакуума.
MCP-RHEED
[ редактировать ]MCP-RHEED-это система, в которой электронный луч усиливается микроканальной пластиной (MCP). Эта система состоит из электронного пистолета и MCP, оснащенного люминесцентным экраном, напротив электронного пистолета. Из -за усиления интенсивность электронного луча может быть уменьшена на несколько порядков, а повреждение образцов уменьшается. Этот метод используется для наблюдения за ростом кристаллов изолятора, таких как органические пленки и щелочные галогенидные пленки, которые легко повреждены электронными лучами. [ 11 ]
Ссылки
[ редактировать ]- ^ Jump up to: а беременный в дюймовый и фон глин час я Дж k Ichimiya A & Cohen Pi (2004). Отражение высокая энергия дифракция электронов . Издательство Кембриджского университета: Кембридж, Великобритания. С. 1, 13, 16, 98, 130, 161. ISBN 0-521-45373-9 .
- ^ Horio y; Hashimoto Y & Ichimaya A (1996). «Новый тип Rheed Apparatus, оснащенный энергией фильтра». Приложение Серфинг Наука 100 : 292–6. Bibcode : 1996Pss..100..292H . doi : 10.1016/0169-4332 (96) 00229-2 .
- ^ Jump up to: а беременный в дюймовый и фон глин час Браун В. (1999). Применяемый RHEED: Отражение Высокоэнергетическая дифракция электронов во время роста кристаллов . Springer-Verlag: Берлин. с. 14–17, 25, 75. ISBN 3-540-65199-3 .
- ^ Jump up to: а беременный в дюймовый Наш k; LifeShits VG; Саранин Аа; Zotov Av & Taymama M (2001). Наука на поверхности: введение Springer-Verlag: Берлин. Стр. 59–6 ISBN 3-540-00545-5 .
- ^ Jump up to: а беременный Mitura Z & Maksym PA (1993). «Анализ рефлексии высокой энергии дифракционных дифракционных графиков». Физический Преподобный Летт 70 (19): 2904–2907. Bibcode : 1993 phrvl..70.2904m . doi : 10.1103/physrevlett.70.2904 . PMID 10053683 .
- ^ Jump up to: а беременный в дюймовый Добсон П.Дж. (1988). Хауи А; Вальдре У (ред.). Характеристика поверхности и интерфейса с помощью электронных оптических методов . Plenum Press: Нью -Йорк. С. 159–193. ISBN 0-306-43086-х .
- ^ Бозович я; Eckstein Jn & Bozovic N (2001). Auceillo O & Krauss AR (ред.). в реальном времени Характеристика жестяных фильмов Джон Уилл и сыновья: Нью -Йорк. Стр. 29–5 ISBN 0-471-24141-5 .
- ^ Brewer RT; Хартман JW; Groves Jr; Арендт Пн; Yashar PC & Atwater HA (2001). «Анализ кривой качания в плоскости в двухходовой текстурированной поликристаллических пленках MGO на аморфных субстратах, выращенных при осаждении с помощью ионного луча». Приложение Серфинг Наука 175 (1–2): 691–696. Bibcode : 2001Apss..175..691b . doi : 10.1016/s0169-4332 (01) 00106-4 .
- ^ Atwater ha; Ahn cc; Wong SS; Он g; Yoshino H & Nikzad S (1997). «Энергосветающий рид и катушки для анализа в реальном времени in situ во время роста фильмов». Серфинг Преподобный Летт 4 (3): 525. Bibcode : 1997srl ..... 4..525a . doi : 10.1142/s0218625x9700050x .
- ^ Хасегава, Шуджи; Ино, Шозо; Ямамото, Юити; Даймон, Хироши (1985). «Химический анализ поверхностей с помощью рентгеновской спектроскопии с полным оборотом в экспериментах RHEED (RHEED-TRAXS)». Японский журнал прикладной физики . 24 (6): L387 - L390. Bibcode : 1985jajap..24l.387h . doi : 10.1143/jjap.24.l387 . S2CID 94132569 .
- ^ Saiki k; Kono t; Ueno K & Koma A (2000). «Высокочувствительное отражение высокоэнергетических дифракционных измерений с использованием микроканальной визуализации». Rev. Sci. Инструмент . 71 (9): 3478. Bibcode : 2000rsci ... 71.3478S . doi : 10.1063/1,1287625 . S2CID 43346059 .
Дальнейшее чтение
[ редактировать ]- Введение в Rheed, как Arrot, ультратонкие магнитные структуры I, Springer-Verlag , 1994, с. 177–220
- Обзор геометрических основ Рид с применением на кремниевые поверхности, Джон Э. Махан, Кент М. Гейб, Ги Робинсон и Роберт Г. Лонг, JVST , A 8, 1990, pp. 3692–3700



