Память с фазовым изменением
| памяти компьютера и хранения данных компьютера Типы |
|---|
| Неустойчивый |
| Энергонезависимый |
Память с фазовым изменением (также известная как PCM , PCME , PRAM , PCRAM , OUM ( овоническая унифицированная память ) и C-RAM или CRAM ( халькогенидное ОЗУ )) — это тип энергонезависимой оперативной памяти . PRAM используют уникальное поведение халькогенидного стекла . В ПКМ тепло, вырабатываемое при прохождении электрического тока через нагревательный элемент, обычно изготовленный из нитрида титана, используется либо для быстрого нагрева и закалки стекла, делая его аморфным , либо для удержания его в диапазоне температур кристаллизации в течение некоторого времени, тем самым переводя его в кристаллическое состояние. [ 1 ] PCM также имеет возможность достигать ряда различных промежуточных состояний, тем самым имея возможность хранить несколько битов в одной ячейке. [ 2 ] но трудности с программированием ячеек таким способом не позволили реализовать эти возможности в других технологиях (особенно во флэш-памяти ) с такими же возможностями.
Недавние исследования PCM были направлены на попытку найти жизнеспособные альтернативы материалу с фазовым переходом Ge 2 Sb 2 Te 5 (GST), но с переменным успехом. Другие исследования были сосредоточены на разработке Ge Te – Sb 2 Te 3 сверхрешетки для достижения нетепловых фазовых изменений путем изменения координационного состояния атомов германия с помощью лазерного импульса. Эта новая межфазная память с фазовым изменением (IPCM) имела много успехов и продолжает оставаться местом многих активных исследований. [ 3 ]
Леон Чуа утверждал, что все двухполюсные устройства с энергонезависимой памятью , включая PCM, следует считать мемристорами . [ 4 ] Стэн Уильямс из HP Labs также утверждал, что PCM следует считать мемристором. [ 5 ] Однако эта терминология была оспорена, и потенциальная применимость мемристорной теории к любому физически реализуемому устройству остается под вопросом. [ 6 ] [ 7 ]
Фон
[ редактировать ]В 1960-х годах Стэнфорд Р. Овшинский из Energy Conversion Devices впервые исследовал свойства халькогенидных стекол как потенциальной технологии памяти. В 1969 году Чарльз Си опубликовал диссертацию в Университете штата Айова , в которой описал и продемонстрировал возможность создания устройства памяти с фазовым изменением путем интеграции халькогенидной пленки с диодной матрицей. [ 8 ] [ 9 ] Кинематографическое исследование, проведенное в 1970 году, установило, что механизм памяти фазового перехода в халькогенидном стекле включает электрическим полем индуцированный рост кристаллических нитей, . [ 10 ] [ 11 ] В сентябрьском номере журнала Electronics за 1970 год Мур Гордон , соучредитель Intel , опубликовал статью об этой технологии. [ 12 ] Однако проблемы с качеством материалов и энергопотреблением помешали коммерциализации технологии. Совсем недавно интерес и исследования возобновились, поскольку флэш- памяти и DRAM ожидается, что технологии столкнутся с трудностями масштабирования по мере сокращения литографии чипов . [ 13 ]
Кристаллическое электросопротивления и аморфное состояния халькогенидного стекла имеют резко разные значения удельного . Аморфное состояние с высоким сопротивлением представляет собой двоичный 0, тогда как кристаллическое состояние с низким сопротивлением представляет собой 1. [ нужна ссылка ] Халькогенид — это тот же материал, который используется в перезаписываемых оптических носителях (таких как CD-RW и DVD-RW ). В этих случаях манипулируют оптическими свойствами материала, а не его удельным электрическим сопротивлением, поскольку показатель преломления халькогенида также меняется в зависимости от состояния материала.
Хотя PRAM еще не достигла стадии коммерциализации потребительских электронных устройств, почти во всех прототипах устройств используется халькогенидный сплав германия (Ge), сурьмы (Sb) и теллура (Te), называемый GeSbTe (GST). Стехиометрия . , или соотношение элементов Ge:Sb:Te, составляет 2:2:5 в GST При нагревании GST до высокой температуры (более 600 °C) его халькогенидная кристалличность теряется. После охлаждения он замерзает до аморфного стеклоподобного состояния. [ 14 ] и его электрическое сопротивление велико. Нагревая халькогенид до температуры выше точки его кристаллизации , но ниже точки плавления , он перейдет в кристаллическое состояние с гораздо меньшим сопротивлением. Время завершения этого фазового перехода зависит от температуры. Кристаллизация более холодных частей халькогенида занимает больше времени, а перегретые части могут быть переплавлены. время кристаллизации порядка 100 нс . Обычно используется [ 15 ] Это дольше, чем у обычных энергозависимых запоминающих устройств, таких как современная DRAM , время переключения которых составляет порядка двух наносекунд. Однако в патентной заявке Samsung Electronics , поданной в январе 2006 года , указывается, что время переключения PRAM может достигать пяти наносекунд.
Достижение, предпринятое в 2008 году компаниями Intel и ST Microelectronics, позволило более тщательно контролировать состояние материала, позволяя преобразовать его в одно из четырех различных состояний: предыдущие аморфные или кристаллические состояния, а также два новых частично кристаллических состояния. Каждое из этих состояний имеет разные электрические свойства, которые можно измерить во время чтения, что позволяет одной ячейке представлять два бита , что удваивает плотность памяти . [ 16 ]
Алюминий/сурьма
[ редактировать ]Устройства памяти с фазовым переходом на основе германия , сурьмы и теллура создают проблемы при производстве, поскольку травление и полировка материала халькогенами могут изменить его состав. Материалы на основе алюминия и сурьмы более термически стабильны, чем GeSbTe . Al 50 Sb 50 имеет три различных уровня сопротивления, что дает возможность хранить три бита данных в двух ячейках вместо двух (для пары ячеек возможно девять состояний, использование восьми из этих состояний дает log 2 8 = 3 бита). [ 17 ] [ 18 ]
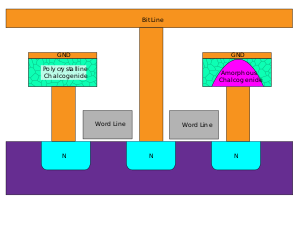
PRAM против Flash
[ редактировать ]Время переключения PRAM и присущая ей масштабируемость [ 19 ] сделайте его более привлекательным, чем флэш-память . Температурная чувствительность PRAM, пожалуй, является ее самым заметным недостатком, который может потребовать изменений в производственном процессе производителей, использующих эту технологию.
Флэш-память работает путем модуляции заряда ( электронов ), хранящегося внутри затвора МОП-транзистора . Затвор состоит из специальной «стопки», предназначенной для улавливания зарядов (либо на плавающем затворе, либо в изоляционных «ловушках» ). транзистора. Наличие заряда внутри затвора сдвигает пороговое напряжение ячейки выше или ниже, что соответствует изменению состояния бита с 1 на 0 или с 0 на 1. Изменение состояния бита требует удаления накопленного заряда, что требует относительно большого напряжения для «высасывания» электронов из плавающего затвора. Этот всплеск напряжения обеспечивается зарядовым насосом , которому требуется некоторое время для набора мощности. Общее время записи для обычных флэш-устройств составляет порядка 100 мкс (для блока данных), что примерно в 10 000 раз превышает типичное 10 нс время чтения для SRAM, например (для байта ). [ нужна ссылка ]
PRAM может обеспечить гораздо более высокую производительность в приложениях, где важна быстрая запись, как потому, что элемент памяти можно переключать быстрее, так и потому, что отдельные биты могут быть изменены на 1 или 0 без необходимости предварительного стирания всего блока ячеек. Высокая производительность PRAM, в тысячи раз превышающая скорость обычных жестких дисков , делает ее особенно интересной для энергонезависимой памяти , производительность которой в настоящее время ограничена временем доступа к памяти.
Кроме того, при использовании вспышки каждый всплеск напряжения на элементе вызывает деградацию. По мере уменьшения размера ячеек ущерб от программирования увеличивается, поскольку напряжение, необходимое для программирования устройства, не масштабируется с литографией. Большинство флэш-устройств в настоящее время рассчитано только на 5000 операций записи на сектор, и многие флэш-контроллеры выполняют выравнивание износа для распределения операций записи по множеству физических секторов.
Устройства PRAM также деградируют по мере использования по другим причинам, чем флэш-память, но деградируют гораздо медленнее. Устройство PRAM может выдержать около 100 миллионов циклов записи. [ 20 ] Срок службы PRAM ограничен такими механизмами, как деградация из-за GST теплового расширения во время программирования, миграция металла (и других материалов) и другие механизмы, которые до сих пор неизвестны.
Детали флэш-памяти можно запрограммировать перед пайкой на плату или даже приобрести предварительно запрограммированными. Однако содержимое PRAM теряется из-за высоких температур, необходимых для припайки устройства к плате (см. Пайка оплавлением или волновая пайка ). Ситуация усугублялась требованием бессвинцового производства, требующего более высоких температур пайки. Производитель, использующий детали PRAM, должен предоставить механизм для программирования PRAM «внутри системы» после ее пайки на месте.
Специальные вентили, используемые во флэш-памяти, со временем «утекают» заряд (электроны), вызывая повреждение и потерю данных. Сопротивление ; элемента памяти в PRAM более стабильно Предполагается, что при нормальной рабочей температуре 85 °C данные будут храниться в течение 300 лет. [ 21 ]
Тщательно модулируя количество заряда, хранящегося на затворе, флэш-устройства могут хранить несколько (обычно два) бита в каждой физической ячейке. По сути, это удваивает плотность памяти , снижая стоимость. Устройства PRAM изначально хранили в каждой ячейке только один бит, но недавние достижения Intel устранили эту проблему. [ нужна ссылка ]
Поскольку флэш-устройства улавливают электроны для хранения информации, они подвержены повреждению данных из-за радиации , что делает их непригодными для многих космических и военных применений. PRAM обладает более высокой устойчивостью к радиации.
В селекторах ячеек PRAM могут использоваться различные устройства: диоды , BJT и MOSFET . Использование диода или BJT обеспечивает наибольший ток для данного размера ячейки. Однако проблемы с использованием диода связаны с паразитными токами в соседних ячейках, а также с более высокими требованиями к напряжению, что приводит к более высокому энергопотреблению. Сопротивление халькогенида обязательно больше, чем сопротивление диода, а это означает, что рабочее напряжение должно значительно превышать 1 В, чтобы гарантировать достаточный ток прямого смещения от диода. Возможно, наиболее серьезным последствием использования массива с диодным выбором, особенно для больших массивов, является общий ток утечки обратного смещения из невыбранных битовых линий. В матрицах, выбранных на основе транзисторов , только выбранные битовые линии вносят вклад в ток утечки обратного смещения. Разница в токе утечки составляет несколько порядков. Еще одной проблемой при масштабировании ниже 40 нм является влияние дискретных примесей при pn-перехода уменьшении ширины . Селекторы на основе тонких пленок обеспечивают более высокую плотность, используя < 4 F. 2 область ячейки путем укладки слоев памяти по горизонтали или вертикали. Часто возможности изоляции уступают использованию транзисторов, если коэффициент включения/выключения селектора недостаточен, что ограничивает возможность работы с очень большими массивами в этой архитектуре. Пороговые переключатели на основе халькогенидов были продемонстрированы как жизнеспособный селектор для массивов PCM высокой плотности. [ 22 ]
2000 и позже
[ редактировать ]В августе 2004 года компания Nanochip лицензировала технологию PRAM для использования в устройствах хранения данных зондов MEMS (микроэлектромеханические системы). Эти устройства не являются твердотельными . Вместо этого очень маленькая пластинка, покрытая халькогенидом, протаскивается под тысячи или даже миллионы электрических зондов, которые могут считывать и записывать халькогенид. Hewlett-Packard Технология микроперемещения позволяет точно позиционировать пластину с точностью до 3 нм , поэтому плотность записи более 1 Тбит (125 ГБ ) на квадратный дюйм станет возможной, если технология будет усовершенствована. Основная идея состоит в том, чтобы уменьшить количество проводов, необходимых внутри кристалла; вместо того, чтобы подключать каждую ячейку, ячейки размещаются ближе друг к другу и считываются с помощью тока, проходящего через зонды МЭМС, действуя как провода. Этот подход напоминает IBM технологию Millipede .
Ячейка Samsung 46,7 нм
[ редактировать ]В сентябре 2006 года Samsung анонсировала прототип устройства емкостью 512 МБ (64 МБ ) с диодными переключателями. [ 23 ] Анонс стал своего рода неожиданностью, особенно он отличался достаточно высокой плотностью памяти . Прототип имел размер ячейки всего 46,7 нм, что меньше, чем у коммерческих флэш- устройств, доступных в то время. Хотя были доступны флэш-устройства большей емкости (64 ГБ или 8 ГБ только появлялись на рынке), другие технологии, конкурирующие за замену флэш-памяти, в целом предлагали меньшую плотность (большие размеры ячеек). единственные серийные устройства MRAM и FeRAM Например, имеют объем всего 4 МБ. Высокая плотность прототипа PRAM-устройства Samsung предполагала, что оно может стать жизнеспособным конкурентом флэш-памяти, а не ограничиваться нишевой ролью, как это делали другие устройства. PRAM оказалась особенно привлекательной в качестве потенциальной замены флэш-памяти NOR , емкость которой обычно отстает от NAND флэш-устройств . Современные емкости на NAND некоторое время назад перевалили за 512 Мб. Флэш-память NOR имеет плотность, аналогичную прототипу PRAM от Samsung, и уже предлагает побитовую адресацию (в отличие от NAND, где доступ к памяти осуществляется в банках по много байт за раз).
Устройство Intel PRAM
[ редактировать ]За заявлением Samsung последовало заявление от Intel и STMicroelectronics , которые продемонстрировали свои собственные устройства PRAM на форуме разработчиков Intel 2006 года в октябре. [ 24 ] Они показали деталь размером 128 МБ, производство которой началось в исследовательской лаборатории STMicroelectronics в Аграте, Италия. Intel заявила, что устройства были строго проверкой концепции .
Устройство БАЕ
[ редактировать ]PRAM также является многообещающей технологией в военной и аэрокосмической промышленности, где радиационные эффекты делают непрактичным использование стандартных энергонезависимых запоминающих устройств, таких как флэш-память. Устройства PRAM были представлены компанией BAE Systems , получившей название C-RAM, с заявленной превосходной устойчивостью к радиации ( радиационной стойкостью ) и устойчивостью к защелкам . Кроме того, BAE заявляет, что длительность цикла записи составляет 10 8 , что позволит ему стать претендентом на замену PROM и EEPROM в космических системах.
Многоуровневая ячейка
[ редактировать ]В феврале 2008 года Intel и STMicroelectronics представили первый прототип многоуровневой ( MLC ) матрицы PRAM. Прототип хранил два логических бита в каждой физической ячейке, фактически 256 МБ памяти хранилось в физическом массиве емкостью 128 МБ. Это означает, что вместо двух обычных состояний — полностью аморфного и полностью кристаллического — два дополнительных отдельных промежуточных состояния представляют собой разные степени частичной кристаллизации, что позволяет хранить вдвое больше битов в одной и той же физической области. [ 16 ] В июне 2011 года [ 25 ] IBM объявила, что создала стабильную, надежную многоразрядную память с фазовым переходом, обладающую высокой производительностью и стабильностью. У SK Hynix было соглашение о совместной разработке и технологическое лицензионное соглашение с IBM для разработки технологии многоуровневой PRAM. [ 26 ]
Устройство Intel, изготовленное по 90-нм техпроцессу
[ редактировать ]Также в феврале 2008 года Intel и STMicroelectronics отправили клиентам прототипы своего первого продукта PRAM. Продукт 90 нм, 128 МБ (16 МБ) назывался Alverstone. [ 27 ]
В июне 2009 года Samsung и Numonyx BV объявили о совместной разработке аппаратных продуктов PRAM, ориентированных на рынок. [ 28 ]
В апреле 2010 года [ 29 ] Numonyx анонсировала линейку 128-Мбитной NOR-совместимой памяти Omneo с фазовым переходом. Samsung объявила о поставке 512 МБ оперативной памяти с фазовым переходом (PRAM) в многочиповом корпусе (MCP) для использования в мобильных телефонах осенью 2010 года.
ST 28 нм, массив 16 МБ
[ редактировать ]В декабре 2018 года компания STMicroelectronics представила данные о конструкции и производительности массива ePCM емкостью 16 МБ для автомобильного блока управления с полностью обедненным кремнием на изоляторе по технологии 28 нм . [ 30 ]
Вычисления в памяти
[ редактировать ]В последнее время наблюдается значительный интерес к применению PCM для вычислений в памяти. [ 31 ] Основная идея состоит в том, чтобы выполнять вычислительные задачи, такие как операции умножения матрицы на вектор, в самом массиве памяти, используя возможности аналоговой памяти PCM и законы цепей Кирхгофа . Вычисления в памяти на основе PCM могут быть интересны для таких приложений, как глубокое обучение , которые не требуют очень высокой точности вычислений. [ 32 ] В 2021 году IBM опубликовала полноценное вычислительное ядро в памяти на основе многоуровневого PCM, интегрированного в CMOS 14 нм. технологический узел [ 33 ]
Проблемы
[ редактировать ]Самой большой проблемой для памяти с фазовым изменением было требование высокой плотности тока программирования (> 10 7 А /см 2 , по сравнению с 10 5 ...10 6 А/см 2 для типичного транзистора или диода ). [ нужна ссылка ] Контакт между горячей областью фазового перехода и прилегающим диэлектриком является еще одной фундаментальной проблемой. Диэлектрик может начать пропускать ток при более высокой температуре или может потерять адгезию при расширении со скоростью, отличной от скорости материала с фазовым переходом.
Память с фазовым изменением подвержена фундаментальному компромиссу между непреднамеренным и запланированным фазовым изменением. Это связано прежде всего с тем фактом, что фазовый переход является термическим, а не электронным процессом. Температурные условия, обеспечивающие быструю кристаллизацию, не должны быть слишком похожи на условия ожидания, например, комнатная температура, иначе сохранение данных будет невозможно. При правильной энергии активации кристаллизации можно добиться быстрой кристаллизации в условиях программирования и очень медленной кристаллизации в нормальных условиях.
Вероятно, самой большой проблемой для памяти с фазовым изменением является ее долговременное сопротивление и порогового напряжения . дрейф [ 34 ] Сопротивление аморфного состояния медленно возрастает по степенному закону (~t 0.1 ). Это серьезно ограничивает возможность многоуровневой работы, поскольку более низкое промежуточное состояние позже будет перепутано с более высоким промежуточным состоянием, а также может поставить под угрозу стандартную двухуровневую работу, если пороговое напряжение превысит расчетное значение.
В апреле 2010 года Numonyx выпустила линейку чипов PRAM с параллельным и последовательным интерфейсом Omneo емкостью 128 МБ NOR, заменяющих флэш-память . Хотя флэш-чипы NOR, которые они намеревались заменить, работали в диапазоне -40–85 ° C, чипы PRAM работали в диапазоне 0–70 ° C, что указывает на меньшее рабочее окно по сравнению с флэш-памятью NOR. Вероятно, это связано с использованием высокочувствительных к температуре p-n-переходов для обеспечения высоких токов, необходимых для программирования.
Хронология
[ редактировать ]- Январь 1955 года : Коломиец и Горунова обнаружили полупроводниковые свойства халькогенидных стекол . [ 35 ] [ 36 ]
- Сентябрь 1966 : Стэнфорд Овшинский подает первый патент на технологию фазового перехода.
- Январь 1969 : Чарльз Х. Си опубликовал в Университете штата Айова диссертацию по халькогенидному устройству памяти с фазовым переходом.
- Июнь 1969 : Патент США 3 448 302 (Шейнфилд), выданный Овшинскому по лицензии, утверждает первую надежную работу устройства PRAM.
- Сентябрь 1970 г .: Гордон Мур публикует исследование в журнале Electronics Magazine.
- Июнь 1999 г .: создается совместное предприятие Ovonyx для коммерциализации технологии PRAM.
- Ноябрь 1999 г .: Lockheed Martin работает с Ovonyx над PRAM для космических приложений.
- Февраль 2000 г .: Intel инвестирует в Ovonyx, лицензирует технологию.
- Декабрь 2000 г .: ST Microelectronics лицензирует технологию PRAM у Ovonyx.
- Март 2002 г .: Macronix подает заявку на патент на бестранзисторную PRAM.
- Июль 2003 г .: Samsung начинает работу над технологией PRAM.
- С 2003 по 2005 год : патентные заявки на PRAM, поданные Toshiba, Hitachi, Macronix, Renesas, Elpida, Sony, Matsushita, Mitsubishi, Infineon и другими.
- Август 2004 г .: Nanochip лицензирует технологию PRAM от Ovonyx для использования в хранилище зондов MEMS.
- Август 2004 г .: Samsung объявляет об успешном массиве PRAM 64 Мбит.
- Февраль 2005 г .: Elpida лицензирует технологию PRAM у Ovonyx.
- Сентябрь 2005 г .: Samsung объявляет об успешном массиве PRAM емкостью 256 Мбит, рекламирует ток программирования 400 мкА.
- Октябрь 2005 г .: Intel увеличивает инвестиции в Ovonyx.
- декабрь 2005 г .; Hitachi и Renesas анонсируют 1,5 В PRAM с током программирования 100 мкА
- Декабрь 2005 г .: Samsung лицензирует технологию PRAM у Ovonyx.
- Июль 2006 г .: BAE Systems начинает продажу первого коммерческого чипа PRAM.
- Сентябрь 2006 г .: Samsung анонсирует устройство PRAM на 512 Мбит.
- Октябрь 2006 г .: Intel и STMicroelectronics демонстрируют чип PRAM емкостью 128 Мбит.
- Декабрь 2006 г .: Исследовательские лаборатории IBM демонстрируют прототип размером 3 на 20 нанометров. [ 37 ]
- Январь 2007 г .: Qimonda лицензирует технологию PRAM у Ovonyx.
- Апрель 2007 г .: технический директор Intel Джастин Раттнер собирается провести первую публичную демонстрацию технологии компании PRAM (ОЗУ с фазовым изменением). [ 38 ]
- Октябрь 2007 г .: Hynix начинает продвигать PRAM, лицензируя технологию Ovonyx.
- Февраль 2008 г .: Intel и STMicroelectronics анонсируют MLC PRAM с четырьмя состояниями. [ 16 ] и начать отправлять образцы клиентам. [ 27 ]
- Декабрь 2008 г .: Numonyx объявляет о массовом производстве устройства PRAM емкостью 128 Мбит для избранных клиентов.
- Июнь 2009 г .: ОЗУ Samsung с фазовым переходом поступит в массовое производство, начиная с июня. [ 39 ]
- Сентябрь 2009 г .: Samsung объявляет о начале массового производства устройства PRAM 512 Мбит. [ 40 ]
- Октябрь 2009 г .: Intel и Numonyx объявляют, что нашли способ разместить массивы памяти с фазовым переходом на одном кристалле. [ 41 ]
- Декабрь 2009 г .: Numonyx анонсирует продукт 1 Гб, 45 нм. [ 42 ]
- Апрель 2010 г .: Numonyx выпускает серию Omneo PRAM (P8P и P5Q), обе по 90-нм техпроцессу. [ 43 ]
- Апрель 2010 г .: Samsung выпускает 512 Мбит PRAM по 65-нм техпроцессу в многочиповом корпусе. [ 44 ]
- Февраль 2011 г .: Samsung представила PRAM 58 нм, 1,8 В, 1 ГБ. [ 45 ]
- Февраль 2012 г .: Samsung представила 20-нм ОЗУ 1,8 В, 8 ГБ. [ 46 ]
- Июль 2012 г .: Micron объявляет о выпуске памяти с фазовым переходом для мобильных устройств — первого решения PRAM в серийном производстве. [ 47 ]
- Январь 2014 г .: Micron отзывает с рынка все детали PCM. [ 48 ]
- Май 2014 г .: IBM демонстрирует объединение PCM, обычной NAND и DRAM на одном контроллере. [ 49 ]
- Август 2014 г .: Western Digital демонстрирует прототип хранилища PCM с 3 миллионами операций ввода-вывода и задержкой 1,5 микросекунды. [ 50 ]
- Июль 2015 г .: Intel и Micron анонсировали память 3D Xpoint , в которой в качестве запоминающей части ячейки памяти используется сплав с фазовым переходом.
См. также
[ редактировать ]- Сегнетоэлектрическая RAM (FRAM)
- Магниторезистивная память с произвольным доступом (MRAM)
- Оперативная память (RMM)
Ссылки
[ редактировать ]- ^ Ле Галло, Мануэль; Себастьян, Абу (30 марта 2020 г.). «Обзор физики устройств памяти с фазовым изменением» . Журнал физики D: Прикладная физика . 53 (21): 213002. Бибкод : 2020JPhD...53u3002L . дои : 10.1088/1361-6463/ab7794 . ISSN 0022-3727 . S2CID 213023359 .
- ^ Берр, Джеффри В.; БрайтСкай, Мэтью Дж.; Себастьян, Абу; Ченг, Хуай-Юй; Ву, Джау-И; Ким, Санбум; Соса, Норма Э.; Папандреу, Николаос; Лунг, Сян-Лань; Позидис, Харалампос; Элефтериу, Евангелос (июнь 2016 г.). «Последний прогресс в технологии памяти с фазовым изменением» . Журнал IEEE по новым и избранным темам в схемах и системах . 6 (2): 146–162. Бибкод : 2016IJEST...6..146B . дои : 10.1109/JETCAS.2016.2547718 . ISSN 2156-3357 . S2CID 26729693 .
- ^ Симпсон, Р.Э.; П. Фонс; А.В. Колобов; Т. Фукая; и др. (июль 2011 г.). «Интерфейсная память с фазовым изменением». Природные нанотехнологии . 6 (8): 501–5. Бибкод : 2011НатНа...6..501С . дои : 10.1038/nnano.2011.96 . ПМИД 21725305 . S2CID 6684244 .
- ^ Чуа, Ло (2011), «Память с переключением сопротивления - это мемристоры», Applied Physics A , 102 (4): 765–783, Bibcode : 2011ApPhA.102..765C , doi : 10.1007/s00339-011-6264-9
- ^ Меллор, Крис (10 октября 2011 г.), «HP и Hynix будут производить мемристорные товары к 2013 году» , The Register , получено 7 марта 2012 г.
- ^ Мёфельс, П.; Сони, Р. (2012). «Фундаментальные вопросы и проблемы реализации мемристоров». arXiv : 1207.7319 [ cond-mat.mes-hall ].
- ^ Ди Вентра, Массимилиано; Першин, Юрий В. (2013). «О физических свойствах мемристивных, мемемкостных и меминдуктивных систем». Нанотехнологии . 24 (25): 255201. arXiv : 1302.7063 . Бибкод : 2013Nanot..24y5201D . CiteSeerX 10.1.1.745.8657 . дои : 10.1088/0957-4484/24/25/255201 . ПМИД 23708238 . S2CID 14892809 .
- ^ Си, Швейцария (1969). Ячейка памяти с использованием бистабильного удельного сопротивления в аморфной пленке As-Te-Ge . Ретроспективные диссертации и диссертации (PhD). Университет штата Айова. 3604 https://lib.dr.iastate.edu/rtd/3604 .
- ^ Пом, А.; Си, К.; Уттехт, Р.; Као, В.; Агравал, О. (1970). «Воспоминания о бистабильном сопротивлении халькогенидного стекла (Овоник)». Транзакции IEEE по магнетизму . 6 (3): 592. Бибкод : 1970ITM.....6..592P . дои : 10.1109/TMAG.1970.1066920 .
- ^ «Формирование нитей в полупроводнике As-Te-Ge, индуцированное электрическим полем» Ч. Си, Р. Уттехт, Х. Стивенсон, Дж. Д. Гринер и К. Рагхаван, Журнал некристаллических твердых тел, 2, 358–370, 1970
- ^ «Кинематографическое исследование механизмов памяти о фазовых изменениях» . Ютуб. 21 июня 2012 г. Архивировано из оригинала 21 декабря 2021 г. Проверено 17 сентября 2013 г.
- ^ Мур, Гордон Э.; Нил, Р.Г.; Нельсон, Д.Л. (28 сентября 1970 г.). «Энергонезависимая и перепрограммируемая память, предназначенная в основном для чтения», находится здесь» (PDF) . Электроника : 56–60.
- ^ «Является ли флэш-память NAND умирающей технологией?» . Техмир . Проверено 4 февраля 2010 г.
- ^ Каравати, Себастьяно; Бернаскони, Марко; Кюне, Томас Д.; Крак, Матиас; Парринелло, Микеле (2007). «Сосуществование тетраэдрических и октаэдрических участков в аморфных материалах с фазовым переходом». Письма по прикладной физике . 91 (17): 171906. arXiv : 0708.1302 . Бибкод : 2007ApPhL..91q1906C . дои : 10.1063/1.2801626 . S2CID 119628572 .
- ^ Хории, Х.; и др. (2003). «Новая технология ячеек с использованием пленок GeSbTe, легированных N, для оперативной памяти с фазовым переходом». Симпозиум 2003 г. по технологии СБИС. Сборник технических статей . стр. 177–8. дои : 10.1109/VLSIT.2003.1221143 . ISBN 4-89114-033-Х . S2CID 40051862 . 03Ч37407.
- ^ Перейти обратно: а б с Грин, Кейт (4 февраля 2008 г.). «Прорыв в памяти» . Обзор технологий .
- ^ «Заменит ли память с фазовым переходом флэш-память?» . КурцвейлАИ . Проверено 17 сентября 2013 г.
- ^ Чжоу, X.; Ву, Л.; Песня, З.; Рао, Ф.; Рен, К.; Пэн, К.; Песня, С.; Лю, Б.; Сюй, Л.; Фэн, С. (2013). «Характеристики фазового перехода материалов Al-Sb с фазовым переходом для применения в памяти фазового изменения». Письма по прикладной физике . 103 (7): 072114. Бибкод : 2013ApPhL.103g2114Z . дои : 10.1063/1.4818662 .
- ^ Симпсон, Р.Э. (2010). «К конечному пределу фазового перехода в Ge 2 Sb 2 Te 5 ». Нано-буквы . 10 (2): 414–9. Бибкод : 2010NanoL..10..414S . дои : 10.1021/nl902777z . ПМИД 20041706 . S2CID 9585187 .
- ^ «В этом году Intel представит образец памяти с фазовым изменением» . Архивировано из оригинала 23 марта 2007 г. Проверено 30 июня 2007 г.
- ^ Пировано, А.; Редаэлли, А.; Пеллиззер, Ф.; Оттогалли, Ф.; Тоси, М.; Ильмини, Д.; Лакаита, Алабама; Без, Р. (2004). «Исследование надежности энергонезависимой памяти с фазовым изменением». Транзакции IEEE по надежности устройств и материалов . 4 (3): 422–7. дои : 10.1109/TDMR.2004.836724 . S2CID 22178768 .
- ^ Карпов, ИВ; Кенке, Д.; Кау, Д.; Тан, С.; Спадини, Г. (2010). «Память фазовых изменений с халькогенидным селектором (PCMS): характерное поведение, физические модели и ключевые свойства материала». Симпозиум G – Материалы и физика для энергонезависимой памяти II . Дело МРС. Том. 1250. Издательство Кембриджского университета. стр. G14-01–H07-01. doi : 10.1557/PROC-1250-G14-01-H07-01 .
- ^ SAMSUNG представляет новое поколение энергонезависимой памяти — PRAM
- ^ «Intel анонсирует потенциальную замену Flash» . Архивировано из оригинала 29 июня 2012 года.
- ^ «IBM разрабатывает «мгновенную» память, в 100 раз быстрее флэш-памяти» . задействовать гаджет. 30 июня 2011 г. Проверено 30 июня 2011 г.
- ^ «SK Hynix и IBM подписывают совместную разработку PCRAM» . Отдел новостей SK Hynix . Проверено 5 февраля 2022 г.
- ^ Перейти обратно: а б «Intel и STMicroelectronics представили первые в отрасли прототипы памяти с фазовым переходом» . Нумоникс. 06 февраля 2008 г. Архивировано из оригинала 9 июня 2008 г. Проверено 15 августа 2008 г.
- ^ «Samsung Electronics и Numonyx объединяют усилия для создания памяти с фазовым изменением» . Samsung. 23 июня 2009 г.
- ^ «Samsung выпустит MCP с фазовым переходом» . ЭЭ Таймс. 28 апреля 2010 г. Проверено 3 мая 2010 г.
- ^ «Память с фазовым изменением (PCM) - Технология, преимущества и применение - STMicroelectronics» . www.st.com . Проверено 8 июля 2022 г.
- ^ Берр, Джеффри В.; Шелби, Роберт М.; Сидлер, Северин; ди Нольфо, Кармело; Чан, Джуну; Бойбат, Ирем; Шеной, Рохит С.; Нарайанан, Притиш; Вирвани, Кумар; Джакометти, Эмануэле У.; Курди, Бюлент Н. (ноябрь 2015 г.). «Экспериментальная демонстрация и устойчивость крупномасштабной нейронной сети (165 000 синапсов) с использованием памяти с фазовым изменением в качестве элемента синаптического веса» . Транзакции IEEE на электронных устройствах . 62 (11): 3498–3507. Бибкод : 2015ITED...62.3498B . дои : 10.1109/TED.2015.2439635 . ISSN 0018-9383 . S2CID 5243635 .
- ^ Себастьян, Абу; Ле Галло, Мануэль; Хаддам-Альджаме, Ридуан; Элефтериу, Евангелос (июль 2020 г.). «Устройства памяти и приложения для вычислений в памяти» . Природные нанотехнологии . 15 (7): 529–544. Бибкод : 2020НатНа..15..529С . дои : 10.1038/s41565-020-0655-z . ISSN 1748-3395 . ПМИД 32231270 . S2CID 214704544 .
- ^ Хаддам-Альджаме, Ридуан; Станисавлевич, Милош; Но Джордж Форт; Карунаратне, Гитан; Брандли, Матиас; Лю, Фэн; Сингх, Абхайрадж; Мюллер, Сильвия М.; Эггер, Медведь; Петропулос, Анастасиос; Антонакопулос, Теодор (2022). «HERMES-Core — PCM с производительностью 1,59 TOPS/мм2 на 14-нм КМОП-вычислительном ядре в памяти с использованием линеаризованных АЦП на базе CCO с частотой 300 пс/младший разряд» . Журнал IEEE твердотельных схем . 57 (4): 1027–1038. Бибкод : 2022IJSSC..57.1027K . дои : 10.1109/JSSC.2022.3140414 . ISSN 1558-173X . S2CID 246417395 .
- ^ Карпов, ИВ; Митра, М.; Кау, Д.; Спадини, Дж.; Крюков Ю.А.; Карпов, В.Г. (2007). «Фундаментальный дрейф параметров в памяти халькогенидных фазовых изменений». Дж. Прил. Физ . 102 (12): 124503–124503–6. Бибкод : 2007JAP...102l4503K . дои : 10.1063/1.2825650 .
- ^ Коломиец, Б.Т. (1964). «Стекловидные полупроводники (I)». Физический статус Solidi B. 7 (2): 359–372. Бибкод : 1964ПССБР...7..359К . дои : 10.1002/pssb.19640070202 . S2CID 222432031 .
- ^ Коломиец, Б.Т. (1964). «Стекловидные полупроводники (II)». Физический статус Solidi B. 7 (3): 713–731. Бибкод : 1964ПССБР...7..713К . дои : 10.1002/pssb.19640070302 .
- ^ «Фазовый переход для замены флэш-памяти?» . Архивировано из оригинала 27 сентября 2007 года.
- ^ «Новости ИТ, карьера, бизнес-технологии, обзоры» . Компьютерный мир .
- ^ Engadget Чипы Samsung PRAM поступают в массовое производство
- ^ «Samsung запускает в производство память с фазовым изменением» .
- ^ «Intel и Numonyx достигли важной вехи в исследованиях с помощью многоуровневой технологии памяти с фазовым изменением точки пересечения» . www.intel.com .
- ^ Numonyx представит результаты исследований памяти с фазовым изменением на ведущей конференции технологической отрасли
- ^ «Решения Numonyx для памяти — Numonyx представляет новые устройства памяти с фазовым переходом» . 25 апреля 2010 г. Архивировано из оригинала 25 апреля 2010 г.
- ^ «Страница не найдена — SAMSUNG» . Самсунг Электроникс Америка . Архивировано из оригинала 21 августа 2010 года.
{{cite web}}: Cite использует общий заголовок ( справка ) - ^ Чанг, Х.; и др. (2011). «58-нм 1,8 В, 1 Гбит PRAM с программной пропускной способностью 6,4 МБ / с». 2011 Международная конференция IEEE по твердотельным схемам . стр. 500–2. дои : 10.1109/ISSCC.2011.5746415 . ISBN 978-1-61284-303-2 . S2CID 206996875 .
- ^ 20-нанометровая оперативная память 1,8 В, 8 ГБ с пропускной способностью программы 40 МБ/с. Архивировано 31 января 2012 г. на Wayback Machine.
- ^ Micron объявляет о доступности памяти фазового изменения для мобильных устройств
- ^ Меллор, Крис (14 января 2014 г.). «Micron: Горячая DRAM. Нам не нужен никакой вонючий PCM» . www.theregister.co.uk . Регистр . Проверено 14 января 2014 г.
- ^ Грушка, Джоэл (8 мая 2014 г.). «IBM демонстрирует память нового поколения с фазовым переходом, которая до 275 раз быстрее, чем ваш SSD» . ЭкстримТех.
- ^ Грушка, Джоэл (6 августа 2014 г.). «Подразделение HGST компании Western Digital создает новый твердотельный накопитель с фазовым переходом, который на несколько порядков быстрее, чем любой флэш-накопитель NAND на рынке» . ЭкстримТех.
Внешние ссылки
[ редактировать ]- микрон
- Овоникс, Инк.
- Устройства преобразования энергии, Inc.
- Коляска малой мощности Hitachi/Renesas
- Хранение пробников Hewlett-Packard
- Европейский симпозиум по фазовым изменениям и овонике
- Пресс-релиз радиационно-стойкого NVM BAE C-RAM
- Технический паспорт радиационно-стойкой NVM BAE C-RAM
- Введение в PCM от Numonyx (видео)
